나노물질








GaAs/GaAs의 Bi 함량1 − x Bi x 340°C에 가까운 기판 온도에서 분자 빔 에피택시에 의해 성장된 /GaAs 이종 구조는 수차 보정된 고각 환상 암시야 기술로 조사됩니다. EDX 분석으로 확증된 고각 환상 암시야 주사 투과 전자 현미경 이미지의 낮은 배율에서의 분석은 평면 결함이 없는 층과 계면 및 GaAsBi 층 내에서 비균질 Bi 분포를 나타냈다. 고배율에서 qHAADF 분석은 낮은 Bi 플럭스에서 GaAsBi/GaAs 계면에서 불균일한 분포와 Bi 편석을 확인하고 Bi 함량이 높은 영역에서 왜곡된 아령 모양을 확인했습니다. 더 높은 Bi 플럭스에서 Bi 수집의 크기가 증가하여 아연 블렌드 {111}를 따라 면이 형성되고 매트릭스와 계면 주위에 균일하게 분산된 대략 등축의 Bi가 풍부한 입자가 생성됩니다. FFT 분석은 일부 클러스터에서 두 단계의 공존을 확인합니다. Bi x 행렬. 클러스터는 로컬 격자 이완에 영향을 미치고 XRD 분석과 잘 일치하는 부분적으로 이완된 GaAsBi/GaAs 시스템으로 이어질 수 있습니다.
<섹션 데이터-제목="배경">최근 GaAsBi 기반 반도체는 온도에 안정하고 중적외선 소자로 주목받고 있다[1]. GaAs 격자에 소량의 Bi를 추가하면 밴드갭이 크게 줄어들어 가장 흥미로운 광전자 효과 중 하나입니다[2, 3]. 그러나 GaAs에 소량의 Bi를 통합하는 것은 약한 Ga-Bi 결합 에너지, 큰 혼화성 갭 및 GaBi와 GaAs 사이의 격자 상수의 큰 차이로 인해 어렵습니다. 결과적으로, GaAsBi는 효율적인 Bi 통합을 위해 비평형 동적 프로세스에서 성장해야 합니다. 성공적으로 합성된 경우에도 Bi의 분포가 때때로 불균일하여 비방사성 재결합 중심의 밀도가 증가하여 레이저 작업의 효율성에 영향을 미칩니다. Bi의 큰 크기와 낮은 전기음성도는 에피택셜 성장 동안 상 분리[4], 표면 액적[5, 6], 원자 배열[7,8,9], 나노 규모의 액적[10] 또는 Bi 클러스터를 생성하는 경향이 있습니다. Bi 클러스터의 존재는 이전에 Ciatto et al.에 의해 감지되었습니다. X-선 흡수 분광법(XAS), 원자력 현미경 및 X-선 회절(XRD) 기술의 조합을 통해 [11]. 그런 다음 여러 저자가 다양한 투과 전자 현미경 기술을 사용하여 열처리된 GaAsBi 샘플에서 Bi 클러스터의 존재를 보고했습니다[4, 12, 13]. 또한, Kunzer et al. [14] 기존의 전자 스핀 공명(ESR)에 의해 통합된 Bi의 약 10%가 GaAsBi 층에서 Ga 사이트를 점유했음을 확인했습니다. 따라서 Bi 혼입 및 결함 형성을 이해하고 제어하는 것은 GaAsBi를 장치에 성공적으로 적용하는 데 중요합니다. 새로운 Bi 기반 재료의 개발이 특성화 도구의 발전과 관련되어 있다는 점은 언급할 가치가 있습니다. 이러한 의미에서 수차 보정 현미경의 고각 환형 암시야 주사 투과 전자 현미경(HAADF-STEM) 기술은 서브 옹스트롬 수준에서 정보를 얻는 데 중요한 역할을 합니다[15, 16]. 이 기술에서 이미지의 강도는 평균 원자 번호(Z ) 투사된 원자 기둥에서, As 및 Ga에 대한 Bi의 원자 번호의 큰 차이로 인해 희박 Ga(AsBi) 헤테로 구조에 성공적으로 적용될 수 있습니다. 또한 HAADF 이미지에서 밝은 특징이 고해상도 투과 전자 현미경(HRTEM)은 대조 반전 및 비편재화가 없기 때문에 정렬된 결정의 원자 기둥과 연관될 수 있습니다. 또한 GaAsBi 샘플의 수차 보정된 HAADF 이미지는 시편 두께에 대한 의존도가 낮고 As/Bi 조성에 대한 거의 선형 의존성을 보여줍니다[12]. 또한 Molina et al.에서 개발한 정량적 HAADF(qHAADF) 이미지 분석 알고리즘을 적용하여 [17], III-V 삼원 반도체 재료[12, 16, 18] 및 결과적으로 GaAsBi 화합물에서 HAADF 강도와 원자 기둥 조성을 효과적으로 상관시키는 것이 가능합니다. 또한 고해상도 HAADF-STEM 이미지는 결정질 품질에 대한 정보를 제공합니다[19,20,21,22].
이 작업에서 우리는 GaAs/GaAs1 − x의 Bi 분포와 수차 보정된 HAADF-STEM 이미징 및 EDX(Complementary Energy-Dispersive X-ray)를 통해 조사합니다. Bi x /GaAs 이종구조는 340°C에 가까운 기판 온도에서 MBE(분자빔 에피택시)로 성장했습니다. 우리는 또한 나노 및 마이크로 규모에서 Bi 수집의 효과를 연구했습니다. 이를 위해 qHAADF 접근 방식, 고해상도 이미지의 FFT(Fourier Fast Transform) 분석 및 XRD 기술을 사용했습니다.
GaAs/GaAs1 − x로 구성된 일련의 두 샘플을 연구합니다. Bi x 2″ n + 에서 솔리드 소스 MBE에 의해 성장된 /GaAs 이종 구조 GaAs:Bi 셀 온도 S1(460°C) 및 S2(505°C)에 의해 제공되는 Bi 플럭스가 다른 Si(001) 웨이퍼. 사용된 시스템은 평균 휴지 배경 압력이 ~ 5 × 10 − 10 인 VG V80 MBE 기계였습니다. 밀리바. 구조는 명목상 130nm GaAs 버퍼, 130nm GaAsBi 레이어, 5nm GaAs 스페이서 레이어, 130nm GaAs 캡으로 구성됩니다. 성장 전에 기판을 400°C에서 20분 동안 가스를 제거한 다음 600°C에서 표면 산화물을 제거했습니다. GaAs 버퍼와 캡은 As2에서 ~ 580°C에서 성장했습니다. 플럭스, GaAsBi 층 및 GaAs 스페이서 층은 거의 화학양론적 As4 하에서 ~ 340°C에서 성장했습니다. 유량. 따라서 GaAsBi 층은 GaAs 캡의 성장 동안 ~ 20분 동안 ~ 580°C에서 제자리에서 어닐링되었습니다. 이러한 성장 조건에서 표면의 금속 방울은 관찰되지 않았습니다. 기판 온도는 광학 온도계를 사용하여 추정되었으며 결과는 알려진 온도에서 표면 재구성 전환에 대해 보정되었습니다. GaAsBi 성장 전에 샘플 표면은 20초 동안 Bi 플럭스에 노출되었습니다. 이 단계의 목적은 Bi 표면층을 설정하고 GaAsBi 성장 시작 시 Bi 혼입을 향상시키는 것이었습니다.
HAADF-STEM용 시편은 기계적 연마 및 Ar + 에 의해 단면으로 준비되었습니다. − 3° 및 + 4°의 빔 기울기와 2.8~3.0kV의 빔 에너지로 정밀 이온 연마 시스템(PIPS)을 사용한 이온 밀링. 최종 밀링 단계에서 이온 에너지는 표면 품질을 향상시키기 위해 1.5kV로 감소했습니다. 연구되기 전의 샘플은 시편 표면에 대한 전자빔 증착의 영향을 줄이기 위해 플라즈마 세척되었습니다[23]. HAADF-STEM 이미지, 무손실 전자 에너지 손실 스펙트럼(EELS) 및 에너지 분산 X선 스펙트럼 라인 스캔은 Titan 3 을 사용하여 200kV에서 수행되었습니다. 60~300kV의 테제. 타이탄 3 Thethes에는 FEG(cold field emission gun), Cs 프로브 교정기 및 전자 단색기가 장착되어 있어 HAADF 이미징에서 원자 분해능을 허용합니다. 이 현미경에는 원소 분석을 위한 Super-X 쿼드 EDX 검출기가 포함되어 있어 원자 위치와 구성에 대한 정보를 동시에 제공합니다. TEM 표본의 지형 연구를 위한 2차 전자(SE) 이미지는 2kV에서 FEI NOVA NANOSEM 450 현미경을 사용하여 수행되었습니다.
Bruker Espirit 소프트웨어를 통한 Bi 조성의 정량적 측정에는 2.42keV의 Bi-M 라인이 사용되었습니다. 시편의 두께는 Digital Micrograph(GATAN™) 소프트웨어를 사용하여 공간적으로 분해된 제로 손실 EELS 신호 분석에서 결정되었습니다[23]. 열별 Bi 분포는 디지털 현미경 사진에서 실행할 수 있는 qHAADF 소프트웨어를 사용하여 연구되었습니다. 이 소프트웨어를 사용하면 HAADF-STEM 이미지에서 강도 피크를 감지하여 원자 기둥 주변의 선택된 영역의 통합 강도를 측정하고 매핑할 수 있습니다[17]. ω-2θ(0 0 4) XRD 스펙트럼은 Cu-Kα1를 사용하여 Bruker D8 Discover X선 회절계로 측정되었습니다. 방사능. 스캔은 Bede Rads Mercury 소프트웨어를 사용하여 시뮬레이션되었습니다.
그림 1은 샘플 S1(a) 및 S2(b)의 [110] 영역 축에서 촬영한 저배율 HAADF-STEM 이미지와 에 표시된 영역에서 [001] 방향을 따라 촬영한 두께 기울기 보정 강도 프로파일을 보여줍니다. HAADF-STEM 이미지(녹색 직사각형). 두 샘플의 연구 영역에서 스레딩 전위 또는 적층 결함이 감지되지 않았습니다. HAADF에서 얻은 강도는 평균 원자 번호에 비례합니다. 따라서 일정한 샘플 두께의 경우 이미지의 더 밝은 대비는 더 높은 Bi 함량(Z 바이 =83, Z 가 =31 및 Z 으로 =33). 이것은 GaAsBi/GaAs 이종구조에서 Bi 분포의 연구를 가능하게 합니다. 그림 1a에서 볼 수 있듯이 샘플 S1의 GaAsBi 층에서는 명확한 대비 변화가 감지되지 않으며(Bi 함량이 낮음) 샘플 두께가 더 높은 다른 영역에서도 클러스터링의 명확한 증거를 나타내지 않습니다. 그러나 Bi 및 As 클러스터는 Bi 함량이 1.44%만큼 낮은 GaAsBi 샘플의 경우에도 문헌에 보고된 바 있지만 더 낮은 온도에서 성장했습니다[11]. Bi 함량이 더 높은 샘플 S2와 관련하여 그림 1b는 상대적으로 균일한 크기와 분포를 가진 레이어에서 더 밝은 대비를 가진 일부 영역을 보여줍니다. GaAsBi 층과 인터페이스를 따라 규칙적으로 분포된 이러한 영역은 더 높은 HAADF 강도로 인해 Bi 함유 클러스터로 직접 해석될 수 있습니다. 더 나은 시각화를 위해 해당 저역 통과 필터링된 이미지는 동일한 이미지에서 삽입으로 표시됩니다. 여기서 노란색은 Bi 함량이 높은 영역에 해당하고 검은색은 낮은 영역에 해당합니다(온도 눈금). 구조적 결함을 유발하지 않고 GaAsBi에서 Bi 클러스터의 형성은 이전에 다른 저자에 의해 보고되었습니다[7, 24, 25]. GaAs 매트릭스에 Bi(As 원자 부피의 1.6배)가 통합되면 변형으로 인해 치환 에너지가 증가하여 As 원자의 용해도가 감소하고 Bi 원자가 모일 수 있습니다. 전계 방출 총 주사 전자 현미경(FEG-SEM)을 사용하여 샘플에 대한 연구를 수행하여 Bi 클러스터가 층 내에 매립되었는지 확인했습니다. 이를 위해 저전압(여기에는 표시되지 않음)에서 획득한 2차 전자의 지형 이미지를 동일한 영역에서 촬영한 STEM 이미지와 비교했습니다.
<그림>
아 GaAs/GaAsBi/GaAs 인터페이스를 보여주는 샘플 S1의 단면 HAADF-STEM 이미지. ㄴ 샘플 S2의 단면 HAADF-STEM 이미지에서, GaAsBi 층에서 Bi 풍부 영역과 관련된 GaAsBi 층을 따라 분포된 밝은 점이 관찰됩니다. 저역 통과 필터를 적용한 영역의 온도 색상 스케일을 사용한 디테일은 더 나은 시각화를 위해 동일한 이미지에 삽입으로 포함됩니다. ㄷ HAADF-STEM 이미지에서 녹색 직사각형으로 표시된 영역에서 [001] 방향을 따라 취해진 두께 기울기 보정 강도 프로파일, 샘플 S1의 경우 파란색 선, 샘플 S2의 경우 검은색 선으로 인터페이스에서 약간 다른 동작을 보여줍니다.
샘플의 Bi 분포에 대한 추가 정보를 얻기 위해 수정된 두께 구배가 있는 성장 방향에 따른 강도 프로파일이 그림 1c에 표시됩니다. 그림 1a, b의 HAADF-STEM 이미지에서 가져온 프로필은 두 샘플에서 유사한 동작을 나타냅니다. 대략 급격한 인터페이스, 비슷한 길이의 GaAsBi 레이어(~ 140nm). GaAsBi/GaAs 인터페이스와 관련하여 HAADF 강도는 약 10nm에서 최대값에서 ~ 0으로 떨어지며(프로파일의 회색 점선 직사각형 참조), Bi 플럭스가 없는 경우에도 GaAs 캡 층 전체에 일부 Bi 통합을 제안합니다. 프로필은 또한 평형 시간에 대한 정보를 나타냅니다. 프로필에서 볼 수 있듯이 Bi 함량이 낮은 샘플(S1)에서 GaAs/GaAsBi 계면은 Bi 함량이 높은 샘플(S2)보다 더 급격합니다. 이것은 두 샘플의 서로 다른 Bi 결합 계수로 설명될 수 있습니다. S1은 S2와 동일한 온도에서 성장했지만 Bi 함량이 훨씬 적습니다. 따라서 S1은 거의 1에 가까운 Bi 혼입[26]과 함께 운동학적으로 제한된 조건에서 성장할 수 있으며, 이는 Bi 표면층이 이 온도에서 Bi 원자의 표면 수명보다 짧은 시간 프레임에 걸쳐 평형을 이룰 것임을 의미합니다. 반면에 S2는 아마도 Bi 결합 계수가 더 낮을 것입니다[27]. 이 경우 Bi 표면층은 평형을 이루는 데 Bi 원자의 표면 수명보다 더 오래 걸리므로 Bi 결합의 안정화가 느려집니다.
HAADF-STEM 강도 프로파일과 이종 구조의 Bi 분포 사이의 상관 관계를 확인하기 위해 샘플의 STEM-EDX Bi 구성 맵을 동시에 취했습니다. 낮은(a) 및 높은(b) Bi 플럭스의 샘플에 대해 그림 2에 표시됩니다. 약 130nm 영역의 포인트 EDX 스펙트럼을 통합하여 결정된 성장 방향에 따른 해당 Bi 조성 프로파일은 그림 2c에 파란색 선과 검정색 선으로 각각 표시됩니다. 이러한 조성 프로파일은 저배율 HAADF 분석에 의해 GaAs/GaAsBi/GaAs 인터페이스에서 감지된 동일한 경향을 나타냅니다. GaAsBi 층의 평균 Bi 원자 분율은 샘플 S1 및 S2에서 각각 1.2 ± 0.4% 및 5.3 ± 0.4%인 해당 EDX 스펙트럼에서 정량화되었으며, 두 샘플의 GaAsBi 층에서 Bi의 비균질 분포를 나타냅니다. .
<그림>
샘플 S1에서 Bi 분포를 나타내는 STEM/EDX 원소 맵(a ) 및 S2(b ). 그림 1b에서 흰색 직사각형으로 표시된 클러스터에 해당하는 Bi, Ga 및 As 원소 맵의 세부 정보는 높은 Bi 영역이 있는 As 및 Ga 신호의 감소를 나타냅니다. ㄷ 샘플 S1(파란색 선) 및 S2(검은색 선)의 EDX 맵에서 약 130nm의 영역을 통합한 후 [001] 방향에 따른 Bi 함량 프로필이 추출되었습니다. 그림 1c에 표시된 저배율의 강도 프로파일에서 유사한 기능이 관찰되었습니다.
Bi 클러스터의 존재는 입체 장애 효과로 인한 것입니다. 이 경우 Bi 원자의 더 큰 원자 크기로 인해 표면 장력이 증가할 수 있으므로 구조의 응력을 줄이기 위해 Bi 원자가 Ga 혼입을 차단하고 결과적으로 그물에 Ga 공석을 유발할 수 있습니다. 그림 2b에서 흰색 사각형으로 둘러싸인 클러스터의 Ga 및 As 구성 맵은 높은 Bi 신호가 있는 위치에서 두 신호가 어떻게 떨어지는지 보여줍니다. 이것은 이 특정 클러스터에서 Bi가 그룹 III 및 그룹 V 하위 격자를 모두 차지할 수 있음을 시사합니다. 이것은 또한 클러스터가 TEM 샘플 준비 중에 형성된 피상적인 클러스터가 아니라는 증거입니다.
원자 수준에서 Bi 분포에 대한 심층 연구를 수행하기 위해 [110] 투영에서 고배율 수차 보정 HAADF-STEM 이미지를 촬영했습니다. 이 III-V 반도체 합금에서 아령의 두 최대 강도 피크는 III족 및 V족 원자 기둥에 해당합니다. 원자 기둥의 강도를 구성과 적절하게 연관시키기 위해 실험 HAADF-STEM 이미지에서 배경 수준이 제거되었습니다. 그런 다음 강도 피크의 자동 위치 지정이 수행되고 V족 원자 기둥 주변의 통합 영역이 신중하게 선택됩니다. 통합 강도는 qHAADF 접근 방식을 사용하여 모든 덤벨에 대해 측정되고 매핑됩니다. Bi 함량을 정량화하는 절차는 Ref. [28]. 이 작업에서 모든 덤벨의 통합 강도 지수(R )는 그룹 V 열의 통합 강도 사이의 비율로 계산되었습니다(I As − Bi ) 전체 이미지의 평균 통합 강도 및 GaAs 층의 그룹 V 열의 평균 통합 강도(I 으로 ), R =(나 (As − Bi) )/나 으로 .
그림 3a는 Bi 함량이 낮은 샘플에서 가져온 GaAs/GaAsBi 계면의 고배율 HAADF-STEM 이미지를 보여줍니다(S1). HAADF 이미지의 컬러 정규화 통합 강도 맵은 그림 3b에 나와 있습니다. 1(짙은 파란색)에서 1.27(빨간색) 범위의 컬러 점은 그룹 V 열의 Bi 함량을 나타냅니다. 관찰할 수 있듯이 R의 작은 변동은 평균값의 값은 두 레이어에서 모두 발견됩니다. 얻어진 결과의 분산을 비교하기 위해 상관계수 Cv를 계산했습니다. (표준편차와 평균 R 사이의 비율로 정의됨 값) GaAs(기판), GaAsBi 층 및 GaAs 캡 층. 이력서 GaAsBi/GaAs 계면에서 관찰된 변동이 기준으로 취한 GaAs 기판에서 관찰된 변동보다 높기 때문에 값은 각각 1.3, 2.6 및 2.6%였습니다. R의 이러한 변형은 값은 Bi 열 구성의 변화와 관련이 있습니다. 0이 아닌 Cv의 원인 기질의 요인은 국부적인 두께 변동, 검출기 노이즈(물질이 없는 영역에서 0.6%로 측정) 또는 현미경 특성화 동안 표면 샘플에 침착되는 탄화수소로 인한 것일 수 있습니다.
<그림>
아 단면 [110] 샘플 S1의 GaAsBi/GaAs 계면의 HAADF-STEM 이미지. GaAs 층의 왜곡되지 않은 영역과 Bi-rich 영역의 왜곡된 음이온-양이온 덤벨을 더 높은 배율로 확대한 세부 정보는 동일한 이미지에 삽입으로 포함됩니다. ㄴ R을 나타내는 컬러 지도 그림 3a에서 HAADF 이미지의 그룹 V 열 주변 값. 녹색은 EDX로 측정한 GaAsBi 층의 평균 Bi 조성에 해당합니다. HAADF-STEM 이미지에서 Bi의 균일한 분포에도 불구하고 강도 맵은 GaAsBi 층에서 나노클러스터링 가능성이 높은 영역(빨간색 점)과 Bi 함량이 상대적으로 낮은 열(파란색 점)을 보여줍니다. ㄷ 전체 R의 성장 방향에 따른 프로파일 약 10nm에서 흐릿한 GaAsBi/GaAs 인터페이스를 보여주는 강도 맵
이 qHAADF 분석은 전체 강도
HAADF-STEM 기술은 또한 샘플 S2에서 낮은 배율로 검출된 클러스터의 구조 및 구성 분석을 가능하게 합니다. 거의 균일하게 분포된 이러한 클러스터는 GaAsBi 층 표면의 약 20-30%를 차지합니다. 발견된 클러스터의 Bi 구성, 모양 및 크기를 알기 위해 [110] 투영에서 수차 보정된 HAADF-STEM 이미지를 촬영하고 그룹 V 열 주변의 EDX 요소 맵 및 강도 맵 비율을 수행했습니다. 서로 다른 결정상을 식별하기 위해 클러스터 내부와 주변의 여러 영역에서 고해상도 이미지로 고속 푸리에 변환(FFT) 연구를 수행했습니다.
그림 4a는 약 12nm 직경의 투명한 Bi 클러스터가 있는 GaAsBi/GaAs 인터페이스의 고해상도 [110] HAADF-STEM 이미지를 보여줍니다. 이미지의 빨간색 사각형은 FFT 연구가 수행된 영역을 나타냅니다. 저역 통과 필터링은 데이터의 노이즈 양을 줄일 뿐만 아니라 원시 이미지에서 관찰되는 주기적 특징을 제거하여 Bi 클러스터의 가장자리를 강조하는 것으로 잘 알려져 있습니다. Werner et al.에 의해 설명된 절차에 따라 필터링된 HAADF-STEM 이미지. [29], 그림 4b에 나와 있습니다. 알 수 있듯이 가장 밝은 영역의 {111} 및 (001) 패싯을 명확하게 관찰할 수 있습니다. 그러나 강도 분포는 입자에 두 가지 다른 조성 부피가 있음을 시사합니다. Bi가 풍부한 영역이 Bi가 덜 풍부한 영역으로 둘러싸인 사다리꼴 모양입니다. Wood et al.에서도 유사한 클러스터 모양이 관찰되었습니다. 5주기 GaAs1 − x에서 Bi x /GaAs1 − y Bi y 구조 [10].
<사진>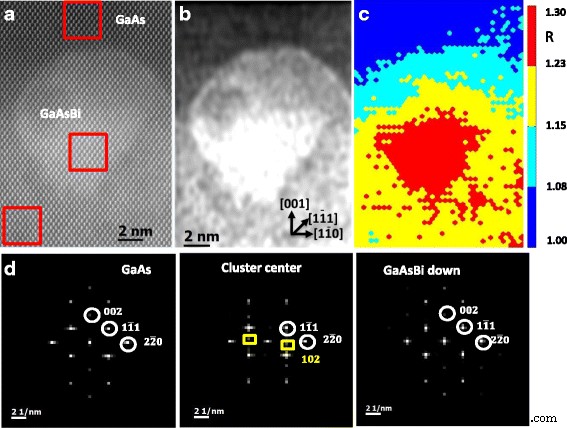
아 단면 [110] GaAsBi/GaAs 인터페이스 옆에 있는 약 12nm 크기의 Bi 클러스터를 캡처한 샘플 S2의 GaAsBi/GaAs 인터페이스의 HAADF-STEM 이미지. ㄴ HAADF-STEM 이미지의 저필터링된 이미지는 GaAsBi 레이어에서 대비가 다른 두 영역을 보여줍니다. Bi가 풍부한 영역은 {111} 및 (001) 평면을 따라 패싯 처리되고 더 낮은 Bi가 풍부한 영역으로 둘러싸여 있습니다. ㄷ R을 나타내는 컬러 지도 클러스터 주변의 등급 Bi 분포를 나타내는 그룹 V 열 주변의 값. d 그림 1a에서 빨간색 직사각형으로 표시된 선택된 영역의 해당 푸리에 변환. 대비가 가장 높은 클러스터 영역에서 rh-Bi 위상과 관련된 평면과 일치하는 추가 스팟이 감지됩니다.
강도 R를 통한 qHAADF 분석 그림 4c에 표시된 맵은 대략적으로 등축인 입자 모양과 클러스터 중앙에서 정점을 이루는 Bi 농도 구배를 보여줍니다.
Wu et al. [4]는 HRTEM 현미경 사진을 연구하고 아연 블렌드 Bi-rich에서 아연 블렌드 {111} 평면에서 핵이 생성된 능면체 Bi(rh-Bi)로의 형성 및 상 변형을 모델링하는 GaAsBi 층에 서로 다른 결정학적 구조의 존재를 보고했습니다. 이러한 의미에서 고해상도 HAADF-STEM 이미지에서 FFT의 밝은 점은 결정면에서 회절 반점으로 해석될 수 있다는 점을 언급할 가치가 있습니다. 그런 다음 GaAs의 아연 블렌드 구조에 대한 기존 패턴의 추가 스폿은 추가 상으로 해석되어야 합니다. 클러스터에서 다른 결정 구조의 존재를 연구하기 위해 그림 4d는 그림 1a에서 빨간색 사각형으로 표시된 3개의 다른 영역에 해당하는 FFT를 보여줍니다. 오른쪽에서 왼쪽으로 GaAs 캡 레이어의 균질한 영역, GaAsBi 레이어의 가장 밝은 영역 및 동일한 GaAsBi 레이어의 대비가 낮은 다른 영역을 보여줍니다. 흰색 원은 Miller 지수 002, \( 1\overline{1}1 \) 및 \( 2\overline{2}0 \)를 사용하여 회절 피크의 위치를 나타냅니다. 관찰할 수 있는 바와 같이, 클러스터의 중앙에만 노란색 사각형으로 표시된 명확한 반점이 나타나며, 이는 아연 블렌드 {220} 평면과 대략 평행한 {102} 평면과 관련되어 있으며, 이는 새로운 rh-Bi 상이 다음에서 핵 생성되었음을 시사합니다. GaAsBi 아연 혼합 층. FFT는 또한 {111} 평면과 관련된 회절 피크의 확장을 나타냅니다. 이렇게 관찰된 비대칭 피크는 클러스터에서 rh-Bi와 아연 블렌드 상 사이의 {111} 평면을 전단함으로써 발생하는 미세 변형 때문일 수 있습니다.
클러스터 구성에 대한 심층 연구를 위해 전자가 클러스터가 포함된 전자 투명 표본을 통과할 때 클러스터에 대한 정보뿐만 아니라 매트릭스의 정보도 전달한다는 점을 언급할 가치가 있습니다. 따라서 실제 클러스터 구성을 추정하기 위해 Ref. [25]. 결과는 또한 GaAsBi/GaAs 계면에 가까운 클러스터가 더 높은 Bi 함량(≈ 30%)으로 크기(12nm)가 더 작은 경향이 있다는 점을 지적했는데, 아마도 캡 층이 시작될 때 표면에 Bi가 존재하기 때문일 것입니다. 성장하다. 그러나 GaAsBi 레이어 내부에 위치한 대부분의 클러스터는 더 큰 크기(16nm)를 갖지만 Bi 함량은 열등합니다(≈ 22%). 또한 GaAsBi 층에서 Bi 함량이 더 우수하고(35%) 더 큰 크기(23nm)를 가진 클러스터가 감지되었습니다. 또한 앞서 언급했듯이 일부 클러스터의 핵심은 순수한 rh-Bi로 구성됩니다.
에피택시 필름의 변형 상태를 조사하기 위해 고해상도 X선 ω-2θ 곡선을 기록했습니다. 그림 5는 샘플 S1(a) 및 S2(b)에 대해 파란색으로 GaAsBi/GaAs 레이어의 (004) XRD 스캔과 주황색으로 시뮬레이션된 피팅을 보여줍니다. 두 샘플에서 0° arc 초에 위치한 가장 날카롭고 가장 높은 강도 피크는 GaAs 기판에 해당하는 반면, 음의 arc 초에 위치한 더 넓은 더 낮은 강도 피크는 변형된 GaAsBi 층에 해당합니다. 피크 사이의 각도는 두 레이어 사이의 격자 불일치 정도와 관련이 있습니다. S2의 스펙트럼에서 GaAs 피크의 오른쪽에 있는 어깨는 인장 변형을 받는 GaAs 층을 나타냅니다. 이것은 S2 GaAsBi 층에서 변형 완화를 의미합니다. 샘플 S1의 XRD 스펙트럼은 EDX 및 HAADF 측정에 의해 제공된 Bi 분획 및 두께를 사용하여 잘 맞았습니다. 샘플 S1의 XRD 스펙트럼에서 변형 완화의 징후는 없습니다. 샘플 S2의 XRD 스펙트럼은 맞추기에 더 문제가 있었습니다. 그림 5b는 HAADF-STEM 분석에 의해 결정된 5.8%의 균일한 GaAsBi 층에 의해 모델링된 데이터를 보여주고, XRD 곡선을 피팅하여 결정된 6%의 GaAsBi 층의 이완과 Bi가 풍부한 클러스터를 무시합니다. 클러스터가 나머지 GaAsBi 매트릭스와 일관성이 없는 경우 이는 합리적입니다. 이 모델은 레이어를 정확하게 나타내지 않습니다. 기판-GaAsBi 분할은 데이터를 설명하기에 충분하지만 ~ 250° arc 초에서 인장 GaAs 피크는 보이지 않습니다. 인장 GaAs 피크는 이완이 층 내에서 발생했음을 시사합니다. 압축 층의 완화는 평면 격자 상수를 감소시킬 것이며, 이는 모델링된 평균 Bi 함량 5.8%가 실제 평균을 과소평가했음을 의미합니다. 이것은 레이어에서 Bi-rich 클러스터의 관찰과 일치합니다. ~ 22–35% GaAsBi에 해당하는 피크는 상호 공간 매핑(표시되지 않음)에 의해 관찰되지 않았으며, 이는 클러스터가 GaAsBi 매트릭스와 일관성이 없을 수 있음을 시사합니다. S2 XRD 스펙트럼의 추가 모델링은 시도되지 않았습니다.
<그림>
샘플 S1(a)의 X선 회절 데이터(파란색 선) 및 모의 맞춤(주황색 선) ) 및 샘플 S2(b ). 0° 아크 초에서 GaAs 피크를 강조하는 수직 파선과 음의 아크 초에 위치한 GaAsBi 필름 피크를 강조 표시합니다. 그림 5b의 오른쪽 GaAs 피크에 있는 숄더는 인장 변형이 있는 GaAs 캡 층을 나타냅니다.
ac-HAADF-STEM 분석은 GaAs/GaAsBi/GaAs 이종구조의 구조 및 구성에 대한 유용한 정보를 제공하며 결과는 EDX, FFT 및 XRD 조사와 잘 일치합니다. 저배율 HAADF-STEM 이미지 분석을 통해 불균일한 Bi 분포 및 비돌발적인 GaAsBi/GaAs 인터페이스를 감지할 수 있었습니다. 고배율에서 qHAADF 분석은 낮은 Bi 플럭스(S1)에서 GaAsBi/GaAs 계면에서 명확한 Bi 분리를 나타내었고, 그룹 V 서브넷에서 Bi 원자의 As-치환 위치로 인해 Bi 분율이 더 높은 영역에서 왜곡된 덤벨 모양을 나타냈습니다. . 더 높은 Bi 플럭스(S2)에서 Bi 수집의 크기는 전체 매트릭스와 인터페이스 주위에 균일하게 분산된 대략 등축 클러스터로 이어집니다. 이 연구는 연구된 클러스터 rh-Bi 및 아연 블렌드 전단 {111} 평면에서 두 가지 다른 결정상이 공존하여 XRD 분석과 잘 일치하는 국부 격자 이완에 영향을 미치고 부분적으로 이완된 GaAsBi/GaAs 시스템으로 이어지는 것으로 나타났습니다.
수차 보정된 고각 환상 암시야 주사 투과 전자 현미경
에너지 분산 X선
전자 에너지 손실 스펙트럼
기존의 전자 스핀 공명
냉전계 방출 총
푸리에 고속 변환
고해상도 투과전자현미경
Instituto Universitario de Investigación en Microscopía Electrónica y Materiales
분자빔 에피택시
정량적 HAADF 이미지 분석 알고리즘
주사 전자 현미경
X선 흡수 분광법
X선 회절
나노물질
배전반은 수많은 개별 회로 또는 소비자 지점에 전력을 분배하는 데 사용되는 퓨즈, 회로 차단기 및 접지 누출 보호 장치를 수용하는 패널 또는 인클로저입니다. 보드에는 일반적으로 단일 입력 전원이 있으며 주 회로 차단기와 잔류 전류 또는 누전 보호 장치가 포함됩니다. 오래된 배전반에는 개별 회로에 전원을 공급하는 일련의 퓨즈가 포함될 수 있습니다. 최신 설비에는 일반적으로 미니 회로 차단기가 있습니다. 배전반은 설치 세부 사항에 따라 단상 또는 삼상 전원을 분배하는 데 사용할 수 있습니다. 배전반 장비, 레이아웃 및 법적 요구 사항은
배전반이라고도하는 패널 보드는 전기를 공급하는 데 사용되는 시스템의 요소입니다. 주요 기능은 밀폐된 공간의 각 회로에 차폐 또는 보호 퓨즈를 제공하면서 전기 공급을 보조 회로로 나누는 것입니다. 패널 및 배전반은 퓨즈 링크, 버스 바, 스위치 및 바이패스 장비라고도 하는 자동화된 보호 장비로 구성되는 경향이 있습니다. 이러한 장비는 과부하, 단락 및 기타 문제로부터 배전 시스템과 전기 연결을 보호합니다. 전기 에너지는 일반적으로 배전 시스템 또는 도체 시스템이라고 하는 대량 전력 소스에서 소비자에게 전송됩니다. 이들은 고전압