나노물질








산화갈륨(Ga2 O3 )은 초광대역 밴드갭, 높은 항복 전계, 큰 BFOM(Baliga's Figure of Merit)이 장점인 반도체 신소재로 쇼트키 배리어 다이오드(SBD)를 비롯한 차세대 고전력 소자의 유망한 후보 물질이다. ). 본 논문에서는 Ga2의 기본 물성 O3 반도체를 분석했다. 그리고 Ga2에 대한 최근 조사 O3 기반 SBD가 검토되었습니다. 한편, 항복전압, 온저항 등의 성능향상을 위한 다양한 방법을 요약하여 비교하였다. 마지막으로 Ga2의 전망 O3 -전력 전자 응용을 위한 기반 SBD를 분석했습니다.
<섹션 데이터-제목="배경">전력, 산업 제어, 자동차 전자 및 소비자 전자 산업의 급속한 발전과 함께 고성능 전력 반도체 장치에 대한 엄청난 수요가 있습니다. 광역 및 초광대역 밴드갭 반도체 재료는 이러한 요구를 충족시킬 수 있습니다[1, 2]. Ga2의 5가지 구조 중 O3 단결정, 단사정 β -가2 O3 가장 안정적이며 초광대역 밴드갭(E g ~ 4.8 eV) 및 매우 높은 항복 전기장(E br ~ 8 MV cm −1 ), 기존의 Si 및 나중에 개발된 SiC 및 GaN 재료와 비교됩니다. 결과적으로 β -가2 O3 훨씬 큰 Baliga의 성능 지수를 보여줍니다(BFOM =\( \varepsilon \mu {E}_{\mathrm{b}}^3 \); ε 는 상대 유전 상수이고 μ 전자 이동도)입니다. BFOM은 전력소자 적용을 위한 재료의 적합성을 평가하는 중요한 기준이다[3,4,5,6,7,8,9,10,11]. 표 1은 Si, 와이드 밴드갭(GaN, SiC) 및 울트라와이드 밴드갭(β)의 기본 물리적 특성을 비교합니다. -가2 O3 ) 반도체 재료. 또한, 단결정 β의 성장을 위해 -가2 O3 플로팅 존(FZ)[12, 13] 및 가장자리 정의 필름 공급 성장(EFG)[14,15]과 같이 대기압에서 쉽고 저렴하며 대량 생산 가능한 용융 성장 방법이 있습니다. ,16,17]. 이것은 Ga2의 또 다른 우수성입니다. O3 SiC 및 GaN에 비해 고품질 단결정 성장 측면에서. 따라서 β -가2 O3 쇼트키 배리어 다이오드(SBD)[18,19,20,21,22,23,24] 및 금속 산화물 반도체 전계 효과 트랜지스터(MOSFET)와 같은 차세대 고전력 반도체 소자의 유망한 후보입니다. 25,26,27,28,29]. Ga2에 대한 많은 연구가 O3 재료 성장 및 전력 장치 제조 및 특성화가 지난 몇 년 동안 수행되었으므로 이 문서에서는 초광대역 밴드갭 Ga2의 재료 특성을 검토했습니다. O3 반도체 및 Ga2의 조사 O3 - 전력 전자 애플리케이션을 위한 기반 SBD. SBD에서 가장 중요한 성능 매개변수는 항복 전압(V br ) 및 온저항(R 켜기 ), 그래서 V를 개선하기 위한 다양한 방법을 요약하고 비교함으로써 br 및 R 켜기 우리의 검토 작업이 Ga2 개발에 도움이 되기를 바랍니다. O3 기반 전원 장치.
산화갈륨(Ga2 O3 )은 산화물 반도체의 새로운 소재이지만 오랜 연구 역사를 가지고 있다. Al2의 위상 평형에 대한 조사 O3 -가2 O3 -H2 O 시스템은 1952년으로 거슬러 올라갈 수 있으며 R. Roy et al. Ga2의 다형체의 존재를 확인했습니다. O3 및 안정성 관계 [30]. 1965년 H. H. Tippins et al. β 밴드 에지에서 광흡수 및 광전도도 연구 -가2 O3 4.7 eV 값으로 밴드갭을 확인했습니다[6]. 1990년대에 Ga2의 용융 성장에 대한 여러 방법 O3 Ga2의 벌크 단결정 및 에피택셜 성장 O3 필름이 개발되었습니다. 최근 5년간 특수 특성과 고품질의 대형 단결정 기판인 Ga2의 성공적인 성장으로 인해 O3 자료는 많은 연구 관심을 끌었습니다.
지금까지 사람들은 Ga2의 5가지 결정상을 발견했습니다. O3 , 즉, α , β , γ , δ , 및 ε 단계. 이 5단계 간의 변환 관계는 그림 1에 나와 있습니다[30]. 단사정상 β- 가2 O3 다른 4개 상은 준안정적이고 β-로 변형되기 쉬운 반면 최고의 열 안정성을 가지고 있습니다. 가2 O3 고온에서. 따라서 현재 대부분의 연구는 β-에 초점을 맞추고 있습니다. 가2 O3 . 일부 최근 조사에서는 다른 단계에서 β 단계가 없었습니다. 예:α- 가2 O3 사파이어와 유사한 커런덤 결정 구조를 가지고 있습니다(Al2 O3 ), 따라서 고품질 α- 가2 O3 현재 존재하는 Al2에 단결정 필름 O3 단결정 기판. 육각상 ε- 가2 O3 AlGaN/GaN 접합의 조건과 유사한 이종 접합 계면에서 고밀도 2D 전자 가스를 형성하는 데 유리한 강력한 자발 분극 효과를 나타내는 두 번째 안정상입니다[31]. 최근에는 대형 β-의 성공적인 성장으로 인해 가2 O3 단결정 기질과 그 최고의 안정성, 지금까지 β-에 대한 연구 가2 O3 다른 4단계보다 훨씬 많습니다. 따라서 본 논문에서는 주로 β-에 대한 연구를 검토한다. 가2 O3 .
<그림>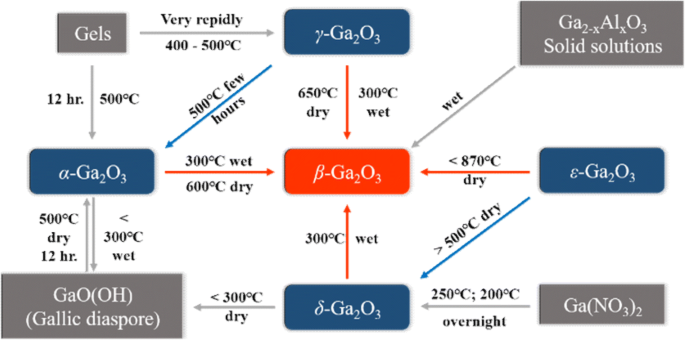
Ga2O3의 결정상과 그 수화물 사이의 변환 관계 [30]
β- 가2 O3 단사정계에 속하며 열적으로 안정합니다. 격자 상수는 a입니다. =1.22nm, b =0.30nm 및 c =0.58 nm, 그림 2와 같이. β-의 결정 구조 가2 O3 특정 전도율이 있다고 결정하지만 알려진 모든 투명 반도체 재료 중 가장 넓은 초광대역 밴드갭(4.7–4.9 eV)에 의해 제한됩니다. 밴드갭에 약간의 결함 에너지 준위가 존재하고 자유 전자가 생성되는 경우에만 재료가 비교적 강한 전도성을 갖습니다. 대부분의 와이드 밴드갭 반도체의 경우 ZnO 반도체와 같이 밴드갭의 결함 수준이 존재하기 때문에 전도성이 형성됩니다[32]. β-의 고유 전기 전도 가2 O3 결정 덩어리에 형성된 점 결함에 의해 주도되는 자유 전자에서 비롯됩니다. 대부분의 연구에서 산소 결손이 전기 전도의 주요 결함이라는 것이 입증되었습니다[33,34,35].
<그림>
β-Ga2의 격자 구조 O3 결정. ref에서 재판. [5]
다결정질 β-에 산소 결손이 많기 때문에 흥미롭습니다. 가2 O3 , 어떤 종류의 가스를 흡수하여 저항률을 변경하기 쉽기 때문에 β-를 사용하는 것에 대한 보고가 많이 있습니다. 가2 O3 H2 감지를 위한 가스 센서 제작 , 채널4 , CO 및 O2 [36,37,38,39]. 또한, β-의 격자상수 때문에 가2 O3 [100] 방향이 [001] 및 [010] 방향보다 훨씬 크므로 소자 제작을 위해 [100] 방향을 따라 초박막을 쉽게 박리할 수 있다[27, 40, 41, 42, 43]. 동시에 이러한 결정구조의 특성으로 인해 β- 가2 O3 웨이퍼, [100] 방향을 따라 벌크를 절단하면 매우 낮은 거칠기로 평평한 표면을 얻을 수 있습니다.
SiC 및 GaN과 비교하여 β- 가2 O3 특정 전기적 특성을 가지고 있으며 그 중 초광대역 밴드갭(4.7–4.9 eV)이 가장 두드러집니다. 이것은 매우 높은 임계 항복 전기장(E br ≈8 MV/cm), SiC 및 GaN의 약 2배입니다. 재료의 항복 전기장은 단극 전원 장치에서 매우 중요한 매개변수입니다. 재료의 E가 더 높은 경우 br , 단위 두께의 재료에서 더 높은 전기장을 유지할 수 있으므로 장치 크기를 줄이고 전원 모듈의 집적도를 높이는 데 유리합니다. 그림 3은 온저항(R 켜기 ) 항복 전압(V br ) Si, GaAs, SiC, GaN, Ga2를 포함한 여러 중요한 반도체용 O3 , 다이아몬드 [5]. 이 그림에서 Ga2의 전도 손실이 O3 소자는 동일한 V에서 SiC 및 GaN 소자보다 10배 더 낮습니다. br . 따라서 Ga2 O3 단극 장치에서 큰 잠재력을 보여줍니다. β-의 포화 전자 이동도 가2 O3 비교적 낮음(~ 200cm 2 뷔 − 1 s − 1 ), β- 가2 O3 GaN에 비해 고주파 장치에는 적합하지 않습니다. 그러나 더 얇은 드리프트 층이 더 작은 공핍 폭을 가지기 때문에 넓은 밴드갭은 이러한 단점을 보완할 수 있습니다. 따라서 기생 커패시턴스를 감소시켜 고주파 애플리케이션의 요구 사항을 충족할 수 있습니다. 게다가 약 4.8eV의 밴드갭은 Ga2를 만듭니다. O3 태양 블라인드 자외선(UV) 광선 범위에 있는 특수 흡수 파장 대역(250–280 nm)을 보유하므로 Ga2 O3 UV 검출기 제작에 좋은 천연 소재입니다[44,45,46,47].
<그림>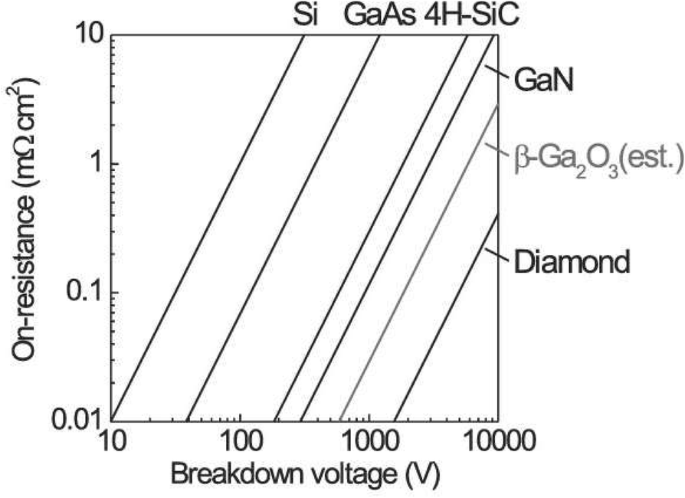
온 저항의 이론적 한계(R 켜기 ) 항복 전압(V br ) β-Ga2의 경우 O3 그리고 대표적인 반도체. ref에서 재판. [26]
최근에는 β-의 n형 도핑이 가2 O3 기본적으로 실현되었습니다. Si 및 Sn 원소는 에너지 준위가 낮은 도너 불순물로서 활성화 에너지가 낮습니다. 도핑 농도는 10 15 범위로 잘 조절될 수 있습니다. –10 19 cm −3 [47], 가장 높은 값 10 20 cm −3 도달했다. 동시에 도핑 농도의 변화에 따라 광학적, 전기적 특성도 변화합니다. 예를 들어, n형 β-의 비저항 가2 O3 10 −3 범위의 변화 − 10 12 변화하는 도핑 농도에 따른 Ω cm [48, 49]. 밴드갭도 도핑 농도에 따라 달라지므로 Ga2의 흡광 특성 O3 영향을 받습니다[50].
Ga2의 개발에서 O3 , 이 자료는 여전히 다음과 같은 몇 가지 단점이 있습니다. (1) P형 도핑은 Ga2의 큰 과제입니다. O3 재료. 수용체 수준이 β-의 가전자대에서 멀기 때문에 가2 O3 , 수용체 불순물의 활성화 에너지는 매우 높습니다. 한편, Ga2의 n형 배경 불순물 O3 크리스탈은 또한 수용체 불순물에 대한 자체 보상 효과를 생성하여 재료의 자체 절연을 초래합니다. 따라서 효과적인 p-type 수행은 아직까지 이루어지지 않았습니다. (2) Ga2의 열전도율 O3 너무 낮습니다. 실험적 및 이론적 조사는 β-의 열전도율이 가2 O3 0.1–0.3 W cm −1 에 불과합니다. K −1 [51,52,53]. 이것은 고전압 및 고전류 환경에서 사용되는 전원 장치에 불리합니다. 과도한 열 축적은 장치의 성능과 신뢰성에 심각한 영향을 미칩니다. (3) 캐리어 이동도가 낮다. Ga2의 이론적 이동도 O3 약 200cm로 제한됨 2 /V는 산란의 영향으로 인한 것입니다[54]. 낮은 이동성은 주파수 및 전류 특성에 부정적인 영향을 미칩니다.
쇼트키 접촉, 오믹 접촉 및 전기장 분포는 SBD에서 온 저항(R 켜기 ) 및 항복 전압(V br ), 이를 개선하기 위한 다양한 방법이 특히 중요합니다.
쇼트키 장벽의 개념에 따르면 장벽 높이는 쇼트키 금속의 일함수와 반도체의 전자 친화력과 관련이 있습니다. 서로 다른 금속의 일함수는 주기적으로 변하는데, 금속은 반도체보다 일함수가 커야 쇼트키 장벽을 형성할 수 있다. 니켈(Ni)과 백금(Pt)은 β-의 일반적인 쇼트키 금속입니다. 가2 O3 , 그리고 그들의 장벽 높이는 다양한 방법으로 도출됩니다 [55,56,57,58,59,60,61,62,63,64,65,66,67,68,69,70,71,72,73,74 ,75,76,77]. 반도체 표면 아래의 공핍 영역은 캐리어 터널링을 방지하기 위해 필요한 두께가 필요하며, 이를 위해서는 반도체의 제한된 도핑 농도가 필요합니다. 도핑 농도의 일반적인 값은 10 16 입니다. –10 17 cm −3 β- 가2 O3 기판 또는 에피택시 층 [56,57,58,59,60,61,62]. 장벽 높이는 실제로 인터페이스 상태의 영향을 받으며 작업 기능과의 단순한 관계에서 벗어납니다. 표면 전처리는 표면 근처의 산소 결손 및 댕글링 결합을 포함하여 계면 상태를 줄이는 것을 목표로 합니다[78].
옴 접촉은 금속과 반도체 사이의 기본 연결 고리입니다. 옴 접촉의 낮은 비저항은 장치가 접촉 저항(R s ) 및 온저항(R 켜기 ). 낮은 접촉 저항을 달성하기 위한 전통적인 방법은 일함수가 낮은 금속을 선택하고 도핑을 많이 하는 것입니다. 실제로 접촉 금속의 일함수는 계면 상태의 고정으로 인해 옴 접촉 형성에 항상 영향을 미치지 않습니다. 반도체의 고농도 도핑은 저항성 접촉의 기본 기술이 됩니다. 주요 목표는 캐리어 농도를 개선하고 인터페이스 장벽을 낮추는 것입니다. RTA(Rapid Thermal Annealing)는 계면 특성을 개선하고 접촉 저항을 줄이기 위해 중복됩니다. Y. Yao et al. 9개의 금속을 β-에 대한 옴 접촉 금속으로 테스트했습니다. 가2 O3 티타늄(Ti)과 인듐(In)은 특정 조건에서 우수한 저항 거동을 보인다는 것을 발견했습니다[79]. 고온에서 어닐링한 후에는 티타늄만이 연속적인 형태를 유지할 수 있습니다. 이와 유사하게 대부분의 연구에서는 β- 가2 O3 양호한 장치 성능을 얻었습니다[60,61,62,63,64,65,66,67,68,69,70].
항복 거동은 소자 내부의 전계 분포와 관련이 있으며, 원통형 접합과 구형 접합은 동일한 조건에서 평행 평면 접합보다 더 큰 전기장을 갖는다[1]. 따라서 항복 전압을 향상시키기 위해 필드 플레이트와 같은 일부 에지 종단 보호 방법이 필요합니다[19, 23, 68]. 계면 전하라고 하는 계면 상태는 일반적으로 반도체 표면에 가까운 전기장에 영향을 미치고 조기 파괴를 일으킵니다. 누설 전류는 항복 거동의 지표이며 일반적으로 전위를 포함한 반도체 내부 결함의 영향을 받습니다. 두 상황 모두 장치의 불안정을 야기하고 피해야 하는 항복 전압을 감소시킬 수 있습니다. 인터페이스 상태의 영향을 줄이기 위한 일반적인 방법은 표면 패시베이션이며, 항복 전압을 높이려면 고품질 기판도 필요합니다.
고품질 및 저비용 단결정 기판 성장의 어려움은 SiC 및 GaN 장치의 상용화에 영향을 미쳤습니다. 가2 동안 O3 단결정 기판은 Ga2 기반의 전력 소자인 저비용 용융 방법으로 성장될 수 있습니다. O3 단결정은 최근 몇 년 동안 많은 주목을 받았습니다. 현재 Ga2의 n형 도핑 기술은 O3 상당히 성숙하지만 p형 도핑이 없으면 Ga2가 됩니다. O3 바이폴라 장치에 적용할 수 없습니다. 매우 큰 밴드갭은 유니폴라 소자의 적용에 큰 이점이 된다. 따라서 Ga2의 개발 O3 전력 소자는 두 종류의 단극 소자, 즉 쇼트키 장벽 다이오드(SBD)와 금속 산화물 반도체 전계 효과 트랜지스터(MOSFET)에 의해 지배됩니다[23, 55, 56].
WBG(Wide Bandgap) 반도체 재료 기술의 발달로 WBG 반도체 기반 SBD 소자는 pn 접합 다이오드를 대체하기 시작하여 SBD에 소수 캐리어 저장 효과가 없고 스위칭 손실이 매우 낮기 때문에 전력 전자 시스템에 적용됩니다. 이론적으로 SiC 및 GaN SBD에 비해 Ga2 O3 SBD는 훨씬 더 얇은 드리프트 레이어로 동일한 항복 전압을 얻을 수 있습니다. 동시에 드리프트 레이어가 얇을수록 기생 커패시턴스가 낮아져 장치의 역 회복 시간이 단축됩니다. Ga2의 주요 개발 진행 상황 O3 SBD는 그림 4에 나와 있습니다. 에피택시 기술의 발달로 SBD 구조는 초기 기판 기반의 단순 구조에서 기판 및 에피택시 필름 기반 복합 구조로 발전했습니다. 그 후, 소자 제작 공정에 대한 점진적인 탐색을 통해 필드 플레이트 및 트렌치를 포함한 첨단 단자 구조가 등장하여 소자 성능을 더욱 향상시켰다. 가2 O3 SBD는 전력 전자 응용 분야에서 잠재력을 발휘하기 시작했습니다.
<그림>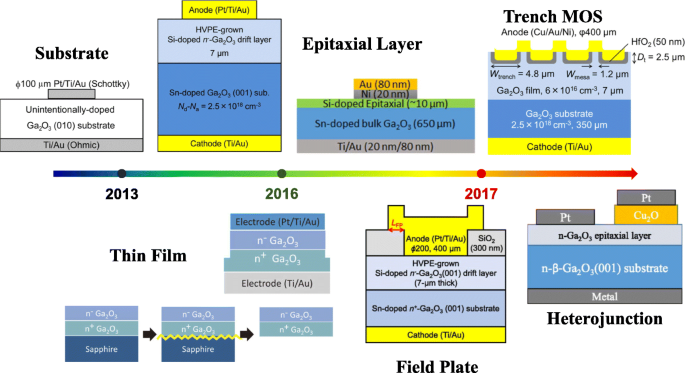
Ga2의 개발 O3 최근 몇 년간 SBD [16, 18, 62, 68–71]
새로운 와이드 밴드갭 반도체 재료로서 Ga2의 초기 개발 단계에서 사람들은 많은 기본적인 문제에 직면했습니다. O3 , 그래서 Ga2의 개발 진행 상황 O3 SBD는 파워 SBD의 진화를 아주 잘 반영합니다. SBD에서 가장 중요한 부분은 쇼트키 접합이므로 초기 연구에서는 Ga2 O3 SBD, 주로 Ga2 사이의 접촉을 포함하여 Schottky 접합에 대한 연구에 중점을 둔 많은 것들이 있습니다. O3 및 다른 쇼트키 전극(Ni、Cu、Au、Pt、TiN) [57,58,59], 쇼트키 접합의 전자 수송 메커니즘, 계면 상태 문제, 쇼트키 접촉에 존재하는 장벽 불균일성 및 이미지 힘, 음극 인터페이스에서 완벽한 옴 접촉을 획득하는 방법[60, 61].
물리적 특성이 점차 뚜렷해지고 제조 공정이 점차 개선됨에 따라 장치 성능이 점진적으로 향상됩니다. 다음은 Ga2 개발의 대표적인 몇 가지 작업입니다. O3 SBD.
2013년 K. Sasaki et al. Tamura Corporation에서 고품질(010) β 기반으로 SBD 제작 -가2 O3 플로팅 존 방법으로 성장한 단결정 기판[62]. 그들은 기판의 다양한 도핑 농도가 장치 성능에 미치는 영향을 조사했으며 도핑 농도가 높을수록 온 저항은 낮아지지만 역방향 항복 전압은 낮아지고 역 누설 전류는 더 커짐을 발견했습니다. 그림 5는 (010) β로 제작된 두 SBD의 역 항복 특성을 보여줍니다. -가2 O3 도핑 농도가 다른 기판. 항복 전압은 150V에 도달합니다. 두 장치의 이상 계수는 1에 가깝습니다. 그리고 Pt/β의 쇼트키 장벽 높이는 -가2 O3 인터페이스는 1.3–1.5 eV로 추정되었습니다.
<그림>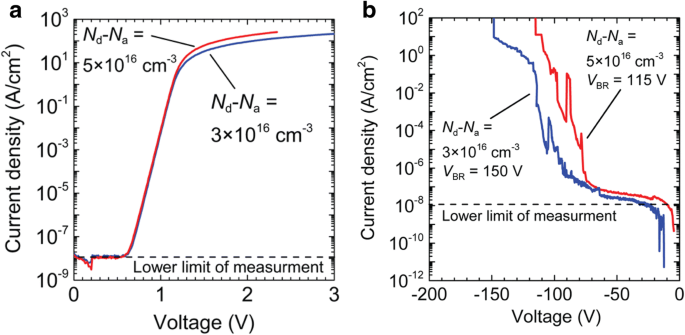
아 , b (010) β에 따른 SBD의 순방향 및 역방향 전기적 특성 -가2 O3 도핑 농도가 다른 기판. 전류 밀도 측정의 하한은 10 -8 입니다. A/cm 2 . ref에서 재판. [62]
중국과학원(IMECAS) 마이크로일렉트로닉스 연구소(Institute of Microelectronics of Microelectronics)와 산둥 대학(Shandong University)의 연구원들이 협력하여 (100) 지향 β 기반 SBD를 조사했습니다. -가2 O3 벌크 기판. 2017년에 그들은 Pt/β를 보고했습니다. -가2 O3 SBD 및 온도에 따른 전기적 특성. X선 회절(XRD) 및 고해상도 투과 전자 현미경(HRTEM) 분석은 β -가2 O3 EFG(Edge-Defined Film-Fed Growth) 기술로 성장한 벌크 단결정은 좋은 (100) 방향과 좋은 결정 품질을 나타냈습니다(그림 6a, b). I–V 측정 및 열이온 방출 모델링을 통해 제작된 Pt/β -가2 O3 SBD 장치는 10 10 의 정류비를 포함하여 우수한 성능을 보였습니다. , 이상 요인(n ) 1.1, 쇼트키 장벽 높이(Φ 나 ) 1.39eV, 임계값 전압(V 바이 )의 1.07V, 온저항(R 켜기 ) 12.5mΩ cm 2 , 2V에서 순방향 전류 밀도(J @2V ) 56A/cm 2 , 및 유효 기증자 농도(N d − N 아 ) / 2.3 × 10 14 cm −3 (그림 6c, d). 좋은 온도 의존적 성능은 기기에서도 발견되었습니다(그림 6e, f). 온도가 상승함에 따라 R 켜기 및 J @2V 장치가 고온에서 잘 작동할 수 있음을 보여줌으로써 더 좋아졌습니다. 다음 연구에서 그들은 이상 요인과 쇼트키 장벽 높이의 온도 의존성을 더 깊이 조사했으며 이러한 종류의 온도 특성은 장벽 높이 불균일성의 가우스 분포로 설명될 수 있음을 발견했습니다[61]. 2018년에는 결정 성장 매개변수를 더욱 최적화하고 Sn 도핑 농도(N d − N 아 =2.3 × 10 14 cm −3 ). 새로운 Pt/β -가2 O3 SBD 장치는 순방향 전류 밀도(J @2V =421A/cm 2 ), ON 상태 저항(R 켜기 =2.9mΩ cm 2 ), 짧은 역 회복 시간(20ns) 및 200V보다 높은 역 항복 전압[63]. 그들의 연구는 EFG가 β 성장했음을 나타냅니다. -가2 O3 단결정은 전력 장치 응용 분야에 유망합니다.
<그림>
아 (100) β의 X선 회절(XRD) 곡선 -가2 O3 (400), (600) 및 (800) 평면의 피크를 명확하게 보여주는 단결정 기판. ㄴ Pt/β의 단면 고해상도 투과 전자 현미경(HRTEM) 이미지 -가2 O3 β의 쇼트키 접촉 및 고속 푸리에 변환(FFT) 현미경 사진 -가2 O3 결정. ㄷ Pt/β의 순방향 및 역방향 J-V 곡선 -가2 O3 SBD 및 SBD의 개략도(삽입). d 선형 및 반 로그 플롯의 순방향 J-V 곡선. 이 온도 종속 J-V 곡선 및 Richardson의 플롯(삽입). 에 온도에 대한 ON 저항 및 순방향 전류 밀도의 의존성. ref에서 재판. [60]
Q. Feng et al. Xidian University의 PLD(Pulsed Laser Deposition) 준비 공정과 Al 도핑된 β의 기본 물리적 특성을 연구했습니다. -가2 O3 영화 [64,65,66]. Al Doping은 β의 밴드갭을 조정할 수 있습니다. -가2 O3 다른 Al 원자 비율을 통합함으로써. 이러한 Al 도핑 필름을 기반으로 Ni/β -(알가)2 O3 SBD 장치를 제작하고 특성화했습니다. 쇼트키 장벽 높이는 1.33eV입니다. 현재 온-오프 비율 및 온-저항 도달 10 11 및 2.1mΩ cm 2 , 각각 [65]. 그들은 또한 이상 인자와 쇼트키 장벽 높이에 대한 온도의 영향을 연구하고 이러한 n 및 Φ 나 장벽 높이의 가우스 분포가 존재한다고 가정함으로써 쇼트키 장벽의 불균일성에 기인한 것입니다[66].
필름 에피택시 기술의 발전으로 할로겐화물 기상 에피택시(HVPE)를 활용하여 Ga2 성장 O3 영화. 에피택시의 빠른 속도와 필름의 고품질의 장점으로 인해 HVPE 성장 Ga2 O3 고전압 SBD의 드리프트층 제작에 매우 적합합니다. 2015년 M. Higashiwaki et al. NICT(National Institute of Information and Communications Technology)에서 7μm 두께로 약하게 도핑됨(~ 1 × 10 16 cm −3 ) 많이 도핑된 (N) 상의 에피택셜 층 d − N 아 =2.5 × 10 18 cm −3 ) (001) β- 가2 O3 HVPE 방법을 통해 기판을 만들고 추가로 제작된 SBD 소자. 서로 다른 온도에서 소자의 CV 및 I-V 특성을 조사했습니다. 온도에 따른 쇼트키 장벽 높이, 문턱 전압, C-V 및 I-V 곡선의 변화 경향을 지적하였다. 그림 7은 장치 구조와 순방향 및 역방향 J-V-T 곡선을 보여줍니다[16]. 21–200°C에서 장벽 높이가 거의 일정하게 유지되는 것으로 나타났습니다. 순방향 및 역방향 전류는 각각 열이온 방출(TE) 및 열이온 전계 방출(TFE) 모델과 잘 일치했습니다. 그들의 결과는 Ga2의 적용 가능성을 보여주었습니다. O3 차세대 전원 장치의 SBD.
<그림>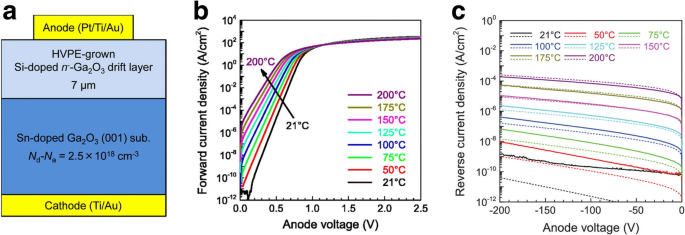
아 HVPE 성장 7μm 두께 n − 기반 SBD 소자의 구조 - 가2 O3 n + 의 호모에피택시 드리프트 레이어 - 가2 O3 단결정 기판. ㄴ 21~200°C에서 측정된 기기의 순방향 J-V 특성입니다. ㄷ 21~200°C에서 J-V를 역전시킵니다(실선과 점선은 각각 실험 결과와 시뮬레이션 결과를 나타냄). ref에서 재판. [16]
2016년 M. Oda et al. FLOSFIA Inc.에서 α에 대한 작업을 발표했습니다. -가2 O3 SBD [18]. 미스트 화학 기상 증착(CVD) 기술, 즉 MIST EPITAXY®를 통해 연속적으로 크게 성장하고(두께 3–4μm) 가볍게 도핑된 α -가2 O3 사파이어 필름(Al2 O3 ) 기판. α를 제거한 후 -가2 O3 기판, 캐소드 및 애노드의 층이 n - 의 바닥 및 상단 표면에 증착되었습니다. - 가2 O3 /n + - 가2 O3 레이어(그림 8). 2580nm 두께의 n − 장치 - 가2 O3 레이어는 855V의 높은 항복 전압과 0.4mΩ cm 2 의 온 저항을 나타냈습니다. . 더 얇은(430nm) n − - 가2 O3 레이어 SBD는 0.1mΩ cm 2 의 매우 낮은 온저항을 나타냈습니다. 531V의 항복 전압. 2018년에 그들은 TO220 패키지로 수행된 이러한 종류의 장치를 추가로 보고했습니다[67]. 130pF의 접합 커패시턴스를 얻었으므로 장치는 SiC SBD 및 Si SBD에 비해 더 나은 역 회복 특성을 나타냅니다. 동시에 패키지 후 장치는 동일한 패키지(12.5°C/W)의 SiC SBD에 필적하는 13.9°C/W의 열 저항을 나타내어 얇은 드리프트 층을 채택하면 효과적으로 보상할 수 있음을 보여줍니다. Ga2의 열전도율이 나쁘다는 단점 O3 재료. 이 보고서에서 저자들은 또한 α -(Rh,Ga)2 O3 α의 효과적인 p형 채널 레이어 역할을 할 수 있습니다. -가2 O3 장치.
<그림>
α의 제작 과정 -가2 O3 FLOSPIA Inc.에서 제안한 SBD. [18, 67]
2017년 K. Konishi et al. NICT에서 보고된 Pt/HVPE-n − - 가2 O3 /(001)n + - 가2 O3 항복 전압이 1076V이고 온 저항이 5.1mΩ cm 2 인 SBD 기기 (그림 9) [68]. 에지 종단 기술의 일종인 필드 플레이트(FP) 엔지니어링은 Ga2에 처음 사용되었습니다. O3 SBD. 양극 연결 SiO2를 추가하여 FP, 전체 소자 구조에서 최대 전계는 임계 전계 이하로 유지되었으며, 특히 양극 주변의 전계는 분명히 감소할 수 있다. 이 방법을 사용하면 높은 항복 전압과 낮은 온 저항을 모두 얻을 수 있습니다. 같은 해에 J. Yang, et al.에 의해 더 높은 항복 전압(1600V)이 보고되었습니다. Ni/MOCVD-n − 이 있는 SBD 장치에서 플로리다 대학의 - 가2 O3 /(− 201) n + - 가2 O3 구조 [69], 그러나 온 저항은 매우 큽니다(25mΩ cm 2 ). 에지 종단이 사용되지 않았습니다. 그들의 조사는 쇼트키 전극의 크기가 더 큰 전극이 더 많은 결함을 갖고 더 쉽게 파괴되기 쉽기 때문에 파괴 전압과 온 저항에 영향을 미친다는 것을 보여주었습니다.
<그림>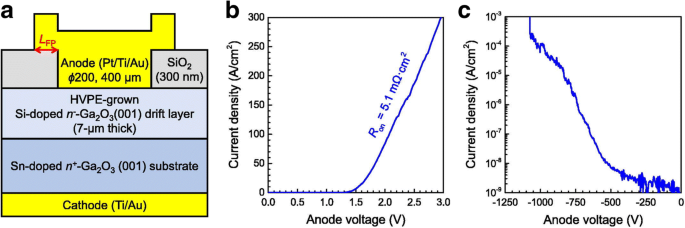
아 필드 플레이트가 있는 SBD의 구조. ㄴ , ㄷ 순방향 및 역방향 전기적 특성(V br =1076 V). ref에서 재판. [68]
2017년 K. Sasaki et al. from Novel Crystal Technology Inc. first fabricated β -Ga2 O3 SBD with trench termination structure (Fig. 10) [70]. By adopting this kind of structure, the electric field in the Schottky junction can be effectively decreased; thus, the leakage current can be greatly reduced while the forward properties are well maintained. The on-resistance of the device was 2.9 mΩ cm 2 , and the breakdown voltage reached about 240 V. At the same time, the threshold voltage was remarkably reduced compared with the previous reports. This work is a valuable exploration on the advanced fabrication process of Ga2 O3 SBD. In the 2nd International Workshop on Gallium Oxide and Related Materials (IWGO 2017) held in Italy, they further reported the improved trench SBD. The threshold voltage decreased to 0.5 V. On-resistance was 2.4 mΩ cm 2 , and breakdown voltage was over 400 V. Compared to the commercialized 600 V SiC SBD, the improved trench Ga2 O3 SBD exhibited superiority in switching loss.
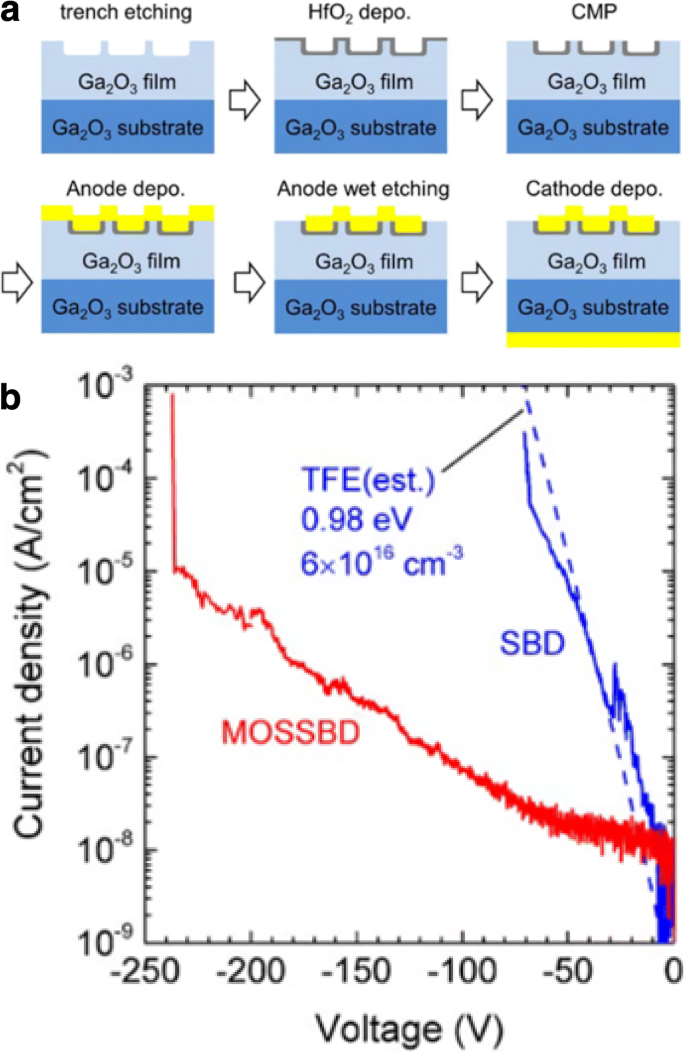
아 Fabrication processes of the MOS-type Ga2 O3 SBD with trench termination structure. ㄴ Comparison of the reverse characteristics of the Ga2 O3 SBDs with and without trenches. Reprinted from ref. [70]
To date, there has been no effective p-type doping in Ga2 O3 , so bipolar devices are not easy to be realized. In 2017, T. Watahiki et al. from Mitsubishi Electric Corporation reported a heterojunction p-Cu2 O/n-Ga2 O3 p-n diode without local termination structure [71]. Figure 11 shows the schematic, band diagram and J–V curves of this p-n diode. Pt/Ga2 O3 SBD was simultaneously fabricated and measured for comparison. The breakdown voltage of the p-n diode reached as high as 1.49 kV. The on-resistance was 8.2 mΩ cm 2 , much lower than that of the SBD with a thick drift layer reported by J. Yang et al. [69]. So, it can be found that bipolar Ga2 O3 device has a certain advantage over unipolar device in regard to the low on-resistance. This work provides a possible solution for the design Ga2 O3 -based bipolar devices. However, this p-n diode exhibited a high threshold voltage (1.7 V). Moreover, in bipolar device, there is the minority carrier storage effect. With the improvement of SBD device structure, this p-n diode appears to show significant competitivity in the aspect of 600–1200 V voltage-resistant level and high frequency. It is believed that with the continuous exploration on the materials, SBD might still be a more effective approach for development of the high-voltage Ga2 O3 device before the successful preparation of p-type Ga2 O3 .
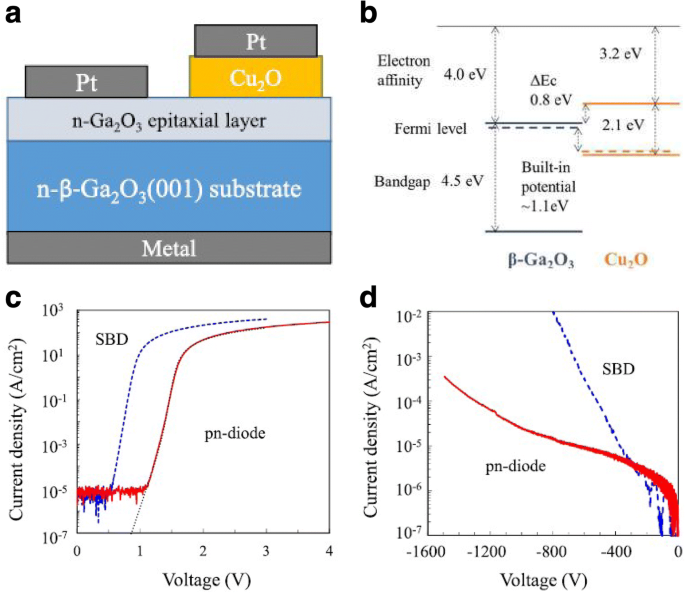
아 Schematic of the cross-sectional Pt/Ga2 O3 SBD and p-Cu2 O/n-Ga2 O3 diode. ㄴ Band diagram of the p-Cu2 O/n-Ga2 O3 상호 작용. ㄷ , d Forward and reverse J–V characteristics of the SBD and p-n diode. Reprinted from ref. [71]
In practical applications, SBD is usually used to rectify the AC or pulse signals as a rectifier in a circuit. It should work at different frequencies. Q. He et al. from IMECAS investigated the rectification characteristics of the Pt/Ga2 O3 SBD under the AC frequency under 10 kHz to 1 MHz by using a half-wave rectification circuit (Fig. 12) [63]. The testing result proves that the device has the ideal working frequency of 100 kHz, which is equivalent to that of SiC. This work is beneficial for people to further explore how Ga2 O3 Schottky rectifier can operate at higher frequency and also to construct power circuit modules based on Ga2 O3 SBD single device.

아 Rectification circuit. ㄴ –이 Rectifying effect of Pt/Ga2 O3 SBD on the AC signals under frequency of 10 kHz, 100 kHz, 500 kHz, and 1 MHz. Reprinted from ref. [63]
Table 2 lists and compares the basic performance parameters of some typical Ga2 O3 Schottky barrier diode reported since 2012. From this table, it is apparent that with the improvement of device structure and fabrication processes, the performances are getting better and better.
Currently, Ga2 O3 SBD is still in its early stage. With the continuous development of fabrication processes, device structure becomes more and more complicated. At the same time, the improvement of the quality of single-crystal substrates and epitaxial films also significantly push forward device performances. However, to date, the development process of Ga2 O3 SBD is very similar to those of previous Si SBD and SiC SBD. Furthermore, the research works on the intrinsic properties of Ga2 O3 materials are still very few. But it is believed that on the basis of its ultrawide bandgap of 4.7–4.9 eV and the development of device structure, Ga2 O3 will better display its unique application value, which requires the joint efforts of the researchers.
Alternating current
Baliga’s figure of merit
화학 기상 증착
Edge-defined film-fed growth
Fast Fourier transform
Field plat
Floating zone
고해상도 투과전자현미경
Halide vapor-phase epitaxy
Institute of Microelectronics of Chinese Academy of Sciences
Metal-organic chemical vapor deposition
Metal-oxide-semiconductor field-effect transistor
National Institute of Information and Communications Technology
펄스 레이저 증착
Schottky barrier diode
Thermionic emission
Thermionic field emission
Wide bandgap
X선 회절
나노물질
전자 산업에 가장 적합한 로봇 애플리케이션은 무엇입니까? 로봇은 전자 회사에서 매우 인기를 얻고 있습니다. 최근 추정에 따르면 전통적으로 로봇 사용의 선두 주자인 자동차 산업보다 전자 산업에서 로봇 성장이 훨씬 더 높습니다. 프로세스에 로봇 자동화를 추가하려는 경우 어떤 작업이 가장 적합한지 알기 어려울 수 있습니다. 다음은 전자 산업에 적합한 15가지 애플리케이션입니다. 1. 회로 기판 조립 전자 제품 제조의 고전적인 응용 분야인 로봇은 회로 기판 조립에 적합합니다. 첫째, 로봇은 인간 작업자보다 더 일관되
사용 가능한 포지셔너 기능 및 옵션을 이해하면 의사 결정 프로세스를 용이하게 하여 품질을 추가로 개선하고 주기 시간을 단축하며 용접 라인에서 우수성을 제공할 수 있습니다. 여기서는 제조업체가 사용할 수 있는 모든 옵션과 기능을 더 잘 이해하는 데 도움이 되는 중요한 포지셔너 정보에 대해 논의합니다. 포지셔너란 무엇인가요? 포지셔너는 360도 회전이 가능하며 회전 및 회전 장치를 통해 부품에 접근할 수 있습니다. 포지셔너를 사용하면 생산을 가속화하고 용접 품질을 향상시킬 수 있습니다. 로봇 작업 셀을 설계할 때 로봇이 작업할