나노물질








습식 에칭은 나노 규모 구조의 제조에 중요해진 나노미터에 가까운 정밀도로 희생 물질을 제거하는 부드럽고 손상이 없는 방법으로서 이점을 제공합니다. 이러한 습식 에칭 용액을 개발하기 위해서는 선택성 및 (an)등방성과 같은 에칭제 특성의 스크리닝이 중요해졌습니다. 이러한 식각액은 일반적으로 식각 속도가 낮기 때문에 식각 거동을 평가하려면 민감한 테스트 구조가 필요합니다. 따라서 축소된 단결정 Si(c-Si) 및 SiGe(c-SiGe) 수레 바퀴가 제작되었습니다. 첫째, 알칼리 에칭액 TMAH 및 NH4에서 결정질 실리콘의 이방성 거동을 감지하기 위한 c-Si 수레 바퀴의 감도 OH를 시연했다. 각 재료/에천트 쌍에 대한 특징인 독특한 수레바퀴 패턴은 등방성 습식 에칭 후 하향식 주사 전자 현미경(SEM)에 의해 관찰되었습니다. Si(100) 및 Si(110) 기판 모두에 대해 결정학적 평면 종속 에칭 속도의 유사한 경향이 얻어졌습니다. 둘째, c-Si 및 c-Si75의 에칭 Ge25 전형적인 선택적 에칭제인 과아세트산(PAA)의 수레바퀴가 평가되었습니다. c-Si75 Ge25 PAA에서의 에칭은 등방성 에칭을 초래하였다. 선택도 값은 두 가지 방법을 기반으로 계산되었습니다. 첫 번째는 수레 바퀴 스포크의 측벽 손실을 측정하는 방법이고 두 번째는 스포크 수축 길이를 측정하는 간접 방법입니다. 두 방법 모두 비슷한 값을 제공하지만, 후자의 방법은 특정 임계 에칭 시간 이후에만 사용할 수 있으며, 그 후에 스포크 팁이 날카로운 팁으로 진화합니다.
전통적으로, 집적 회로 반도체 장치의 트랜지스터 밀도의 점진적인 증가는 노드 크기를 축소함으로써 달성되었습니다. 이것은 기술적으로나 경제적으로 더 이상 지속 가능하지 않습니다. 따라서 Fin-FET 및 GAA-FET와 같은 새로운 전계 효과 트랜지스터(FET) 아키텍처가 도입되었습니다[1,2,3]. 후자는 게이트가 채널을 더 정확하게 조정할 수 있기 때문에 전자에 비해 이점을 제공합니다[4]. 대부분의 고급 FET 트랜지스터 및 메모리 셀에 사용되는 이러한 복잡한 3D 기능의 제조에 사용되는 일부 공정에는 극도로 선택적이고 등방성인 에칭액이 필요합니다[5, 6].
하나 이상의 수직으로 적층된 수평 결정질 나노와이어를 포함하는 GAA 아키텍처의 제조를 위해, 희생 결정질 에피택셜 층의 매우 선택적이고 등방성 에칭이 필요하다. 예를 들어 Si 나노와이어 출시의 경우 Six Ge1-x Si 나노와이어를 그대로 유지하는 에칭액이 필요합니다.
따라서 에칭제 특성의 스크리닝 및 이해가 중요해졌습니다. 블랭킷 필름의 에칭액 스크리닝은 재료/에천트 쌍의 (an)등방성에 대한 신뢰할 수 있는 정보를 제공하지 않습니다. 측면 트렌치에서 느린 에칭 또는 소위 '차단' 평면의 형성으로 인해 결정질 희생 층의 에칭이 지연되거나 중지될 수 있기 때문에 이방성을 시각화하는 것이 매우 중요합니다. 이방성은 MEMS(Microelectromechanical Structures)의 제작[7, 8]과 태양광 응용 분야에서 Si의 표면 질감에 대해 광범위하게 연구되었습니다[9,10,11].
원칙적으로 두 가지 실험 방법이 사용되었으며, 둘 다 Si의 결정학적 방향의 함수로 에칭 속도를 산출합니다. 먼저 직경이 몇 밀리미터인 실리콘 구 또는 반구가 에칭됩니다. 이방성은 일단 정량화되면 다른 결정 평면의 에칭 속도를 산출하는 패싯 형성을 발생시킵니다[12,13,14]. 두 번째로 가장 널리 사용되는 방법은 웨이퍼에 실리콘 스포크 또는 트렌치를 방사형으로 패턴화하여 소위 수레바퀴 모양을 만드는 것입니다[15, 16]. 후자의 방법의 장점은 하나의 습식 에칭 실험으로 많은 결정학적 면을 조사할 수 있다는 사실과 증폭 효과에 있습니다. 등방성 습식 에칭 동안 스포크의 팁은 왜건 휠 스포크 측벽의 에칭 속도에 비례하는 속도로 수축되며 후자는 관심 있는 에칭 속도입니다. 스포크의 기하학적 구조로 인해 스포크 팁의 수축 속도는 측벽의 실제 에칭 속도보다 훨씬 빠릅니다. 따라서 상대적으로 큰 수축 길이는 스포크의 작은 측벽 얇아짐보다 시각화 및 정량화하기가 더 쉽습니다. 증폭 계수는 수레 바퀴에 있는 스포크의 기하학적 배열에 따라 다릅니다. 더 많은 스포크와 더 작은 각도를 가진 수레 바퀴는 더 큰 증폭 계수를 갖습니다. 문헌[15,16,17,18]에 설명된 수레 바퀴는 cm 크기의 직경을 가지며 일반적으로 각도 너비와 간격이 1°인 180개의 스포크를 수용하여 증폭 계수가 115입니다. 대부분의 응용 분야에서 높은 에칭 속도는 원하는; 따라서 대부분의 저자는 상대적으로 뜨겁고(~ 60–80 °C) 상대적으로 농축된(~ 12–25 wt.%) 알칼리성 TMAH 및 KOH 용액에서 실리콘의 이방성 에칭을 연구했습니다. 그러나 저농도 알칼리 용액에서 이방성 에칭에 대해서는 알려진 바가 거의 없으며 저온에서는 더욱 적습니다. 또한 대부분의 경우 가장 진보된 CMOS(Complementary Metal Oxide Semiconductor) 응용 분야에서 nm 크기 구조의 제조 공정 중에 반도체 재료의 나노미터 제거만 필요합니다. 따라서 VLSI(Very Large-Scale Integration)에 사용되는 대부분의 습식 식각 공정에는 몇 나노미터/분 범위의 훨씬 더 낮은 습식 식각 속도가 필요합니다. 따라서 우리는 이전 세대 수레바퀴의 소형화를 제안합니다.
이 작업에서는 축소된 c-Si뿐만 아니라 c-SiGe 왜건 휠도 제작되었습니다. 이와 같이 등방성 및 에칭제의 선택성 요구 사항을 높은 수준의 정확도로 동시에 평가할 수 있습니다. 왜건 휠 기술의 주요 자산은 여전히 재료/에천트 쌍의 이방성 정도를 결정하는 것이기 때문에 먼저 이전 연구에서 cm 크기의 수레 바퀴에서 얻은 결과를 벤치마킹합니다. 그런 다음, 특히 c-Si75의 선택적 에칭을 위한 선택적 및 등방성 에칭제의 개발을 위한 이 기술의 유용성을 설명할 것입니다. Ge25 c-Si와 관련하여.
수레바퀴의 치수는 나노미터 -범위 측벽 손실로 인한 sub -미크론 후퇴 길이. 수레 바퀴 치수는 다음 세 가지 경계 사이의 균형을 기반으로 합니다.
수레 바퀴(내부) 스포크 너비인 최소 임계 치수(CD)에 대한 제약을 설정하는 포토리소그래피 기술입니다.
<리> 2.최대 실제 시야(FoV)를 정의하는 이미징 기술, 따라서 최대 수레 바퀴 지름.
<리> 3.원형 수레 패턴으로 배열할 수 있는 최대 스포크 수 또는 최대 증폭 계수를 정의하는 최소 스포크 쐐기 각도입니다.
이를 고려하여 내부 스포크 폭은 90nm(CD), 수레바퀴 지름 3.8μm(FoV)로 설정하였으며, 32개의 스포크가 원형 패턴으로 배열되어 있다. 이 수레바퀴 디자인은 5.6°의 스포크 각도와 약 20의 증폭 계수를 생성합니다. 이 목적을 위해 전용 마스크가 설계되었습니다(그림 1a). 치수는 Wind et al.에 의해 이전에 제작된 수레 바퀴의 치수와 비교됩니다. (표 1 참조). 수레 바퀴는 3.9μm의 피치로 수직 및 수평 방향으로 정렬되어 두 개의 수레 바퀴 사이에 100nm 공간을 남깁니다(그림 1b). 이 수레 바퀴의 제작은 다음 섹션에서 설명합니다.
<그림>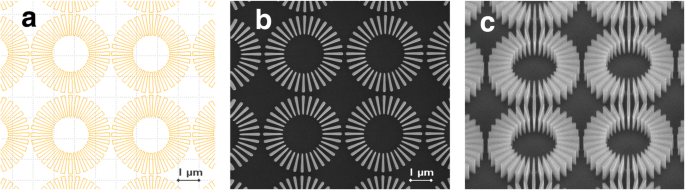
마스크에 설계된 마차 바퀴(a ) 및 나노 제조 공정 후:평면도 SEM(b ), 기울어진 보기 SEM(c )
결정질 실리콘(c-Si) 수레 바퀴는 표준 p형(B-도핑, 1–100 Ohm cm) 300mm Si(100) 및 Si(110) 웨이퍼에서 제작되었습니다. 패터닝 프로세스는 30nm 실리콘 질화물, 160nm 비정질 탄소(APF), 20nm 실리콘 질화물 및 30nm 비정질 Si로 구성된 (위에서 아래로) 하드마스크 스택의 증착으로 구성되었습니다. 193nm 침지 리소그래피를 사용하여 패턴을 포토레지스트에 전사했습니다. 포토레지스트가 현상된 후, 포토레지스트와 APF 스트립을 포함하는 플라즈마 에칭을 사용하여 수레바퀴 패턴을 에칭했습니다. SiN 층인 하드마스크 스택의 바닥 층은 뜨거운 인산을 사용하여 제거되었습니다(6분 85wt% H3 PO4 160 °C에서) 또는 불화수소산(5분 10wt.% HF). 그림 1c는 제작된 수레 바퀴의 기울어진 SEM 보기를 보여줍니다.
결정질 실리콘-게르마늄 수레 바퀴(c-Si75 Ge25 ) 또한 표준 p형(B-도핑, 1–100 Ohm cm) 300mm Si(100) 또는 Si(110) 웨이퍼에서 제작되었습니다. 패터닝 전에 약 600nm 도핑되지 않은 Si75 층 Ge25 에피택셜로 증착되었습니다. 그 후 Si wagon-wheels와 동일한 패터닝 단계를 수행하여 c-Si75가 생성되었습니다. Ge25 수레 바퀴 스포크.
(an)등방성 습식 에칭 테스트 전에 SPM 세척(5분 H2 SO4 :H2 O2 3:1 at 60 °C), 유기잔류물 제거를 목적으로 한 후 1 wt.% HF 수용액에 2분간 담그면서 산화막을 제거하였다. SPM 및 HF 세척 공정 직후에 에칭액 이방성은 실온(RT)에서 교반되지 않은 에칭액 샘플에 테스트 패턴을 배치하여 분석됩니다. TMAH 및 NH4 OH 에천트 용액은 25 wt.% TMAH 또는 29 wt.% NH4의 희석에 의해 준비되었습니다. 오. 9.5부의 H2를 혼합하여 과아세트산(PAA) 용액을 제조했습니다. O2 (30중량%), 11부의 아세트산(98중량%), 및 0.1부의 HF(49중량%). 이 에칭 용액은 Six를 선택적으로 에칭하는 것으로 알려져 있습니다. Ge1-x 순수 Si 이상의 합금 [19, 20]. SiGe 에칭을 위한 산화 종으로 작용하는 PAA는 아세트산과 과산화물과 촉매로 HF를 반응시켜 형성됩니다. 그러나 평형에 도달하려면 일정한 시간이 필요합니다. 따라서 솔루션은 1주일 동안 숙성되었습니다. 에칭액 이방성 및 선택성은 RT에서 교반되지 않은 에칭액 샘플에 테스트 패턴을 배치하여 분석되었습니다. 에칭 직후 샘플을 탈이온수로 30초 동안 헹구고 질소 가스로 건조했습니다.
Si(100) 웨이퍼에 제작된 실리콘 수레 바퀴가 RT에서 저농도 TMAH(5wt.%)로 에칭될 때 다음과 같은 관찰이 가능합니다(그림 2). 첫째, Si의 특징적인 4중 대칭 (100) 웨이퍼는 수레바퀴의 이방성 에칭을 통해 드러난다. 둘째, 다양한 결정학적 평면의 방향 종속 에칭 속도를 시각적으로 추론할 수 있습니다. 왜건 휠의 상대적으로 빠른 에칭 스포크는 {110} 및 인접 {110} 측벽 평면으로 정의되는 반면 느린 에칭 스포크는 다음과 같이 정의됩니다. {100} 및 인접{100} 측벽면 이 주요 관찰 외에도 저농도 및 RT TMAH에서 Si의 에칭 속도 순서는 R을 따릅니다. (110)> R (100) , 다른 이방성 효과를 식별할 수 있습니다. 예를 들어 4개의 {110} 평면에 해당하는 4개의 스포크는 가장 빠른 에칭 스포크가 아닙니다. 더 정확하게는 이러한 {110} 평면의 2개 인접 스포크입니다. 따라서 {110} 주변의 에칭 레이트는 2개의 등가 최대값으로 분할되고 {110} 평면은 로컬 최소값입니다. 이는 [21,22,23]에 의해 수행된 유사한 관찰에 해당합니다. 여기서 {110} 평면의 낮은 에칭율은 TMA + 에 의한 차단 효과에 기인합니다. 이온.
<그림>
아 RT 및 확대(b)에서 저농도 TMAH(5중량%)로 에칭된 Si(100) 수레바퀴의 TD SEM ) 점선으로 표시된 것처럼 더 빠른 에칭 평면/면의 발달을 보여줍니다.
이방성 에칭의 또 다른 결과는 4개의 {100} 스포크의 외부 스포크 끝단의 특정 모양입니다. 가장 빠른 볼록한 표면에 대해 에칭 평면이 드러날 것입니다. 처음에는 스포크 끝이 볼록한 표면이므로 특정 에칭 시간이 지나면 더 빠른 에칭 {110} 평면이 나타나 외부 스포크 끝에서 면을 형성합니다. 이것은 <100> 방향을 따른 스포크에서 가장 분명합니다(그림 2의 확대 b).
오목의 경우 그러나 표면적으로는 가장 느림 에칭 평면이 공개됩니다. 왜건 휠 스포크를 에칭하는 동안 스포크를 둘러싼 Si(100) 기판도 에칭됩니다. 이 베이스 기판 전환은 오목한 표면입니다. 따라서 가장 느린 에칭 평면인 {111} 평면이 표시되어야 합니다. 이러한 {111} 평면은 Si(100) 기판의 <110> 방향과 정렬된 것처럼 보입니다. 실제로, 그림 3b에서 TMAH에서 에칭한 후 {111} 평면이 드러났고, <110> 방향을 따라 모든 스포크에 대해 경사진 {111} 평면이 있는 베이스를 형성했습니다.
<그림>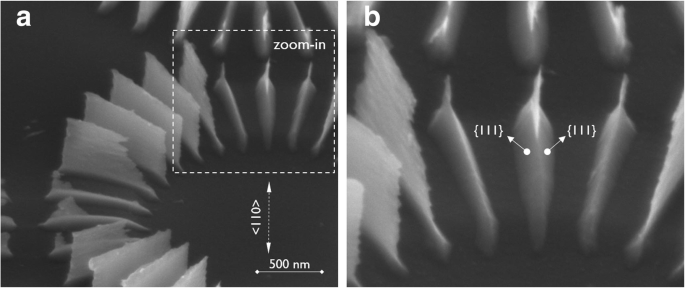
아 RT 및 확대(b)에서 저농도 TMAH(5중량%)로 에칭된 Si(100) 수레 바퀴의 기울어진 SEM 이미지 ) 기울어진 {111} 평면 표시
Si(100) 수레바퀴와 유사하게, Si(110) 수레바퀴는 실온에서 저농도 TMAH(5중량%)로 에칭되었습니다. Si(100) 웨이퍼의 4중 대칭 대신에 Si(110)의 2중 대칭이 나타납니다. 일부 {100}, {110}, {111} 및 {211} 평면의 결정학적 방향은 그림 4a에 할당되어 있습니다. 등방성 평가를 위해 Si(110) 기판을 사용할 때의 이점 중 하나는 수레 바퀴 스포크의 측벽으로 표시되는 수직 {111} 평면의 존재입니다. 도 4에서 볼 수 있는 바와 같이, 이들은 가장 느린 에칭 평면이다. 가장 빠른 에칭 평면은 {110} 및 {211} 평면인 것 같습니다. {100} 평면에서 중간 식각률이 발견되었습니다. 따라서 R (110) ~ R (211)> R (100)> R (111) , Si(100)에서 얻은 결과와 일치합니다.
<그림>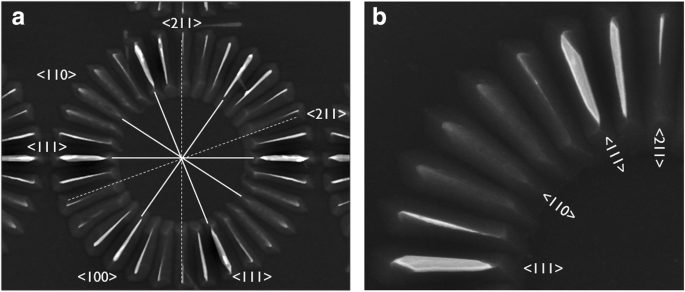
아 RT 및 확대(b)에서 저농도 TMAH(5중량%)로 에칭된 Si(110) 수레바퀴의 TD-SEM ) <111> 지향 스포크에서 패싯 형성을 보여줍니다. 주요 결정학적 방향(또는 등가 평면)은 실선으로 표시되고 더 높은 굴절률 평면은 점선으로 표시됩니다.
그림 4b에서 가장 느린 에칭 {111} 스포크의 끝이 둥근 모양에서 화살표 모양으로 진화하여 비대칭 평행사변형을 형성하는 것을 볼 수 있습니다. 이러한 패싯이 형성되는 근본적인 원인은 {110} 및 {211} 평면의 더 빠른 에칭입니다.
TMAH 및 TMAH/IPA 혼합물은 높은 에칭율과 이방성의 조정이 필요한 MEMS 구조의 제조를 위해 잘 연구되고 일반적으로 사용되는 에칭제입니다. 따라서 TMAH에서 Si 에칭에 대한 대부분의 연구는 더 높은 온도와 농도에서 수행되었습니다. 일반적인 농도 범위는 10~25wt.% TMAH 및 60~90°C의 온도 범위입니다[12,13,14, 23]. 몇몇 연구 그룹은 우리 연구와 같이 약 5wt.%의 낮은 농도에서 에칭 테스트를 수행했지만 여전히 60–90 °C의 고온을 사용했습니다[24,25,26]. R (110) /R (100) 비율은 일반적으로 고농도 및 고온의 경우 약 2이며 감소에 따라 증가하는 것으로 보입니다. TMAH 온도(추가 파일 1:S1). 이 연구는 나노스케일 에칭 응용에 초점을 맞추기 때문에 높은 에칭 속도는 추구되지 않습니다. 따라서 에칭 현상을 관찰하고 구조의 완전한 용해를 피하기 위해 허용 가능한 시간 창을 갖기 위해 낮은(RT) 온도가 선택되었습니다. 같은 순서의 속도, R (110)> R (100) , RT 및 5wt.% TMAH에서 수행된 이 연구에서 관찰되었지만 R의 계산된 값 (110) /R (100) 비율은 2보다 훨씬 높습니다(참고문헌 [27] 참조). 따라서 이것은 이 이방성 비율이 감소함에 따라 증가하는 경향을 확인시켜줍니다. TMAH 온도. 운동학적 및 원자론적 측면을 포함하여 이 관찰에 대한 자세한 기계론적 설명은 이 작업의 범위를 벗어납니다. 그러나 TMAH에서 실리콘 에칭에 대한 위의 비교를 기반으로 축소된 수레바퀴는 에칭제의 이방성 거동을 감지하고 비교하는 데 필요한 감도를 제공한다고 결론지을 수 있습니다.
Si(100) 수레바퀴와 Si(110) 수레바퀴는 저농도(0.4wt.%) 수산화암모늄(NH4 오) 실온에서. 전자(그림 5, 왼쪽)에서 Si(100) 웨이퍼의 4중 대칭이 나타납니다. 이론적으로 <110> 방향에 대해 18.4° 및 26.6°인 <210> 및 <310> 방향을 따른 스포크는 세 번째 스포크로 가장 잘 표현됩니다(상단 '북쪽' 스포크에서 계산 ) 측벽이 19.7° 및 25.3°인 것이 가장 빠른 에칭 스포크입니다. 스포크는 스포크에 비해 에칭 속도가 느리고 이 스포크의 바깥쪽 끝에서 패싯이 발생합니다. 이러한 패싯은 아마도 빠른 에칭 {210} 및 {310} 평면이며 특히 더 긴 에칭 시간에 대해 {110} 스포크의 전체 더 빠른 겉보기 에칭 속도에 기여할 수 있습니다. 따라서 관찰된 에칭 속도는 R을 따릅니다. (310) ~ R (210)> R (100) ~ R (110) .
<그림>
RT에서 저농도 NH4OH(0.4중량%)로 에칭된 Si(100)(왼쪽) 및 Si(110) 수레바퀴(오른쪽)의 TD SEM 이미지. 특정 결정학적 방향은 [ ]로 표시되고, 등가 방향은 <>로 표시됩니다. 주요 결정학적 방향(또는 등가 평면)은 실선으로 표시되고 더 높은 굴절률 평면은 점선으로 표시됩니다.
Si(110) 수레 바퀴(그림 5, 오른쪽)의 경우 NH4의 이방성 에칭을 통해 (100) 및 (110) 평면 주위의 이중 대칭이 나타납니다. 오. 측벽이 있는 <111> 방향의 스포크는 가장 느린 에칭 스포크 또는 평면으로 나타납니다. 가장 빠른 에칭 스포크는 높은 굴절률 {211} 및 {311} 평면으로 정의됩니다. {110} 및 {100}에는 중간 에칭 속도가 있습니다. 따라서 Si(110) 결과는 NH4의 Si(100) 결과와 일치합니다. 오. 또한 Si(110) 왜건 휠의 경우, 특히 {111} 및 {100} 스포크의 바깥쪽 끝에서 스포크의 패싯이 눈에 띄게 나타납니다. 패싯은 아마도 더 빠른 에칭 {211} 및 {311} 평면의 개발일 것입니다.
문헌에서 NH4의 에칭 속도 이방성에 대한 제한된 정보를 사용할 수 있습니다. 오. 그러나 NH4 수용액 OH는 다른 OH와 유사한 특성을 갖는 등방성 에칭제로도 사용되었습니다[28]. Si etchant를 포함합니다. 이점은 금속을 포함하지 않는다는 것입니다(예:K + , 나 + , C + , ...). 따라서 NH4 OH는 조사할 가치가 있는 IC 호환 에칭액입니다. Schnakenberg et al. R (111) /R (100) 3.7 wt.% NH4에서 에칭된 수레바퀴형 에칭 패턴에 대한 에칭율 비율 75°C에서 OH는 약 0.04이고 R (110) /R (100) 에칭 속도 비율 0.3 [28]. 나중 결과는 R에 대한 0.5의 추정 에칭 비율과 잘 비교됩니다. (110) /R (100) .
우리의 결과로부터 NH4에서 Si의 에칭이 OH는 TMAH와 비교하여 다른 수레바퀴 에칭 패턴을 제공합니다. [OH - 에는 약간의 차이가 있지만 ] 두 에칭 용액(~ 0.12 M 대 ~ 0.55 M)에 대해 TMAH 및 NH4의 에칭 모두 OH는 동일한 온도(RT)에서 수행되었습니다. 유일한 나머지 차이점은 반대 양이온입니다. 부피가 더 큰(CH3 )4 N + 더 작은 NH4에 비해 + 양이온. 에칭제 용액의 양이온이 표면에 부착되어 다른 에칭 평면과 관련된 다른 하이드록실 말단 Si 표면 사이트를 선택적으로 차단할 수 있다는 것이 지적되었습니다[29, 30]. 다른 평면의 에칭 속도가 다르게 영향을 받을 때마다 이방성이 변경됩니다.
이 섹션에서 우리는 에칭율과 에칭액의 선택성을 평가하기 위해 축소된 마차 휠의 가능성을 보여주고 논의할 것입니다. Si/Si75 Ge25 쌍은 희생 c-Si75 Ge25 중간층은 c-Si 나노와이어를 향해 등방성 및 선택적으로 에칭되어야 합니다. 에칭은 HF, H2의 혼합물로 준비된 선택적 에칭액에서 수행됩니다. O2 , 및 CH3 쿠. 이 혼합물은 과아세트산(CH3 CO3 H) 과산화물과 아세트산 사이의 산 촉매 반응 때문입니다[31, 32]. 특정 숙성 시간이 지나면 평형 농도에 도달합니다. 이렇게 형성된 PAA는 Si75의 효과적이고 선택적인 산화제입니다. Ge25 . SiGe의 선택적 산화 후, SiGe 산화물은 두 번째 확산 제한 반응에서 HF에 의해 용해됩니다.
c-Si75 Ge25 수레바퀴 샘플을 PAA 용액에 담그어 시간을 늘렸습니다(t 0 + 30초, + 60초, ...+ 180초) 및 왜건 휠 스포크의 에칭은 후속 하향식 SEM 측정에 의해 모니터링되었습니다. 스포크의 너비는 10nm 이상인 경우 기존 SEM으로 안정적으로 측정할 수 있습니다. 결과는 그림 6의 시계열에 나와 있습니다. 처음에 수레 바퀴 스포크는 측벽의 에칭으로 인해 얇아집니다. 모든 Si75 Ge25 스포크는 균일하게 얇아져 에칭이 등방성임을 증명합니다. 약 90초 후에 스포크 팁이 수축되기 시작하여 증폭 효과가 시작되었음을 나타냅니다. 우리는 이 증폭 효과가 스포크 팁이 날카로운 팁으로 진화한 후에만 나타나기 시작한다는 것을 관찰했습니다. t에 0 , 스포크의 끝은 여전히 둥글다. 스포크의 초기 에칭 단계(t <90초), 둥근 팁은 단지 날카로운 팁으로 변형되고 스포크가 수축되기 시작합니다(추가 파일 1:S2 참조). 이 발견은 t에서 수레 바퀴 스포크 모양에 대해 명확하게 설명됩니다. =180초:팁 수축으로 인해 스포크의 대략 절반이 에칭되었습니다(∆l은 대략 450nm임). 그러나 측벽이 양쪽에서 ∆w~∆l/20 =22.5nm만큼만 수축되기 때문에 적어도 스포크의 가장 넓은 끝 부분에는 여전히 약간의 SiGe가 남아 있습니다. 결과적으로 중요한 시간(t 크리티컬 ), 수축 길이(∆l)는 Si75의 에칭 속도를 간접적으로 계산하는 데 사용할 수 있습니다. Ge25 스포크. 그러나 이 t 전에 크리티컬 , 식각률은 측정하기 어려운 측벽 손실(∆w)을 직접 측정해야만 계산할 수 있습니다. 측벽 손실을 직접 측정하고 스포크 수축을 간접적으로 측정하여 얻은 PAA에서 Si 및 SiGe의 식각 속도를 비교한 결과가 표 2에 나와 있습니다. 식각 속도는 시간에 따른 측벽 폭 감소의 기울기와 시간에 대한 증가하는 스포크 수축 길이의 기울기. 후자의 기울기는 t 이후의 데이터 포인트를 사용하여 계산되었습니다. 크리티컬 측벽 폭은 적어도 약 10nm에 이르는 기존 SEM의 관찰 한계까지 선형적으로 감소하는 것으로 보입니다. 이러한 피처 크기까지 우리는 스포크가 점진적으로 얇아지는 동안 에칭 속도의 현저한 변화를 관찰하지 못했습니다(그림 7 및 9).
<그림>
PAA 솔루션에서 Si75Ge25(100) 왜건 휠의 에칭 시계열
<그림>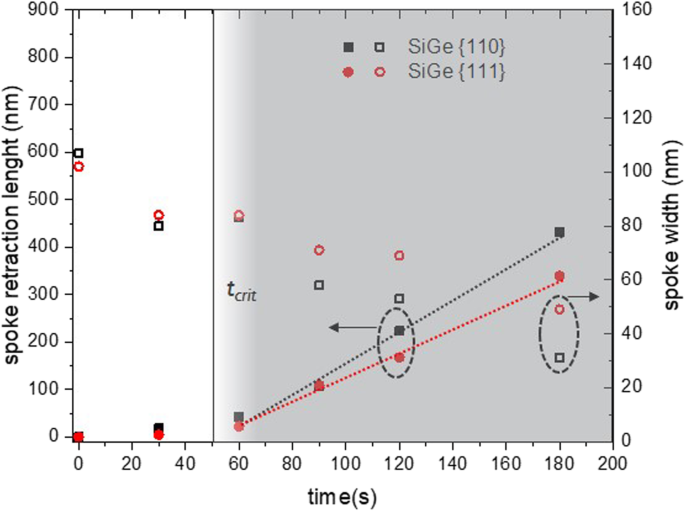
Si75Ge25 스포크 에칭:스포크 폭은 점진적으로 감소하지만 특정 임계값 이후에만 스포크 팁이 수축되기 시작하고 측정된 수축 길이 Si75Ge25는 a.f.o. 에칭 시간(회색 음영 영역)
SiGe 에칭제에 대한 에칭 속도를 얻는 것 외에도 에칭제의 등방성 거동을 확인했습니다. 모든 다른 방향의 스포크는 동일한 에칭 속도로, 즉 등방성으로 에칭된다는 것이 분명합니다. 따라서 이것은 반응 속도가 Si75가 아닌 산화물 용해 속도에 의해 제어되는 공정을 가리킵니다. Ge25 산화율. 산화물 용해는 활성화 에너지가 낮고 확산이 제한적이며 이방성 거동을 일으키지 않습니다.
c-Si75에서 얻은 결과 Ge25 (100) 수레 바퀴는 c-Si75로 검증되었습니다. Ge25 (110) 수레 바퀴. 실리콘 수레 바퀴에 대해 설명한 것처럼 (110) 기판을 사용할 때의 한 가지 이점은 수레 바퀴 스포크의 측벽으로 표시되는 수직 {111} 평면의 추가 존재입니다. 이들은 일반적으로 가장 느린 에칭 평면/스포크입니다. 따라서 Si75의 등방성의 완전한 이미지를 얻으려면 이러한 스포크를 주의 깊게 관찰해야 합니다. Ge25 -PAA 에칭제 쌍. 결과(추가 파일 1:S3.1 참조)는 Si75로 얻은 에칭 결과와 일치합니다. Ge25 (100) 수레 바퀴(그림 6). 에칭은 먼저 얇아지고 스포크 팁 후퇴로 점진적으로 진행되었습니다. 가장 긴 에칭 시간(t =180초). 그러나 ∆l의 특정 각도 의존성이라는 명확한 경향이 없었기 때문에 이는 등방성에 기인하지 않았다. 우리는 이것이 제조 후 스포크 너비의 더 큰 변화(스포크 간 및 스포크 내)에 기인한다고 생각합니다. 실제로 참조 사진에서 이미 볼 수 있습니다(t 0 ) 측벽이 완벽하게 직선이 아닙니다. 이 측벽 거칠기는 아마도 에피택셜로 증착된 Si75의 이완 결함 때문일 것입니다. Ge25 (110) 기판 상의 층. 요약하면, 둘 다 c-Si75 Ge25 (100) 및 (110) 왜건 휠은 PAA 용액에서 등방성으로 에칭되어 c-Si75를 빠르고 완벽하게 제거하는 이점이 있습니다. Ge25 , 차단 평면을 형성하지 않는 경향이 있기 때문에 희생 물질로 사용됩니다.
PAA의 습식 에칭은 c-Si wagon-wheel에 대해 반복되었습니다. 이 테스트의 목적은 실리콘에 대한 에칭액의 선택성을 확인하는 것입니다. 샘플을 시간을 늘리기 위해 동일한 PAA 용액에 담그었습니다(t 0 + 15분, + 30분, ...+ 90분). 에칭 시간은 분 단위입니다. Si75의 경우 초 단위가 아닙니다. Ge25 수레바퀴. 이러한 연장된 에칭 시간은 이 에칭제의 목적이 실리콘을 보존하는 것이더라도 모든 Si 에칭을 관찰하기 위한 것입니다.
에칭 시간은 다르지만 Si75의 경우와 유사한 관찰 Ge25 수레 바퀴 스포크가 만들어졌습니다. 처음에는 상대적으로 느린 측벽 에칭으로 인해 실리콘 스포크가 점차 얇아지고 시간이 지나면 t 크리티컬 , 이 경우 약 45분 후에 증폭 효과로 인해 스포크가 상대적으로 빠르게 수축되기 시작합니다(그림 8 및 9). 모든 경우에 에칭은 등방성으로 보입니다. c-Si(100) 수레바퀴로 얻은 시계열(추가 파일 1:S3.2 참조)은 c-Si(110) 수레바퀴로 얻은 시계열과 일치합니다(그림 8).
<그림>
PAA 솔루션에서 Si(110) 왜건 휠의 에칭 시계열. 다른 방향에 비해 <111> 스포크의 에칭 속도가 약간 더 느리며 이미지 t에서 가장 잘 식별할 수 있습니다. 0 + 90분, 점선으로 표시
<그림>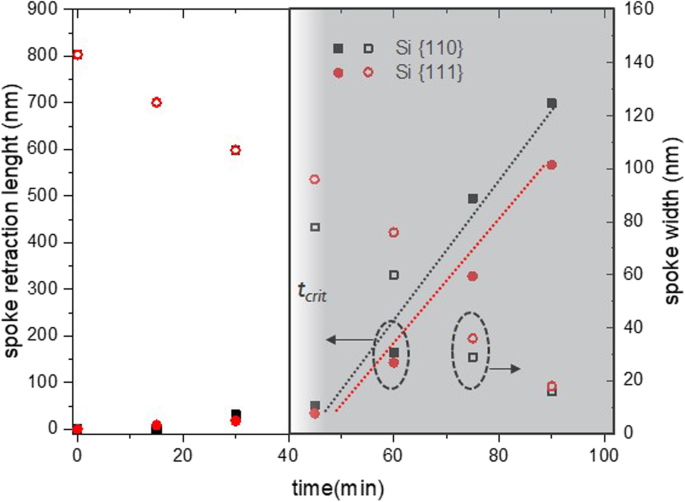
Etching of Si spokes:the spoke width decreases gradually, but only after a certain tcrit., the spoke tips start to retract, and the measured retraction lengths can be fitted linearly a.f.o. etching time (gray-shaded area)
Calculated etch rates are shown in Table 2. Both measurement methods give comparable etching rates with only a 7% and 4% difference in the etch rate values of the {111} and {110} planes, respectively. The values of the Si etching rate are all < 1 nm/min. Holländer et al. measured Si(100) etch rates of ~ 10 nm/min with HF:H2 O2 :CH3 COOH 1:2:3 with a HF concentration of 1.6 wt.% and Wieser et al. measured etch rates of ~ 3 and 5 nm/min for undoped Si(111) and Si(100), respectively with BHF:H2 O2 :CH3 COOH 1:2:3 solutions with a HF concentration of 1 wt.% [33, 34]. Our values compare well with those reported values, considering that the HF concentration in our tests are lower ([HF] =0.25 wt.%). Our results also suggest a slightly lower etching rate of the {111} planes, measured on Si(110) substrates, compared to the {110} planes, measured on Si(100) substrates. These quantitative results point toward a very low etching anisotropy of Si in PAA which is hardly observable by the top-down SEM images. For the sake of clarity, the {111} planes of the wagon-wheel at t 0 + 90 min in Fig. 8 are indicated and it can be noticed that the {111} spokes are slightly broader and longer than the surrounding spokes. This demonstrates again that these scaled-down wagon-wheels are sensitive to detect very faint differences in the crystallographic plane-dependent etch rates (‘anisotropy’) of etchants.
The selectivity ratios of the Si75 Ge25 /Si pair in PAA were extracted from the etching rates in Table 2. The selectivity ratios of Si75 Ge25 (111)/Si(111) range between 11.0 and 12.6 while the Si75 Ge25 (110)/Si(110) ratios are slightly higher, between 14.2 and 16.8. These values are slightly lower than the reported values from Holländer et al. who claim selectivities around ~ 20 [33]. This can be attributed to the higher SiGe etch rates (11–17 nm/min) due to the dynamic process conditions (wafer rotation) in contrast to our static process conditions (no stirring) in which case the SiGe etch rates were ranging between 7.8 and 12.3 nm/min. Interestingly, this confirms the observed isotropic etching of SiGe in PAA:since the reaction rate is kinetically controlled (by stirring or rotation), the rate determining step (RDS) is most probably the diffusion controlled SiGe-oxide dissolution by HF.
Scaled-down wagon-wheels with a diameter of 4 μm and 32 spokes exposing the different crystallographic planes were fabricated on 300-mm-diameter wafers. The structures were patterned on Si(100), Si(110), Si75 Ge25 (100), and Si75 Ge25 (110) substrates allowing the observation of the etching of the three main crystallographic orientations of c-Si and c-Si75 Ge25 ({111}, {110}, and {100}) as well as higher index planes. The structures proved to be valuable for the evaluation of the isotropic or anisotropic behavior of etchants by simple inspection by TD SEM. Various alkaline as well as acidic etchants were evaluated by image analysis of their characteristic wagon-wheel etching pattern. Trends in etching ratios were in good agreement with previous works. In TMAH, the plane-dependent etching rate of silicon follows the order:R (110) ~ R (211)> R (100)> R (111) . In NH4 OH, on the other hand, the etching rate follows the order:R (310) ~ R (210)> R (100) ~ R (110)> R (111) . Besides the relative etching rates of the main crystallographic planes, other anisotropic features, like facets, were observed, indicating that the structures are very sensitive to changes in the anisotropic properties of the etchant.
In addition to their capacity for the revelation of the (an)isotropy of etchants, these wagon-wheel structures also demonstrate their benefit for the assessment of the selectivity of etchants. For this purpose, the system PAA/Si/Si75 Ge25 was assessed in terms of Si75 Ge25 etching, selective toward Si. Selectivity values were obtained by two methods:the first by measurement of the sidewall loss of the spokes; the second, indirect method, through measurement of the spoke retraction lengths. It was shown that the latter method could only be used after a certain critical etching time, after which the spoke tips have evolved toward a seemingly sharp tip.
In conclusion, scaled-down wagon-wheels can be used as lab-scale vehicles for the swift evaluation of anisotropy and selectivity of material/etchant pairs. The structures also have the potential to be used as high-throughput short loop test structures for the screening of etchants on 300 mm wafer wet processing tools. In addition, due to their small size, these wagon-wheels could be used for future in-situ etching studies, using liquid cell environmental electron transmission microscopy ETEM.
All data are fully available without restriction.
acetic acid
buffered hydrofluoric acid
critical Dimension
complementary metal oxide semiconductor
single-crystalline silicon
single-crystalline silicon-germanium
environmental electron transmission microscopy
fin field effect transistor
field of view
gate all around
hydrofluoric acid
microelectromechanical systems
peracetic acid
etch rate of a (xyz) plane
rate determining step
scanning electron microscopy
tetramethyl ammonium hydroxide
very large-scale integration
나노물질
자동차 세계와 같은 대규모 산업에서 코딩은 추적 목적에 필수적이 되었습니다. 차량에는 여러 개별 부품이 포함되어 있으며, 모두 제조업체에서 추적할 수 있도록 코드와 부품 번호가 필요합니다. 부품 위조는 이 산업에서 심각한 문제였으며, 업계 표준에 부합하는 부품으로 만든 양질의 차량만 생산하려는 자동차 회사의 욕구를 무너뜨렸습니다. 따라서 제조업체에 따라 코드는 내부 추적성을 위해 제거 가능하거나 고객 추적성에 대한 요구 사항을 충족하기 위해 오래 지속되어야 합니다. 코드는 위조 방지를 위해 신중해야 할 수도 있습니다. 업계에서
로봇은 수년 동안 항공우주 산업에서 사용되어 왔으며 현재 도장 자동화의 두 가지 주요 이점인 속도와 정확성 때문에 그 어느 때보다 많이 활용되고 있습니다. Robotxworld.com의 2013년 6월 기사에 따르면 보잉은 로봇을 사용하여 777 비행기의 166피트 날개를 칠하고 있습니다. 이 프로세스는 인간 작업자가 최대 4시간 30분이 걸리는 반면 로봇은 24분 안에 완료할 수 있습니다. 이러한 속도는 페인팅 프로세스 자동화의 매력적인 이점 중 하나입니다. 페인팅 자동화의 또 다른 이점은 무엇입니까? 오버 스프레이 부족. 로