나노물질








수직으로 정렬된 Si 나노와이어(Si NW)의 주기적으로 정렬된 어레이는 금속 보조 화학 에칭과 결합된 나노구 리소그래피에 의해 성공적으로 제조됩니다. 에칭 시간을 조정하여 나노와이어의 직경과 길이를 모두 잘 제어할 수 있습니다. 이러한 Si NW의 전도성 특성과 특히 크기 의존성은 개별 나노와이어에 대한 전도성 원자력 현미경(CAFM)으로 조사됩니다. 결과는 Si NW의 컨덕턴스가 직경 및 길이와 크게 관련이 있음을 나타냅니다. 더 작은 직경과 더 짧은 길이를 가진 Si NW는 더 나은 전도성을 나타냅니다. I-V 곡선 특성화와 함께 가능한 메커니즘은 크기 종속 쇼트키 장벽 높이의 관점에서 가정되며, 이는 EFM(정전기 힘 현미경) 측정에 의해 추가로 확인됩니다. 이 연구는 또한 CAFM이 개별 나노구조에 대한 전도성 특성의 크기(또는 기타 매개변수) 의존성을 탐색하는 효과적인 수단으로 작용할 수 있음을 시사하며, 이는 나노구조의 제조 최적화와 잠재적 응용 모두에 필수적이어야 합니다.
실리콘 나노와이어(Si NW)는 높은 종횡비와 고유한 전기적, 열전 및 광전 특성뿐만 아니라 기존 실리콘 기술과의 호환성으로 인해 전자, 광자, 광전자 및 기타 여러 분야에서 유망한 응용 분야를 얻었습니다[1,2,3 ,4,5]. 지난 수십 년 동안 Si NW의 연구는 주로 성장 개선 및 속성 측정에 중점을 두었습니다. 기체-액체-고체 방법, 화학 기상 증착 및 분자 빔 에피택시와 같은 상향식 방법[6,7,8,9,10] 및 전자를 사용한 하향식 접근 방식을 포함하여 Si NW를 제조하기 위해 많은 방법이 개발되었습니다. -빔 리소그래피, 반응성 이온 에칭 또는 금속 보조 화학 에칭 [11,12,13,14,15,16]. 이러한 방법들 중에서, 금속 보조 화학 에칭(MACE)과 결합된 나노구 리소그래피(NSL)는 단순성, 저렴한 비용 및 다용성을 위해 수직으로 정렬된 Si NW의 대면적 정렬 어레이를 제조하기 위해 집중적으로 채택되었습니다[15,16,17 ,18,19,20,21,22,23]. MACE에 의해 달성된 Si NW는 일반적으로 매우 거칠고 균일한 다공성 표면을 가지므로[18,19,20,21], 이는 큰 비표면적과 우수한 특성을 갖도록 하여 바이오센서, 열전 장치, 리튬에 큰 응용 가능성을 제공합니다. -이온 배터리, 태양 전지 등 [22,23,24]. 이러한 응용을 실현하려면 전기적 특성을 잘 이해하는 것이 중요합니다. 최근에는 나노와이어의 전기적 특성을 조사하기 위해 두 가지 방법이 종종 적용되고 있다. 하나는 상대적으로 수행하기 쉽지만 나노와이어의 대규모 어셈블리에 대한 평균 결과를 제공할 수 있는 일반적인 거시적 방법으로 수행됩니다[24, 25]. 다른 하나는 특수 제작된 단일 나노와이어 장치[21, 26, 27, 28]로 개별 나노와이어에 대해 수행되며, 이는 크기 불균일성의 영향을 배제할 수 있지만 특히 속성 의존성을 측정할 때 달성하기 쉽지 않습니다. 따라서 복잡한 나노가공 없이 개별 NW의 전기적 특성을 연구하기 위한 보다 편리한 방법이 강력히 요구됩니다.
최근 수십 년 동안 SPM(Scanning Probe Microscopy) 기반 전기 측정은 나노 규모의 전기 특성화를 위한 강력한 기술로 스스로를 드러냈습니다[29, 30]. 이러한 SPM 기술 중 CAFM(conductive atomic force microscopy)은 단일 또는 개별 나노구조의 전도성을 연구하는 데 성공적으로 적용되었습니다[30,31,32]. ZnO, InAs, CdS, CdSe, GaAs, InAsSb 및 Si NW와 같은 다양한 나노와이어에 대한 CAFM 조사는 이미 보고되었습니다[33,34,35,36,37,38]. 대부분의 연구는 고정된 매개변수를 갖는 나노와이어의 전도성 특성에 초점을 맞추었지만 일부 조사는 전도성 특성의 도핑 의존성을 조사하기 위해 수행되었습니다[37,38,39]. 나노와이어의 전도성 특성의 크기 의존성은 아직 많이 조사되지 않았습니다. CAFM에 국한되지 않고 나노와이어의 직경 의존적 전도성 특성에 대한 연구는 소수에 불과하며, 그 중 상당 부분이 나노와이어 저항의 직경 의존성을 다룬다[25, 40, 41, 42]. 예를 들어, GaN 나노와이어에 대한 몇 가지 연구에서는 저항률이 임계 직경(20 ~ 80 nm, 제조 방법에 따라 다름)에서 높고 그 이상에서 변하지 않은 채로 유지된다는 것을 발견했습니다[41, 43]. 반면 Si 나노와이어에 대한 다른 연구에서는 다음과 같이 보고했습니다. 나노와이어 저항은 수십에서 수백 나노미터 범위에서 직경이 증가함에 따라 감소했습니다[40, 44]. 금속 접촉을 갖는 반도체 나노와이어의 경우 쇼트키 장벽은 전도성 특성에 중요한 역할을 할 수 있습니다. 따라서 반도체 나노와이어 존재 시 저항률을 제외하고는 쇼트키 장벽을 고려해야 한다. 여러 논문에서 쇼트키 장벽 높이(SBH)의 직경 의존성에 초점을 맞추었지만 결과는 일치하지 않습니다. 예를 들어, Calahorra et al. 나노와이어에서 푸아송 방정식을 풀어서 SBH를 계산했고, 크기 감소에 따라 장벽 높이가 증가하는 분명한 경향을 발견했습니다[45]. 유사한 직경 의존성이 Soudi et al.에 의해 실험적으로 보고되었습니다. ZnO 단일 나노와이어 소자에서 직경 의존적 표면 광전압 및 표면 상태 밀도를 조사할 때. 그들은 표면 장벽 높이가 감소하는 직경(20–60 nm)에 따라 증가한다는 것을 발견했으며, 이는 Poisson의 방정식을 사용하여 시뮬레이션된 표면 상태 밀도로 해석됩니다[46]. 대조적으로, Yun et al. 반대의 의존성, 즉 경계면 상태의 기여로 인해 직경이 감소함에 따라 장벽 높이가 감소하는 것으로 나타났습니다[47]. Mao et al.의 또 다른 실험 작업. 단일 Pt/ZnO 나노바늘 쇼트키 다이오드에서 직경이 감소함에 따라 장벽 높이가 감소한다고 보고했으며, 이는 줄 가열 효과 및/또는 계면의 전자적 불균일성으로 설명됩니다[48]. 따라서 지금까지 나노와이어의 전도성 특성의 직경 의존성은 아직 합의에 이르지 못했고 완전히 이해되지 않았습니다. 특히, MACE 방법으로 제작된 개별 Si NW에 대한 크기 의존적 전도성 특성과 크기 의존적 SBH 연구는 보고되지 않았으며, 이는 유망한 응용 분야에 대해 상당히 거친 표면을 가지고 있습니다.
본 논문에서는 MACE와 NSL을 결합한 방법으로 직경과 길이가 다른 수직으로 정렬된 Si NW의 주기적 배열을 준비합니다. SiNW의 직경과 길이는 에칭 시간을 조정하여 잘 제어할 수 있습니다. 어레이 내부의 개별 Si NW의 전도성 특성은 추가 나노가공 없이 CAFM에 의해 조사되며, 이는 단순히 샘플을 교체함으로써 개별 Si NW의 크기 종속 전도성 특성을 편리하게 연구할 수 있습니다. 결과는 개별 Si NW에서 측정된 전류가 NW의 직경과 길이에 크게 의존함을 보여줍니다. 더 작은 직경과 더 짧은 길이를 가진 Si NW는 더 나은 전도성을 나타냅니다. I-V 곡선 피팅에서 크기 종속 쇼트키 장벽 높이를 얻을 수 있으며 이는 나노와이어의 크기 종속 전도성 특성을 결정하는 핵심 요소로 작용하는 것으로 밝혀졌습니다. 또한, EFM(electrostatic force microscopy) 측정에 의해 유사한 크기 의존 SBH를 얻었다. 따라서 우리의 연구는 Si NW의 크기 종속 특성을 드러낼 뿐만 아니라 CAFM이 개별 나노구조에 대한 전도성 특성의 크기(또는 기타 매개변수) 종속성을 탐색하는 효과적인 수단으로 작용할 수 있음을 시사합니다.
Si 웨이퍼는 MTI(중국)에서 구입했습니다. 폴리스티렌 구체(PS, 직경 490nm)의 현탁액(수중 2.5 wt%)은 Duke Scientific(미국)에서 구입했습니다. Si NW 제조를 위한 아세톤, 메탄올, 황산, 과산화수소 및 불산은 Sinopharm Chemical Reagent(중국)에서 구입했습니다. 한외여과 시스템(Milli-Q, Millipore, Marlborough, MA)에서 탈이온수(DI, 18.2 MΩ·cm)를 얻었습니다.
수직으로 정렬된 실리콘 나노와이어 어레이는 이전 문헌[49, 50]에서 자세히 설명된 MACE와 결합된 NSL에 의해 제조됩니다. 주요 제조 공정은 그림 1a에 예정되어 있습니다. 먼저, 직경 490 nm의 폴리스티렌 구체(PS) 단층을 화학적으로 세척된 평면 Si 웨이퍼(n형, 0.01 Ω cm) 위에 자가 조립하여 육각형 밀집 단층을 형성했습니다. 그 후, PS 커버 샘플은 O2로 반응성 이온 에칭(RIE, Trion Technology)(50 W, 70 mTorr)에 의해 에칭되었습니다. 가스(20 sccm)를 사용하여 다음 절차에서 마스크 층 역할을 하는 PS의 직경을 줄였습니다. 그 후, 다음 MACE 처리를 위한 촉매 역할을 하는 PS 층으로 마스킹된 샘플 위에 이온 스퍼터링에 의해 20 nm Au 필름을 증착했습니다. 샘플을 HF(40%) 및 H2 중 MACE로 처리했습니다. O2 (30%) 실온에서 혼합 용액(부피비 4:1). MACE 공정에서 Au로 덮인 Si 표면은 PS로 덮인 표면(Au 없이)이 보호되는 동안 효과적으로 에칭되어 Si NW가 형성되었습니다. 마지막으로 샘플을 KI/I2에 담가 남아 있는 Au 층과 PS 구체를 제거했습니다. 및 테트라히드로푸란 용액, 각각. 이 제조 방법을 사용하면 수직으로 정렬된 Si NW 어레이의 대면적 주기적 어레이를 얻을 수 있습니다.
<사진>
아 수직으로 정렬된 Si 나노와이어 어레이를 제조하는 절차의 개략도. ㄴ 개별 Si 나노와이어에 대한 CAFM 및 EFM 측정을 위한 실험 설정의 개략도
제작된 Si NW의 형태는 주사전자현미경(SEM, SIGMA300)으로 확인하고 구조적 특성은 532 nm의 여기 파장과 약 1 mW의 저전력에서 라만 분광기(Jobin Yvon HR-Evolution 2 system)로 조사했습니다. .
Si NW의 전기적 특성은 그림 1b에 표시된 대로 상용 SPM 장비(Multimode V, Bruker Nano Surfaces)를 사용하여 CAFM 및 EFM에 의해 조사되었습니다. CAFM 및 EFM 측정에는 Cr/Pt 코팅 팁(Multi75E-G, Budget Sensors, 반경 약 25 nm)이 사용되었습니다. CAFM에서 전도성 팁은 팁이 접지된 동안 기판에 인가된 DC 바이어스 전압으로 접촉 모드에서 샘플 표면 위에서 스캔되었고 팁과 샘플 사이의 전류가 측정되었습니다. 양의 샘플 바이어스에서 표면 양극 산화가 심각하기 때문에 모든 전류 이미지는 음의 샘플 바이어스에서 측정되었습니다. CAFM 실험에서 - 0.5 ~ - 3.0 V 범위의 다양한 음의 전압이 테스트되었습니다. 바이어스 전압이 - 1.5 V 미만으로 설정되면 전류가 너무 작아 전도도가 불량한 샘플에 대해 감지되지 않는 것으로 나타났습니다. 바이어스 전압을 − 2.0 V 이상으로 설정했지만 큰 정전기장에서 팁 및/또는 샘플의 손상으로 인해 측정이 불안정했습니다. 따라서 − 1.5 V의 바이어스 전압이 현재 이미지 측정을 위해 선택되었습니다. EFM 측정은 2-패스 모드에서 Si NW에서 수행되었습니다. 첫 번째 패스에서는 지형 이미지를 얻기 위해 탭핑 모드에서 작동했으며 두 번째 패스에서는 반 데르 발스 힘을 무시할 수 있을 만큼 팁을 높이 들어 올렸습니다. 리프트 패스에서 샘플과 접지된 팁 사이에 DC 전압이 추가되었고 정전기력에 의해 유도된 위상 변이 신호가 감지되었습니다. 모든 실험은 흐르는 N2 안정적인 전기 측정을 위해 주변 온도를 유지하고 전도성 특성에 대한 산화물 층의 영향을 효과적으로 줄이기 위해 샘플을 HF 용액(5%)에 30초 동안 미리 담가두었습니다. 측정은 HF 침지 직후에 수행되었기 때문에 개질된 산소층은 전도성 팁이 침투할 수 있을 정도로 얇아야 하고 전도도에 미치는 영향이 최소화되어야 합니다.
수직으로 정렬된 대면적 Si 나노와이어 어레이의 제조는 그림 1a에 나와 있습니다. RIE 시간을 변경하면 PS 구의 직경을 원하는 값으로 줄일 수 있으므로 직경을 제어할 수 있는 Si NW를 얻을 수 있습니다. 90, 120 및 150 s RIE 에칭 후 얻은 Si NW의 SEM 이미지는 각각 그림 2a, b, c에 나와 있습니다. Si NW는 넓은 영역에서 주기적으로 육각형 배열로 수직으로 정렬되어 있음을 관찰할 수 있습니다. 이러한 수직으로 정렬된 Si NW는 490 nm의 동일한 주기와 약 350 nm의 동일한 길이(40 s의 동일한 MACE 시간)를 갖습니다. (a), (b) 및 (c)에서 Si NW의 직경은 각각 약 350, 260 및 190 nm입니다. RIE 에칭 시간에 대한 NW 직경의 의존성은 그림 2d에 표시되어 있으며 좋은 선형 상관 관계를 보여줍니다. 한편, 나노와이어의 길이는 HF와 H2에서 MACE의 시간을 변화시켜 조정할 수 있습니다. O2 혼합 용액. 40, 60, 80 및 100 s MACE 후 Si NW의 단면 SEM 이미지가 그림 2e에 나와 있습니다. MACE 시간을 증가시키면 NW의 길이가 350에서 960 nm로 증가함을 알 수 있습니다. 유사하게, Si NW의 길이는 그림 2f와 같이 MACE 시간에 대한 좋은 선형 의존성을 나타냅니다. 이러한 결과는 제어 가능한 직경과 길이를 갖는 정렬된 Si NW가 MACE와 결합된 NSL 방법에 의해 성공적으로 제조되었음을 나타냅니다.
<그림>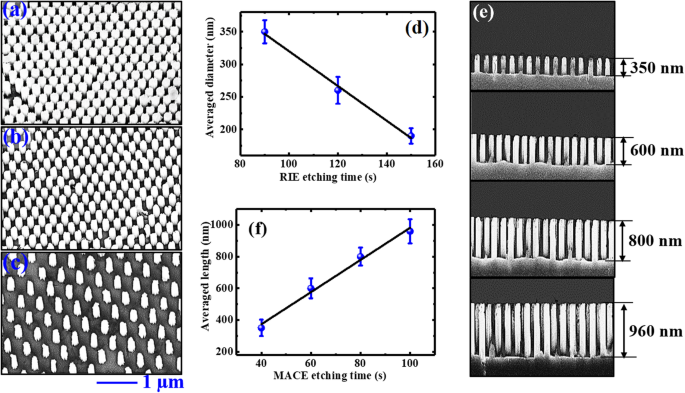
350 nm의 동일한 길이를 갖지만 a의 직경은 다른 Si NW의 평면도 SEM 이미지 350 nm; ㄴ 260 nm; 및 c 190 nm. RIE 에칭 시간에 대한 NW 직경의 의존성은 d로 표시됩니다. . 이 260 nm의 직경은 같지만 길이가 350, 600, 800, 960 nm인 Si NW의 단면 SEM 이미지. 에 MACE 시간에 대한 NW의 길이 의존성을 나타냅니다.
SEM 이미지에서 Si NW는 화학적 에칭 후 매우 거친 표면을 가지며 측벽 표면이 특히 거칠다는 것을 알 수 있습니다. 직경과 길이의 함수로서 표면층의 미세구조를 확인하기 위해, 라만 스펙트럼은 직경과 길이가 다른 벌크 Si 및 Si NW 모두에서 측정되었습니다. 각 스펙트럼은 520 cm − 1 에서 최대 피크 강도를 사용하여 정규화되었습니다. , 다른 직경과 다른 길이에 대한 결과는 각각 그림 3과 b에 나와 있습니다. 벌크 실리콘의 스펙트럼은 ~ 520.1 cm − 1 에 위치한 날카로운 피크를 보여줍니다. . 피크 위치의 적색 편이와 피크 폭의 확장(절반 최대값, FWHM이라고 함)은 모두 그림 3c 및 d에 표시된 대로 Si NW에서 관찰할 수 있습니다. 피크 적색편이 및 확장은 350 및 600 nm의 짧은 길이를 가진 나노와이어의 경우 다소 작으며 나노와이어 길이가 800 nm 이상으로 증가함에 따라 상대적으로 분명해집니다. 이러한 라만 피크 적색편이 및 확장은 때때로 도펀트 수준 또는 결정질 함량의 변화에 기인합니다. 이전 문헌[5, 51]에 따르면 동일한 MACE 방법으로 제조된 Si NW의 경우 도핑 농도는 시작 웨이퍼와 동일한 도핑 수준을 가질 수 있습니다. 장비의 한계로 인해 이 결과를 확인할 수 없었습니다. 한편, 이러한 Si NW는 거친 표면을 가지고 있지만, 이전 문헌에서는 MACE 방법으로 제조된 Si NW가 주로 n- 및 p-도핑 및 경질 및 중도핑 모두에 대해 결정 구조를 유지할 수 있음을 발견했습니다[5, 51 , 52]. NW의 벽면에는 얇은 비정질층만이 관찰되었다. 다른 그룹에 의해 직경과 길이가 다른 Si NW에서 유사한 결과가 얻어졌습니다. 따라서 MACE 방법으로 제작된 Si NW는 얇은 표면층을 제외하고는 도펀트 수준과 결정질 함량을 벌크 대응물과 거의 동일하게 유지할 수 있다고 가정할 수 있습니다.
<사진>
a가 있는 벌크 Si 및 Si 나노와이어의 일반적인 라만 스펙트럼 350 nm의 동일한 길이이지만 다른 직경 및 b 직경은 190 nm 같지만 길이가 다릅니다. ㄷ 그리고 d 나노와이어 길이의 함수로서 피크 위치의 적색 편이 및 FWHM 확장을 나타냅니다.
따라서 라만 피크 이동 및 확장은 나노와이어의 손상된 거친 표면에 의해 유도될 가능성이 가장 높습니다[53]. 동일한 MACE 방법으로 제작된 Si NW의 라만 결과를 보고한 여러 논문이 있습니다. 예를 들어, Feser et al. 520 cm − 1 에서 현저한 피크 넓어짐을 발견했습니다. MACE 시간에 따라 증가하고 이 피크 확장은 에칭 공정에 의해 유도된 결정 장애(예:점 결함 클러스터)에 기인합니다[23]. Lajvardi et al. 라만 적색편이가 MACE 시간에 따라 증가한다는 것을 발견했습니다. i. 이자형. TO 라만 피크는 521.1 cm − 1 에 위치했습니다. 벌크 Si의 경우 518.7 cm − 1 로 이동했습니다. 각각 80분 에칭된 샘플에 대해 [54]. 그들은 라만 이동의 기원이 나노와이어의 벽에 Si 나노결정이 형성되기 때문일 수 있다고 말했다. Linet al. TO 라만 피크가 520에서 516 cm − 1 로 이동하는 것을 관찰했습니다. NW의 길이가 0(벌크 Si)에서 2.73 μm로 증가하는 동안 피크 너비가 3에서 9 cm로 넓어진 경우 − 1 NW의 길이를 0.19에서 2.73 μm로 증가시키면서 [55]. 그들은 라만 피크 확장이 포논-변형률 상호 작용에 의해 지배되고 라만 피크 이동이 변형률 유도 표면 격자 왜곡에 비례하는 것으로 입증되었다고 생각했습니다. HF 에칭에 의해 유도된 변형은 NW의 길이(더 많은 에칭 시간)에 따라 증가했기 때문에 라만 피크 적색 편이와 확장은 NW의 길이가 증가함에 따라 증가했습니다. 우리의 경우 그림 3a 및 b에 표시된 것과 같은 라만 스펙트럼에서 TO 라만 피크가 520에서 519.4 cm − 1 로 이동함을 알 수 있습니다. NW의 길이가 0(벌크 Si)에서 960 nm로 증가할 때 FWHM이 4.41에서 4.47 cm − 1 로 확장됩니다. NW의 길이가 350에서 960 nm로 증가함에 따라. 우리는 이 길이 의존적 라만 피크 이동 및 확장이 손상된 표면(변형 또는 장애)에서 비롯되는 것을 선호합니다. 그러나 서로 다른 직경과 다른 길이(<1.0 cm − 1 )를 가진 나노와이어의 경우 적색편이와 피크 확장 모두의 매우 작은 변화로 인해 ), 크기에 따른 변형/장애의 변화는 최소화된 것으로 간주할 수 있습니다. 따라서 변형/장애는 NW의 전도도를 수정할 수 있지만 전도도의 크기 의존성에 미치는 영향은 다음 섹션에서 다루지 않습니다.
Si NW의 전도성 특성은 직경과 길이가 다른 개별 NW에서 CAFM으로 측정됩니다. 350 nm의 길이는 동일하지만 직경이 350, 260 및 190 nm인 수직으로 정렬된 Si NW의 일반적인 지형 이미지는 각각 그림 4a, b 및 c에 표시되어 있으며 해당 전류 이미지는 샘플에서 얻은 것입니다. − 1.5 V의 바이어스는 (d), (e) 및 (f)에 표시됩니다. Cr/Pt 코팅된 원자현미경 팁이 큰 각도의 쐐기형이므로 Si NW는 실제보다 더 큰 직경을 나타냅니다. 또한 팁이 기판과 접촉할 수 없기 때문에 나노와이어에서 나오는 전류를 잘 감지할 수 없었기 때문에 나노와이어에서 측정된 전류만 고려됩니다. 현재 이미지에서 대부분의 Si 나노와이어 가장자리가 중앙보다 약간 더 나은 컨덕턴스를 나타냄을 관찰할 수 있습니다. 이것은 AFM 팁과 더 큰 접촉 면적을 가진 Si NW 사이의 측면 접촉으로 인해 발생할 수 있습니다. 또한 상단 표면의 명백한 거칠기로 인해 중앙 영역의 일부 영역에서도 가장자리와 유사한 큰 전류가 표시되어 뚜렷한 고리 모양의 전류 분포가 나타나지 않을 수 있습니다. 반면에 Si NW의 전도도는 분명히 나노와이어의 직경과 관련이 있습니다. 직경이 350nm에서 190 nm로 감소함에 따라 나노와이어의 전도성 면적비와 절대 전류값이 크게 증가함을 알 수 있다. 결과는 더 작은 직경을 가진 Si NW가 더 큰 것보다 더 전도성이 있음을 시사합니다. 직경 의존성을 보다 직관적으로 얻기 위해 그림 4d에서 f의 표시된 선을 따라 현재 프로파일이 그림 4g에 표시됩니다. 190 nm 직경의 Si NW가 260 nm 및 350 nm 직경의 Si NW보다 훨씬 더 전도성이 있음을 분명히 보여줍니다. 이러한 직경 의존성은 추가 파일 1:그림 S1(a)와 같이 직경이 다른 Si NW에 대한 전류 분포의 통계 히스토그램에서 얻을 수 있습니다. 이 히스토그램은 직경이 감소할 때 전류 분포가 높은 값으로 이동하는 것을 보여줍니다. 평균 전류(I av )의 Si NW는 현재 이미지의 모든 나노와이어에 대한 전류를 평균화하여 계산되며, 이는 NW 직경의 함수로 그림 4h에 표시됩니다. Si NW의 평균 전류는 NW의 직경이 350에서 190 nm로 감소할 때 극적인 9배 증가를 나타냅니다. 직경에 대한 유사한 전류 의존성은 단일 InAs 나노와이어 및 단일 Si 나노와이어 장치에서 달성되었습니다[35, 47].
<그림>
350 nm의 길이와 다른 직경의 a Si NW의 지형 이미지 350 nm, b 260 nm, c 190 nm. − 1.5 V의 샘플 바이어스에서 얻은 해당 전류 이미지는 d에 나와 있습니다. , e 및 f , 각각. d에 표시된 라인에 따른 현재 프로필 –f g로 표시됩니다. , 및 h 평균 전류(I av ) NW 직경의 함수로서 나노와이어에 대해. a의 지형 이미지에 해당 선이 추가됩니다. –ㄷ g의 프로필 곡선 안내를 위해 수직으로 이동합니다.
− 1.5 V의 샘플 바이어스에서 측정된 길이가 다르고 직경이 190 nm인 Si NW의 일반적인 전류 이미지가 그림 5에 나와 있습니다. 그림 5a에서 d는 길이가 350인 Si NW의 현재 이미지를 보여줍니다. 각각 600, 800 및 960 nm. 이러한 전류 이미지에서 전도성 영역은 길이가 증가함에 따라 분명히 감소하는 반면 절대 전류의 감소는 특히 350 nm 및 600 nm 길이의 NW에서 그렇게 분명하지 않다는 것을 알 수 있습니다. 아마도 국부적으로 불규칙한 표면 거칠기의 존재로 인해 그림 5b의 일부 지점에서 더 큰 전류가 관찰되었습니다. 그럼에도 불구하고 도 5b의 평균 전류는 도 5a의 평균 전류보다 훨씬 작았다. 위와 동일한 분석을 사용하여 표시된 선을 따라 현재 프로필이 그림 5e에 표시되고 통계 히스토그램이 추가 파일 1에 표시됩니다. 그림 S1(b). 둘 다 NW의 길이가 증가함에 따라 현저한 전류 감소를 분명히 나타냅니다. NW 길이의 함수로서 나노와이어의 평균 전류는 그림 5f에 표시되어 있으며 수십에서 수백 pA 정도이며 그림 5a에서 e보다 nA 정도 훨씬 작습니다. . 나노와이어는 대부분의 영역이 비전도성일 때 소수의 전도성 지점에서만 비교적 큰 전류를 나타내기 때문입니다. 그림 5f에서 평균 전류는 길이가 300에서 960 nm로 증가할 때 3배 이상 감소하는 것으로 나타나 길이가 증가함에 따라 나노 와이어의 컨덕턴스가 감소함을 나타냅니다. 길이에 대한 나노와이어 저항의 의존성은 반도체 나노와이어에 대한 4점 저항 측정에 의해 이전에 조사되었으며, 이는 옴 접촉 하에서 나노와이어의 저항이 저항의 기울기와 선형적으로 길이에 따라 증가함을 시사했습니다[56, 57]. 우리의 경우 추가 파일 1:그림 S2에 제공된 I ~ 1/L의 플롯에서 종속성이 현저하게 비선형적입니다. 따라서 곡선 기울기에서 저항을 올바르게 얻을 수 없습니다. CAFM 측정에서 주목할 가치가 있습니다. 총 측정 저항에는 Cr/Pt 코팅 팁과 Si NW(R 팁/NW ), Si NW의 저항(R 북서 ) 및 Si 웨이퍼의 저항(R 대량 ). CAFM에 의해 측정된 저항은 주로 팁 아래의 국부적인 표면적에서 비롯되고 전류 경로를 따라 면적이 증가함에 따라 빠르게 감소하기 때문에 R 대량 R에 비해 훨씬 작습니다. 북서 및 R 팁/NW . 반면, 팁과 나노와이어 사이의 금속-반도체 접촉 면적이 매우 작기 때문에 접촉 저항 R 팁/NW 나노와이어 저항 R보다 훨씬 큽니다. 북서 . 1/L에 대한 전류 의존성의 비선형성은 접촉 저항이 크다는 것을 나타냅니다. 따라서 CAFM에서 수행하는 측정에서는 쇼트키 장벽이 중요한 역할을 하는 금속-반도체 접촉 저항을 강조해야 합니다.
<사진>
190 nm의 직경은 같지만 길이는 a가 다른 − 1.5 V의 샘플 바이어스에서 Si NW의 현재 이미지 350 nm, b 600 nm, c 800 nm 및 d 각각 960 nm. a에 표시된 라인을 따라 현재 프로필 –d e로 표시됩니다. , 및 f 나노와이어의 평균 전류를 나타냅니다(I av ) NW의 길이의 함수로. e의 프로필 곡선 안내를 위해 수직으로 이동합니다.
위의 추론을 확인하기 위해 개별 Si NW에 전류-전압(I-V) 곡선을 기록하여 금속 팁/Si 나노와이어 접촉에서 쇼트키 장벽을 조사했습니다. 350 nm의 길이는 같지만 직경이 다른 Si NW의 일반적인 I-V 곡선은 그림 6a에 표시되어 있고 Si NW의 지름은 190 nm이지만 길이가 다른 곡선은 그림 6b에 표시되어 있습니다. 모든 I-V 곡선은 금속 팁과 n형 반도체 사이의 쇼트키 접촉이 있는 일반적인 I-V 곡선에 따라 음의 샘플 전압 영역에서 더 큰 전류를 나타냅니다. I-V 곡선이 우수한 금속-반도체 특성을 나타내므로 컨덕턴스에 대한 산소 층 효과가 심각하지 않으며 따라서 다음 논의에서 최소로 가정됨을 나타냅니다. 한편, 결과는 더 작고 더 짧은 나노와이어가 더 크고 더 긴 것보다 더 큰 컨덕턴스를 나타내며 현재 이미지에서 얻은 결과와 잘 일치함을 보여줍니다. 정량적 분석을 위해 잘 알려진 금속-반도체 접촉에 대한 열이온 방출 모델이 채택되었다[58, 59]. 이 모델에서 직렬 저항이 있는 n형 반도체에 대한 쇼트키 접촉의 I-V 특성은 [59]로 근사화될 수 있습니다.
<그림>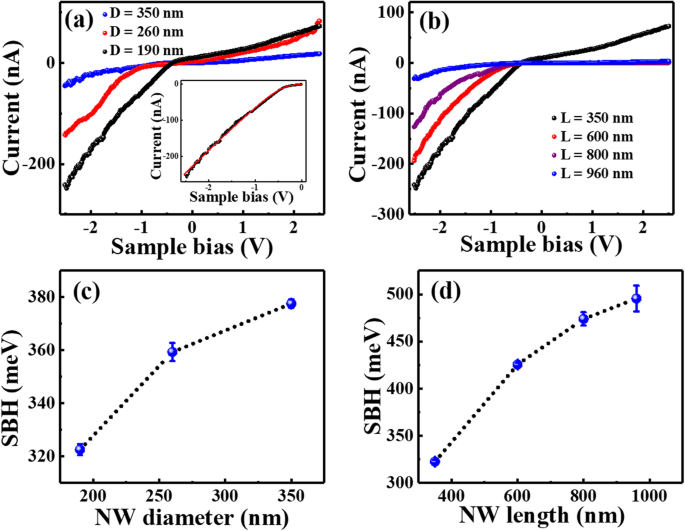
350 nm의 길이는 같지만 직경이 다른 Si NW의 일반적인 I-V 곡선(a ) 및 190 nm의 동일한 직경이지만 다른 길이(b ). a의 삽입 직경 190 nm, 길이 350 nm인 Si NW의 일반적인 피팅 결과를 보여줍니다. ㄷ 그리고 d 피팅 결과에서 얻은 쇼트키 장벽 높이를 각각 NW의 직경과 길이의 함수로 나타냅니다.
$$ I={I}_S\left[\exp \left(\frac{q\left(VI{R}_S\right)}{\mathrm{n} kT}\right)-1\right], $ $ (1)여기서 n 이상적인 요소이며 R S 는 직렬 저항입니다. 나 S 는 포화 전류이며 다음과 같이 표현할 수 있습니다.
$$ {I}_S=\mathrm{AA}\ast {T}^2\exp \left(-\frac{\varphi_B}{kT}\right), $$ (2)여기서 A는 접촉 면적, A*는 Richardson 상수, φ 나 는 금속 팁과 Si 나노와이어 사이의 쇼트키 장벽 높이(SBH)입니다. 따라서 SBH는 다음 공식으로 얻을 수 있습니다.
$$ {\varphi}_B=kT\ln \left(\frac{\mathrm{AA}\ast {T}^2}{I_{\mathrm{S}}}\right), $$ (3)그림 6a와 b의 I-V 곡선은 Eq. (1), 전방 영역에서의 전형적인 피팅 라인은 Fig. 6a의 인세트에서 보여진다. 포화 전류에서 SBH 값을 얻기 위해 유효 Richardson 상수 A*는 벌크 실리콘의 값과 거의 같다고 가정합니다. 즉, 112A cm − 2 K − 2 n형 실리콘의 경우 [59]. 접촉 면적은 2 × 10 − 11 로 가정합니다. cm 2 Cr/Pt 코팅된 팁 반경을 25 nm로 취함으로써. SBH 값은 350 nm의 동일한 길이와 190, 260 및 350 nm의 서로 다른 직경을 가진 Si NW에 대해 각각 약 322, 359 및 377 meV로 얻어졌습니다. 190 nm의 동일한 직경과 350, 600, 800 및 960 nm의 다른 길이를 갖는 Si NW의 경우, SBH 값은 상응하게 322, 425, 473 및 495 meV입니다. 비교를 위해 추가 파일 1:그림 S3(a)와 같이 동일한 유형의 Si 웨이퍼에서 일반적인 I-V 곡선을 측정했습니다. Si 웨이퍼의 컨덕턴스가 생산된 NW보다 훨씬 작음을 분명히 보여줍니다. 감지 가능한 전류는 높은 바이어스 전압(− 4 ~ − 10 V)에서만 측정할 수 있습니다. 위의 열이온 방출 모델(추가 파일 1:그림 S3(b))로 I-V 곡선을 맞춘 후 벌크 Si에 대해 0.60 eV의 SBH 값을 얻었습니다. Obviously, all of the measured SBH values for Si NWs with different diameters and lengths are smaller than that of the bulk Si. Similar Schottky barrier lowering in nanowires has been reported by different groups on different types of nanowires, which was attributed to the carrier recombination in depletion region [46, 60], barrier inhomogeneity and Joule heating effect [48], or image potential lowering [47]. In our case, the barrier lowering can be also attributed to the large density of surface states induced image potential lowering and carrier charging in depletion region.
The dependence of SBH values on nanowires’ diameter and length is plotted in Fig. 6 c and d respectively, and it can be found that the SBH increases obviously with the increasing of both nanowires’ diameter and length. In addition, the same measurements were done on Si NWs with different diameters of 260 and 350 nm for all lengths, and the I–V curves are shown in Additional file 1:Figure S4 a and b, respectively. The obtained diameter-dependent SBH values from curve fitting for all lengths are listed in Table 1 and plotted in Additional file 1:Figure S5. The results show that the SBH values increase with increased diameter for all lengths, and also increase with increased length for all diameters. Therefore, the results obtained from the I–V curves analyses suggest that the Schottky barrier lowering is more significant for the nanowires with smaller diameters and shorter lengths. On the other hand, the ideal factor n and series resistances R s of Si NWs with different diameters and lengths can also be obtained from the fitting results, as listed in Table 1. The results show that n is much larger than 1 for all nanowires (2.8 ~ 9.4), indicating that the contact between the tip and nanowire is not ideal metal-semiconductor contact, probably due to the existence of oxide layer. On the other hand, the R s increases with increased diameter as well as increased length. For example, R S increases from 6.1 to 21.6 MΩ as the diameter increases from 190 to 350 nm for the same length of 350 nm and increases from 6.1 to 32.3 MΩ for the length from 350 to 960 nm with the same diameter of 190 nm. The increase of R s with increased length is reasonable, while that increase with increased diameter is out of expectation. There is no good explanation for it at present, which may because that the series resistance is not simply the resistance of nanowire and the effective tip-nanowire contact area is not exactly equal to the nanowire’s sectional area. Nevertheless, the series resistances of Si NWs did be much smaller than the contact resistances, therefore the conductance of Si NWs should be dominated by the SBH determined contact resistance.
The origin of the size-dependent SBH is not very clear yet. The mechanism explanation for similar diameter dependence of SBH has been supposed in several literatures [45,46,47,48, 60]. For example, Leonard et al. interpreted this effect with the point of electron-hole recombination in depletion region [60]. As the recombination time decreased as the nanowire diameter was reduced, current density increased with decreasing nanowire diameter. Yoon et al. explained the diameter-dependent SBH using the presence of interface states [47]. Mao et al. attributed its origin to barrier inhomogeneity and Joule heating effect [48]. In our case, the Si NWs are made by the MACE method, so there inevitably exist an amount of defects on the surface and a reformed thin oxygen layer, resulting in a large density of surface states. Actually, from the enlarged SEM images and AFM observation, the top surface of Si NWs is very rough, further increasing the density of surface states. We think the presence of surface (or interface) states should be the main cause of the diameter dependence of SBH. According to previous literatures [47, 61, 62], the SBH lowering was interpreted by charged interface states. By adopting the cylindrical coaxial capacitor model used in reference [47], interface state–induced carrier transfer will form two opposite charged layers (metal and semiconductor contact surface) which generates an electric field opposite to the built-in electric field and lowers the barrier potential. As the surface state density increases with decreased nanowire diameter, smaller SBH is obtained on nanowires with a smaller diameter. Why the values of SBH related to the nanowire length is not clear yet. As the MACE time increased, the surface disorder or roughness increases correspondingly. Different changes in the surface microstructures may introduce different changes of SBH values, which need further investigations to work it out. Anyway, whatever the origin of size dependence of conductive properties, the size-dependent SBH lowering could result in higher conductance, which should be beneficial for practical applications.
To further verify the size-dependent SBH results of Si NWs obtained by CAFM, the EFM measurements were performed on the same samples and the EFM phase shift was measured as a function of applied DC bias. In previous literatures [63, 64], the relation between phase shift and electrostatic force has already been established, where the tip-sample system is roughly treated as a plane capacitor. When a bias is applied between the tip and the sample, the capacitive electrostatic force gradient would cause a phase shift. At a lifted height where the Van de Waals force can be ignored, the electrostatic force acted on the tip can be expressed as [63]:
$$ F=\frac{1}{2}\frac{\partial C}{\partial z}{\left({V}_{EFM}-{V}_{CPD}\right)}^2, $$ (4)여기서 C , V EFM , 및 V CPD are the capacitance, applied DC voltage and contact potential difference (CPD) between the sample and tip, respectively. V CPD can be written as (φ 샘플 − φ tip )/e when the bias voltage V EFM was applied to the sample in our experiments. The phase shift detected by EFM is proportional to the gradient of the electrostatic force, which can be written as:
$$ \varDelta \varPhi =-\frac{Q}{k}\frac{\partial F}{\partial z}=-\frac{Q}{k}\left[\frac{1}{2}\frac{\partial^2C}{\partial {z}^2}{\left({V}_{EFM}-{V}_{CPD}\right)}^2\right], $$ (5)where Q is the quality factor, k is the spring constant of the probe and z is the distance between tip and top of Si NW.
식에서 (5), it can be seen that the EFM phase shift should be equal to zero at V EFM =V CPD . Therefore, V CPD can be achieved from the EFM measurements. The ΔΦ ~V EFM curves measured at a lift height of 100 nm on the individual Si NWs with different diameters and lengths are shown in Fig. 7 a and b as the scattered dots, respectively. By using Eq. (5), the ΔΦ ~V EFM curves can be fitted well, shown as the solid lines in Fig. 7 a and b. From the fitting parameters, the values of V CPD can be obtained, as presented in Fig. 7 c and d as a function of diameter and length respectively. The results show that the CPD values increase with increased diameter and increased length. Similar CPD results have been reported in a previous work performed by Kelvin probe force microscopy on ZnO NWs, in which the absolute value of CPD between ZnO nanowire and Pt/Ir tip also increased with increased diameter [65]. As diagrammed in Additional file 1:Figure S6, the value of SBH roughly equals to qV CPD plus E n (=E C − E F ). E로 n is a constant for all Si NWs made from the same material, the size dependence of V CPD well represents the size dependence of SBH. Therefore, from the EFM results, it can be suggested that, the SBH values increase with the increasing of NWs’ diameter and length, well consistent with the results achieved by CAFM measurements. Similarly, the EFM measurements are performed on all series of Si NWs, and the diameter-dependent V CPD values at different lengths are shown in Additional file 1:Figure S7(a) and (b) respectively, which exhibit same diameter dependence as that obtained by CAFM.

∆Φ ~ V curves measured by EFM on individual Si NWs with a different diameters of 190, 260, and 350 nm (length = 350 nm) and b different lengths of 350, 600, 800, and 960 nm (diameter = 190 nm). ㄷ 그리고 d present the V CPD values obtained by curve fitting as a function of NWs’ diameter and length. The curves in a 그리고 b are vertically shifted for guidance
In summary, by a simple, low-cost method without involving any intricated procedures, Si NWs arrays with controllable diameters and lengths are prepared. Both the diameter and length of SiNWs can be well controlled by adjusting the etching time. The conductive properties include the current map and I–V curves are directly measured on individual Si NWs without complex nanofabrication procedure by the means of CAFM. Size-dependent conductance of Si NWs can be obtained from both the current images and I–V curves. Our results demonstrate that the Si NWs with a smaller diameter and shorter length exhibit better conductance. It can be attributed to the size dependence of SBH, which increased from 322 to 377 meV with the diameter increasing from 190 to 350 nm for the same length of 350 nm. Correspondingly, the SBH values increased from 322 to 495 meV as the length varies from 350 to 960 nm for the same diameter of 190 nm. The same size-dependent SBH can also be obtained from the EFM measurements. Such SBH lowering is interpreted by charged interface states. Therefore, our study not only reveals the size-dependent properties of Si NWs but also suggests that CAFM can act as an effective means to explore the size (or other parameters) dependence of conductive properties on individual nanostructures.
The datasets used for supporting the conclusion are included in the article and the supporting file.
Conductive atomic force microscopy
Contact potential difference
Electrostatic force microscopy
금속 보조 화학 에칭
Nanosphere lithography
Polystyrene spheres
반응성 이온 에칭
쇼트키 장벽 높이
주사전자현미경
Si nanowires
Scanning probe microscopy
나노물질
우리가 스마트 자료를 좋아한다는 것을 이미 알고 계실 것입니다. 그리고 이번에는 매우 흥미로운 소재인 전도성 잉크에 대해 조금 더 자세히 알려 드리고자 합니다. 전도성 잉크란 무엇입니까? 전도성 잉크는 은 또는 탄소 입자를 포함한 페인트입니다. . 이 입자는 이 잉크/페인트에 전도성을 부여하는 역할을 합니다. . 이 잉크는 회로의 전선과 구리 트랙을 대체할 수 있습니다. 우리가 어렸을 때 학교에서 만들던 회로, 압정과 가는 구리선으로 연결된 집게가 있는 전형적인 회로를 기억하십니까? 확실히 다음 세대는 구리선을 사용할 필요가 없
예 및 아니오. PLA는 좋은 전기 전도체는 아니지만 전자 장치에 문제를 일으킬 수 있는 작은 전류를 전도합니다. 전도성은 PLA 재료의 불순물(일반적으로 수분)에서 비롯됩니다. 좋은 소식은 대부분의 필라멘트가 위험한 전도성 및 체적 저항 수준으로 간주되는 수준보다 훨씬 낮다는 것입니다. PLA는 약 60%의 결정도를 갖는 중간 정도에 속합니다. 이는 분자 구조가 정렬된 일부 영역과 그렇지 않은 영역을 의미합니다. 그래서 PLA는 전도성이 있습니까? 아래에서 PLA 필라멘트의 전기적 특성에 대해 자세히 알아 보려면 계속