나노물질








그리드 금속 접촉 영역을 제외하고 1 sun, AM 1.5G 조건에서 전력 변환에서 1.27%의 유효 영역 광전지 효율이 에피택셜 성장한 p-GaN/i-InGaN/n-GaN 다이오드 어레이에 대해 얻어졌습니다. (111)-Si. 단락 전류 밀도는 14.96 mA/cm 2 입니다. 개방 회로 전압은 0.28 V입니다. 변형 및 결함이 없는 III-질화물 나노로드 어레이 구조 내에서 다중 반사를 통해 획득된 향상된 광 트래핑과 넓은 밴드갭 III-질화물 구성요소에 의해 증폭된 단파장 응답은 장치 성능의 향상을 관찰했습니다.
녹색 에너지 개발은 점점 더 필수적이 되었고, 나날이 증가하는 에너지 위기로 인해 LED(Light Emitting Diode) 및 태양전지 산업이 빠른 속도로 발전하고 있습니다. 지난 수십 년 동안 III-질화물 반도체는 LED 장치[1,2,3]에 성공적으로 적용되어 상당한 상업적 이점을 얻었습니다. 현재 많은 과학자들이 광전지 응용을 위한 III-질화물에 대한 연구 잠재력을 활용하려고 합니다[4, 5]. III-V족 질화물 물질은 큰 흡수 계수를 갖는 직접 밴드갭[4, 6], 밴드 엔지니어링을 통한 대부분의 태양 스펙트럼을 덮는 넓은 밴드갭 범위[4, 6, 7]와 같은 광기전 시스템에 대한 많은 이점을 가지고 있습니다. 높은 캐리어 이동도[7] 및 우수한 방사선 저항[8]. 이러한 우수한 특성을 기반으로 InGaN/Si 탠덤 셀[9,10,11,12,13,14], 핫 캐리어 태양 전지[15], 쇼트키 기반 태양 전지[16, 17,18], 단일 [19,20,21,22,23,24] 및 다중 [25,26] 접합 태양 전지뿐만 아니라 태양 전지 성능에 대한 편광 효과 [9, 23, 27]. 시뮬레이션은 InGaN/Si 이종구조 탠덤 셀이 다양한 시뮬레이션 모델을 기반으로 하여 21-36%[10, 11, 13]만큼 높은 효율을 가질 수 있다고 예측했습니다. 4가지 다른 In 조성을 가진 InGaN 동종 구조 탠덤 태양 전지의 전력 변환 효율(PCE)은 1-태양 복사 조도에서 51%, 250-태양 집중 조건에서 58%로 제안됩니다[26]. 그러나 불순물과 비방사성 재결합 문제는 저온 InGaN 박막 성장 조건에서 점점 더 중요해지고 있다[28,29,30]. 격자 불일치로 인한 심각한 적층 결함과 전위 밀도는 캐리어 확산 길이의 감소와 태양 전지 PCE의 한계로 이어진다[31,32,33,34]. 따라서 고효율 III-질화물 광전지 장치의 잠재적 기능을 실현하기 위해서는 많은 과제가 남아 있습니다.
지난 10년 동안 독립 GaN 기판에 대한 고 InGaN 결정 성장 방법[34], p형 InGaN 도핑[35], 양자 우물 설계[36,37,38,39,40], 전극과 같은 많은 관련 연구 주제 설계[41,42,43,44], 집광기 태양광[37, 41, 45], 중간 대역 태양 전지[46] 및 반사 감소 구조[47,48,49]가 연구되었습니다. 또한, 비극성 질화물 기반 태양전지가 편광 효과에 대해 조사되었다[50, 51]. Dahal et al. 는 더 긴 파장(> 420 nm)에서 30% 이상의 InGaN 다중 양자 우물 태양 전지 작동을 시연했으며[38] 최대 30개의 태양까지 증가된 조명 강도에서 3.03% 효율을 보여주었습니다[37]. Mori et al. 집광기 질화물 기반 태양 전지[45]를 조사하고 최대 300개의 태양까지 높은 광도에서 작동하는 4%의 가장 높은 PCE를 해결했습니다[41]. 여러 연구 그룹이 다른 구조 또는 광학 설계를 제공하고 성장 기술을 개선했지만 III-질화물 태양 전지의 PCE는 크게 발전하지 않았습니다. 한편, Reichertz et al. 탠덤 태양 전지는 p-n 접합 Si 기판에서 p-n 접합 GaN을 에피택셜 성장함으로써 실현 가능함을 입증했습니다[14]. 그들의 결과는 Si 기판이 장파장 효율에 기여하고 질화물이 단파장 효율에 기여함을 나타냅니다. 실리콘 기판은 저렴한 솔루션뿐만 아니라 PCE 향상 및 우수한 열전도율을 제공합니다[52].
일반적으로 태양 전지 성장의 경우 연속적인 필름 층이 서로의 위에 성장하므로 높은 전위 밀도가 발생합니다. 그러나 III-질화물이 나노구조로 성장하면 기판과 접촉하는 바닥 면적이 작아서 나사 전위가 감소하고 변형도 최소화될 수 있습니다. Tessarek et al. GaN 나노로드의 전위는 직경이 200 nm로 내려감에 따라 사라졌다고 보고했다[53]. 따라서 실리콘 기판의 박막 성장에 대한 대안으로 III-질화물 나노막대 태양 전지를 성장시켜 비용을 절감하고 결정 품질을 개선하며 전지 효율을 높이는 것이 바람직한 선택이 될 것입니다. 또한, 나노로드/나노와이어는 전극으로의 직접적인 경로로 인해 광 발생 전자가 정공과 재결합되기 전에 더 효과적으로 수집될 수 있고 나노로드 구조가 광자 흡수를 향상시키기 위해 광 트래핑을 개선할 수 있기 때문에 광전지 응용 분야에 큰 용량을 가지고 있습니다[54, 55]. 여러 그룹에서 광검출기[56, 57], 나노레이저[58, 59], 나노 LED[60, 61] 및 III-질화물 나노막대를 기반으로 한 광전기화학적 물 분해 응용[62]을 시연했습니다[55]. 그럼에도 불구하고 나노로드 태양 전지의 단점은 광 생성 전자-정공 쌍이 표면 결함으로 인해 풍부한 캐리어 트래핑 센터에서 재결합한다는 것입니다. 더욱이, 나노로드 태양전지의 소자 제조 공정은 박막 소자의 소자 제조 공정보다 복잡하다. 그러나 위에서 언급한 이러한 문제를 극복하면 Wallentin et al. 여기서 InP nanorod 어레이는 nanorod 직경과 상단 n-segment의 길이 최적화로부터 13.8% PCE를 갖습니다[54, 63]. Krogstrup et al. 높은 단락 전류 밀도(Jsc )은 단일 코어-쉘 GaAs 나노와이어 구조에서 광 집중에 의해 강화된 10배 이상의 광 흡수로 인해 얻어졌다[64]. Wierer et al. [65], Cansizoglu et al. [66], Nguyen et al. [31]은 GaN 템플릿과 Si 기판에서 다양한 유형의 질화물 나노로드 어레이 태양 전지를 시연했습니다. 최근 나노로드/나노와이어 광전지 연구의 비교는 보충 정보:표 S1에 나열되어 있습니다. 그러나 저비용 Si(111) 기판에서 In 함량이 다른 InGaN 나노막대 앙상블 광기전 소자의 광전 변환 기여는 지금까지 체계적으로 논의되지 않았습니다.
이 연구에서, 8% 및 11% 인듐 농도를 갖는 Mg:GaN/InGaN/Si:GaN III-질화물 나노로드 앙상블은 플라즈마 보조 분자빔 에피택시(PA-MBE, Veeco)에 의해 n-도핑된 Si(111) 기판에서 성장되었습니다. EPI930). 구조적 특성과 인듐 함량은 고해상도 x-선 회절(HR-XRD, Bede D1) 측정에 의해 추정되었습니다. 나노로드의 미세 구조는 고해상도 투과전자현미경(HR-TEM, FEI E.O Tecnai F20 G2)으로 분석하였다. 질화물 태양 전지의 전류 밀도 대 전압(J-V) 특성은 1 태양, AM 1.5G 조명(Newport 94023A)에서 논의되었습니다. 외부양자효율(EQE, Enli Technology Co., Ltd., QE-R3018)을 측정하여 스펙트럼 응답을 연구하였다. 전자와 정공 수송을 설명하기 위해 밴드 다이어그램 정렬 및 시뮬레이션도 조사되었습니다.
Si:GaN 및 Mg:GaN/InGaN/Si:GaN 나노로드의 성장은 PA-MBE(플라즈마 보조 분자빔 에피택시) 기술을 기반으로 합니다. 모든 샘플은 6N 질소 플라즈마 소스(Veeco, UNI-Bulb)가 장착된 Veeco GEN930 PA-MBE 시스템으로 성장되었습니다. 저항률이 0.001–0.005 Ω·㎝인 n형 Si(111) 기판을 초음파 수조에서 아세톤, 이소프로판올, 탈이온수로 각 단계에서 5분 동안 세척하여 잔류 유기 오염물을 제거한 다음 a. 48–51% HF:H2 O =5 분 동안 1:5 용액을 사용하여 천연 산화물을 제거합니다. 화학적 세정/식각 공정 후, Si 기판을 질소 가스로 건조시켰다. Si 기판은 버퍼 챔버에 도입된 다음 자기적으로 결합된 이송 암에 의해 성장 챔버로 이송되었습니다. 나노로드 성장 전에 기판을 900°C에서 30분 동안 열적으로 세척하여 잔여 자연 산화물을 제거하여 깨끗하고 정돈된 7 × 7 재구성된 Si 표면을 얻었다. 활성화된 질소 원자는 플라즈마 건에 의해 생성되었으며 그 플럭스와 순도는 고해상도 질량 유량 컨트롤러(HORIBA STEC, SEC-7320 M)와 질소 정화기(Entegris, CE35KFI4R)를 통해 제어되었습니다. 고순도(6N 이상) Ga, In, Si 및 Mg 소스는 고체 소스 유출 셀에 의해 제공되었습니다. III족 금속 및 N2 플라즈마 빔 등가 압력(BEP)은 빔 플럭스 게이지로 측정되었습니다. N이 풍부한 조건에 대한 III/V 플럭스 비율을 제어하여 나노로드를 얻을 수 있습니다. 먼저 자기조립된 Si:GaN 나노로드를 760°C에서 82분 동안 성장시켰다. InN의 탈착은 인듐이 샘플 표면에서 증발하기 때문에 상승된 온도에서 중요합니다. 나노로드에서 인듐을 유지하기 위해 금속 변조 에피택시(MME) 기술이 사용되었습니다[67, 68]. MME는 금속 플럭스를 조절하기 위해 금속 셔터를 주기적으로 열고 닫는 것을 포함하지만 N2 셔터가 열려 있습니다. In 농도를 조정하기 위해 In 및 Ga 원자의 두 가지 다른 주기 시간이 550 °C에서 50주기로 20 s/30 s(샘플 B) 및 30 s/30 s(샘플 C) 동안 기판에 교대로 충돌했습니다. 마지막으로 Mg:GaN 층을 600 °C에서 성장시켰다. 샘플은 9.25 × 10 −6 에서 성장했습니다. 플라즈마 전력 450 W, 2.42 × 10 −8 의 torr 활성 질소 BEP torr BEP 및 1.93 × 10 −8 torr Ga BEP. 또한, 단일층 Si:GaN 나노로드(시료 A)도 동일한 조건에서 대조군으로 준비하였다.
나노로드 성장 후, 소자 제조 공정은 다음 단계를 포함하였다. (1) 350 × 350 μm 2 의 장치 면적 메사는 테트라플루오로메탄(CF4 ) 포토레지스트(Microchemicals GmbH, AZ1400)를 마스크로 사용하는 반응성 이온 에칭 기술(Advanced System Technology, Cirie-200)을 기반으로 합니다. (2) 메사 영역을 제외한 장치에서 느슨한 나노로드를 청소하기 위해 탈이온수가 있는 초음파 수조를 사용했습니다. (3) 샘플을 (NH4에 담그십시오. )2 고유 산화물 억제 및 비방사성 재결합 감소를 위해 질화물 표면을 부동태화하기 위해 60°C에서 1 분 동안 S. (4) 포토리소그래피(M&R Nano Technology)와 함께 스퍼터링(Advanced System Technology, Psur-100HB)에 의해 나노로드 위에 100nm ITO(인듐 주석 산화물) 박막을 증착하여 Mg:GaN 옴 투명 접촉 역할을 합니다. , AG350-6B) 및 리프트오프 기술. (5) 다층 Ti/Al/Ti/Au(20 nm/300 nm/20 nm/50 nm) 격자 금속 접점은 ITO 필름과 n-형 Si 기판에 e-빔 증착으로 제작되었습니다(Advanced System Technology , Peva-600E) 포토리소그래피 및 리프트오프 기술을 사용합니다. (6) 모든 그리드 금속 접점은 옴 접점을 얻기 위해 800 °C의 질소에서 30 초 동안 급속 열 어닐링 시스템(Advanced System Technology, FA04)에 의해 어닐링되었습니다.
결정 구조를 더 연구하기 위해 샘플 B와 C의 개별 나노로드를 에탄올에서 초음파 처리하여 추출했습니다. 초음파 처리 30분 후, 에탄올 용액 몇 방울을 구리 그리드(Ted Pella)에 적용하고 에탄올을 실온에서 증발시켰다. 측정 전에 샘플을 150 °C에서 구워 유리 유기 용매를 제거했습니다.
주사 전자 현미경 (SEM) 이미지의 평면도와 단면도는 성장한 나노 막대의 형태를 보여주는 그림 1a-f에 나와 있습니다. 왼쪽에서 오른쪽으로, 그림 1a-c는 20 s/30의 주기 시간에 충돌하는 다양한 In/Ga 원자를 가진 Si:GaN(샘플 A) 및 Mg:GaN/InGaN/Si:GaN의 표면 형태 변화를 나타냅니다. 50 주기 InGaN 성장 동안 각각 s(샘플 B) 및 30 s/30 s(샘플 C). Si:GaN 및 Mg:GaN/InGaN/Si:GaN 나노로드의 직경은 각각 30–100 nm 및 80–150 nm이고 면적 밀도는 ~ 7 × 10 9 입니다. cm −2 . 나노로드의 단면 이미지는 그림 1d–f에 나와 있으며 샘플 A ~ C에 대해 나노로드의 길이가 약 700 nm임을 나타냅니다. Mg:GaN/InGaN/Si:GaN 샘플의 개략 구조가 표시됩니다. 그림 1g에서.
<그림>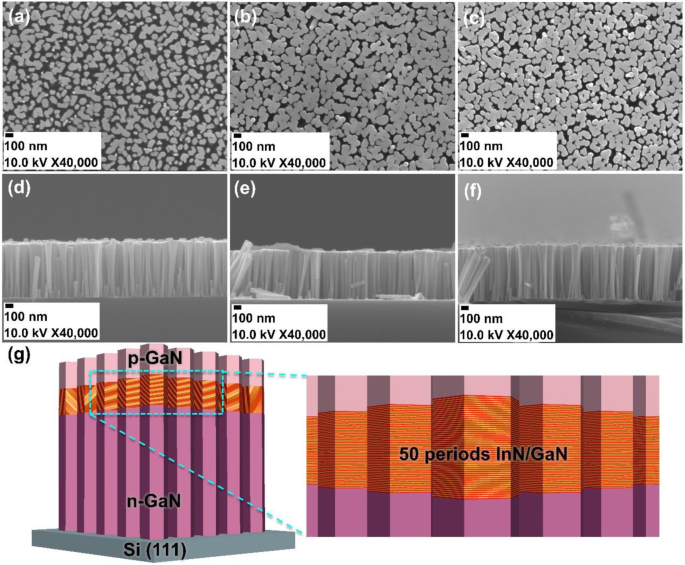
a의 SEM 상위 뷰 n-GaN(샘플 A), In 및 Ga 원자 충돌 주기 시간이 b인 p-GaN/InGaN/n-GaN 20 s/30 s(샘플 B) 및 c 30 s/30 s(샘플 C). d의 SEM 단면도 샘플 A, e 샘플 B 및 f 샘플 C. g p-GaN/InGaN/n-GaN 나노로드 구조의 개략도
그림 2a는 서로 다른 소스 충돌 주기 시간 샘플에 초점을 맞춘 x-선 ta-2theta 회절 측정을 기록했습니다. 28.44°에 위치한 가장 강한 피크는 Si 기판에서 비롯됩니다. 34.56°에서 뚜렷하고 선명한 피크는 GaN(0002) 회절에 해당하며 InGaN 층에서 상 혼합이 잘 억제되었음을 나타냅니다. 샘플 B의 경우 34.22°, 샘플 C의 경우 34.13°에서 GaN(0002) 피크의 하위 2θ측 피크가 InGaN(0002)입니다. c InN과 GaN의 격자상수는 각각 5.760 Å과 5.185 Å이다[74]. 브래그의 법칙에 따라 c InGaN(0002)의 격자 상수는 샘플 B의 경우 5.23 Å, 샘플 C의 경우 5.25 Å로 계산됩니다. c 가져오기 InGaN(0002)의 격자 상수를 Vegard의 법칙에 따라 In 농도는 변형률을 고려하지 않고 시료 B의 경우 8%, 시료 C의 경우 11%로 추정할 수 있습니다. 그림 2b는 샘플 C의 저배율 TEM 이미지와 그 구조의 개략도를 보여줍니다. 영역 1 및 영역 2는 각각 n-GaN 및 InGaN 영역입니다. 영역 1에서 촬영한 SAED(selective-area electron diffraction) 패턴은 [0001] 방향이 나노로드의 장축 및 질화물 나노로드의 공통 성장 방향에 평행함을 보여줍니다. 또한, 결정에 전위가 발견되지 않는다. 그림 2 c 및 d에서 원자 분해능 TEM 이미지는 c GaN 및 InGaN의 격자 상수는 각각 5.19 Å 및 5.25 Å이며 XRD 세타-2세타 스캔을 통해 브래그의 법칙에 의해 계산된 결과와 동일합니다. 또한 c 보충 정보:그림 S1에 표시된 원자 분해능 TEM 이미지를 통해 샘플 B에 대한 InGaN의 격자 상수는 5.23 Å입니다. 또한, 인듐 분포를 나타내는 고각 환형 암시야(HAADF) 이미지와 에너지 분산 X선 분광법(EDS) 라인 스캔이 보충 정보:그림 S2에 포함되어 있습니다.
<그림>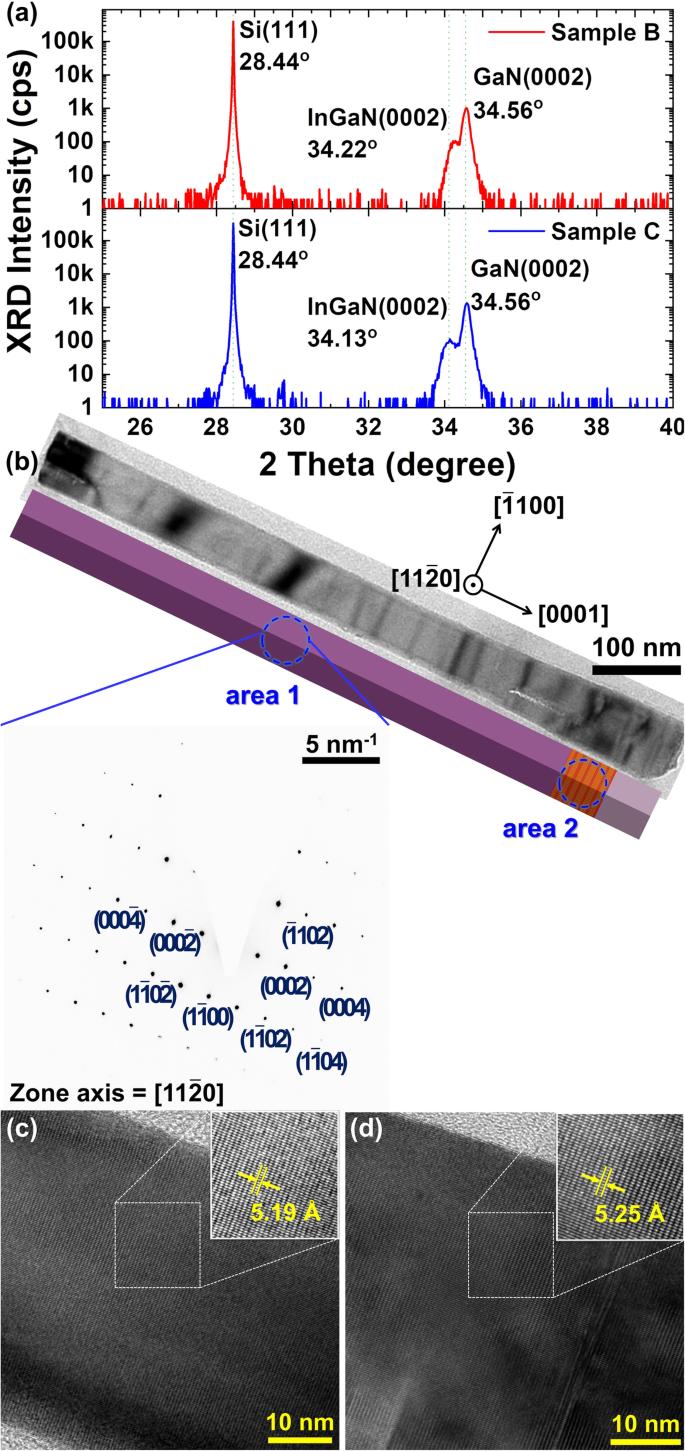
아 theta-2theta 스캔을 위한 HR-XRD 스펙트럼. InGaN 재료의 인듐 함량은 Vegard의 법칙을 사용하여 샘플 B(빨간색 곡선)의 경우 8%, 샘플 C(파란색 곡선)의 경우 11%로 추정되었습니다. ㄴ 무전위 질화물 나노로드 TEM 이미지 및 n-GaN 영역의 SAED 패턴. 이미지 아래의 단일 nanorod 개략도는 구조적 상대적 규모를 따릅니다. c의 원자 해상도 TEM 이미지 영역 1 및 d의 n-GaN 영역 2의 InGaN은 전위가 없고 c 격자 상수
전류 밀도 대 전압 측정은 Keithley 2400 소스 미터로 수행되었습니다. 그림 3a는 나노로드 조립 태양 전지 개략도를 표시합니다. 총 장치 면적은 0.12 mm 2 입니다. 접촉 금속을 제외한 조명 아래의 유효 면적은 0.0924 mm 2 입니다. . 광자 생성 전자를 수집하기 위해 p-GaN 상단에 100nm 투명 전도성 ITO 필름을 증착하여 나노로드와 Ti/Al/Ti/Au(20 nm/300 nm/20 nm/50 nm)를 연결합니다. ) 손가락 전극. 장치의 광전 특성 분석은 그림 3b-d와 같이 1 sun, AM 1.5G 조건에서 솔라 시뮬레이터로 수행되었습니다. 직렬 저항 R s 그림 3b–d에서 결정된 값은 83 Ω, 250 Ω 및 2.5kΩ이고 션트 저항 R 쉿 값은 샘플 A, B 및 C에 대해 각각 413kΩ, 550kΩ 및 2 MΩ입니다. 제로 전압에서의 광전류 밀도, Jsc , 0.08 중 Ga0.92 N 장치(샘플 B) 및 In0.11 GA0.89 N 장치(샘플 C)는 7.77 mA/cm 2 입니다. 및 14.96 mA/cm 2 각기. 증가하는 In 농도에 대한 광전류 향상은 Jsc를 통해 입증되었습니다. 비교. 또한, Krogstrup et al. 나노로드 태양 전지의 집광 특성은 광 흡수를 향상시키고 높은 광전류를 제공할 수 있음을 설명했습니다[64]. 개방 회로 전압(Voc ) 및 샘플 C의 충전율(FF)은 각각 0.28 V 및 30%입니다. 여러 그룹은 또한 더 낮은 Voc를 갖는 나노로드 구조를 시연했습니다. [72, 75, 76]. 실제로 조명된 영역에서 실제 광전지 성능을 설명하려면 유효 영역 PCE, PCEeff , 그리드 전극 면적을 제외한 유효 면적을 기준으로 효율을 설정하는 반면, 전체 면적 PCE, PCEtot , 전체 장치 영역을 고려합니다. PCEtot 및 PCEeff 값은 0.98%와 1.27%로 지금까지 보고된 질화물 나노막대 태양전지의 PCE가 더 높음을 나타냅니다. 주요 기여는 높은 Jsc에서 비롯됩니다. , 비록 Voc 다른 III-질화물 나노막대 태양전지보다 낮다[65, 77]. 낮은 Voc의 두 가지 가능한 이유가 있습니다. , 밴드 다이어그램을 기반으로 하는 Si 밴드갭이 1.12 eV이고 제한된 전류 경로가 표면 페르미 레벨 고정으로 인해 생성될 수 있는 p-n Si 접합에서 제한된 준 페르미 준위를 포함하여 [66]. 표 1은 Jsc를 요약합니다. , Voc , FF 및 세 가지 샘플의 PCE 비교.
<그림>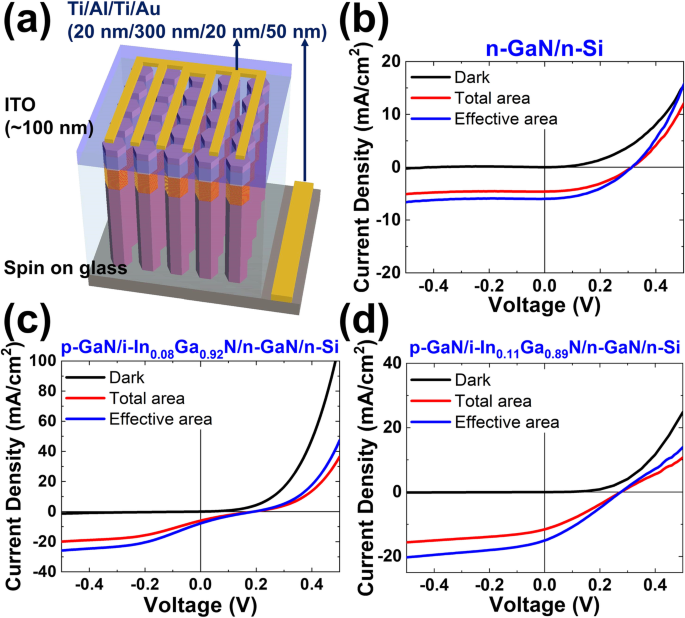
아 nanorod는 태양 전지 개략도를 조립합니다. b의 전류 밀도-전압 곡선 n-GaN/n-Si, c p-GaN/In0.08 Ga0.92 N/n-GaN/n-Si 및 d p-GaN/In0.11 GA0.89 N/n-GaN/n-Si 나노로드 조립 태양 전지 1 태양, AM 1.5G 솔라 시뮬레이터
물리적 및 전기적 특성을 이해하기 위해 밴드 다이어그램은 1D-DDCC(One Dimensional Poisson, Drift-Diffusion 및 Schrodinger Solver) 프로그램을 사용하여 계산됩니다[78]. 사용된 ITO, Si 및 GaN의 전자 친화도는 각각 4.40 eV, 4.05 eV 및 4.1 eV입니다. 그림 4a와 b는 각각 전압 바이어스가 없는 ITO/n-GaN/n-Si 밴드 다이어그램과 어두운 상태에서 J-V 곡선을 보여줍니다. ITO/n-GaN/n-Si 구조는 정류 효과가 없고 선형 J-V 프로파일을 나타냅니다. Si와 GaN 사이의 전도대 오프셋이 50 meV의 작은 값으로 예상되기 때문에 이종 인터페이스의 전위 장벽은 캐리어가 전송하기 위해 무시할 수 있습니다. 이 저항과 같은 선형 J-V 곡선은 실험 결과와 모순됩니다.
<그림>
아 ITO/n-GaN/n-Si 밴드 다이어그램, b ITO/n-GaN/n-Si J-V 곡선, c ITO/n-GaN/p-Si/n-Si 밴드 다이어그램 및 d 1D-DDCC 프로그램으로 시뮬레이션한 ITO/n-GaN/p-Si/n-Si의 J-V 곡선
J-V 곡선 결과에 대한 가능한 설명은 Ga 확산이 GaN/Si 계면에서 p-Si를 유도하고 p-n 접합을 생성한다는 것입니다. Reichertz et al. [14] 및 Neplokh et al. [76]은 질화물 층의 성장 동안 실리콘 기판으로의 Al 확산을 확인했다. 붕소, Al 및 Ga는 p-Si 층 형성을 위한 도펀트가 될 수 있는 IIIB족 원소이다. 그러나 Ga 확산 속도는 700°C에서 8 nm/day입니다[79]. 그림 4c는 n-GaN과 n-Si 계면 사이에 매우 얇은(1 nm) p-Si 층을 포함하는 밴드 다이어그램을 보여줍니다. 전자를 n-Si 기판으로, 정공을 ITO 접촉층으로 유도할 수 있는 p-n Si 접합에 작은 내장 전기장이 생성됩니다. 두께 종속 J-V 곡선은 그림 4d에서 p-Si 층의 두께가 얇아지면 다이오드 턴온 전압이 감소함을 보여줍니다. 초박형 p-Si는 준 페르미 준위 분리에 대한 제한 사항이 될 것이며 Voc 태양열 성능. p-Si 층이 포함된 시뮬레이션된 전기적 특성이 이 연구 결과에 더 가깝습니다. 따라서 Mg:GaN/InGaN/Si:GaN/p-Si/n-Si 구조의 밴드 다이어그램은 그림 5와 같은 모델로 구축할 수 있습니다. 위쪽에서 AM 1.5G 빛의 조명은 흡수로 이어집니다. InGaN 밴드갭보다 높은 에너지를 갖는 광자. 막대와 막대 사이의 공간을 통해 빛이 Si에 조사되면 Si 밴드갭보다 큰 에너지를 가진 광자도 p-n Si 기판에 흡수되어 광전류가 생성됩니다. 동시에, 단파장 광에 의해 질화물 영역에서 생성된 전자-정공 쌍은 p-i-n 접합 내장 전계에 의해 분리된다. 결국, 광 생성 캐리어는 Mg:GaN에 대한 상부 ITO(인듐 주석 산화물) 접촉 및 하부 Si n-접촉을 통해 수집될 수 있습니다. 이 구조 모델을 기반으로 ITO 접촉에 의해 도입된 쇼트키 장벽을 고려한 J-V 곡선 시뮬레이션은 그림 5b에 나와 있습니다. 시뮬레이션된 J-V 곡선은 S자 모양이 p-접점의 비저항 거동으로 인해 발생함을 나타냅니다. 이것이 그림 3의 c와 d에서 Mg:GaN/u-InGaN/Si:GaN(샘플 B와 C)에 존재하는 S자 모양을 설명할 수 있는 이유이다. 따라서 네거티브 바이어스(J네거티브 바이어스(− 0.5 V)에서 전류 밀도 ) S자 모양이 평평해진 경우는 표 S2에 나와 있습니다. J부정적 편향 추가 최적화 및 목표 값을 위한 체크 포인트가 될 수 있습니다.
<그림>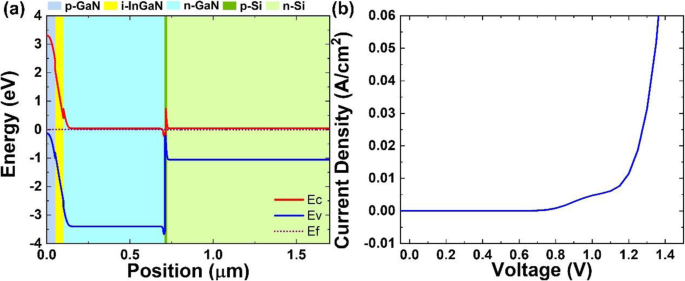
아 1D-DDCC 프로그램으로 시뮬레이션한 p-n Si 태양전지 밴드 다이어그램의 p-i-n 질화물 나노로드. ㄴ p-n Si 태양 전지의 p-i-n 질화물 나노로드의 J-V 곡선 시뮬레이션
Si:GaN/n:Si(샘플 A), Mg:GaN/u-In0.08 Ga0.92 N/Si:GaN(샘플 B) 및 Mg:GaN/u-In0.11 GA0.89 N/Si:GaN(샘플 C). 샘플 C는 InGaN 층의 흡수로 인해 단파장에서 더 높은 값의 원인이 될 수 있는 더 높은 In 농도를 가지고 있습니다. 샘플 A, B 및 C의 최대 EQE는 각각 32%, 55% 및 63%입니다. 그림 6b에 표시된 Si 웨이퍼, 샘플 A, B 및 C의 반사 스펙트럼과 비교할 때 EQE의 진동과 반사 스펙트럼은 서로 다른 층의 간섭으로 인한 것입니다. 베어 Si 웨이퍼는 평평한 표면으로 인해 반사율이 가장 높습니다. 샘플 A, B, C는 나노로드 구조가 빛을 포착하는 효과가 있기 때문에 반사율이 낮습니다. 샘플 C는 장파장에서 가장 높은 EQE를 갖고 가장 높은 광 포획 효과로 인해 가장 낮은 반사율을 갖는 것으로 밝혀졌습니다. 이 결과는 샘플 C에서 생성된 더 높은 광전류를 설명할 수 있습니다. 샘플 B와 샘플 C의 실온(RT, 300 K) 광발광(PL) 스펙트럼이 그림 6c에 나와 있습니다. 3.40 eV에 위치한 가장 높은 피크는 GaN NBE(near band edge) 방출입니다. 3.09 eV 및 3.03 eV에 위치한 피크는 In0.08로 인한 것입니다. Ga0.92 N 및 In0.11 GA0.89 N NBE 방출. 결과는 RT에서 3.1 eV 및 3.0 eV의 보잉 방정식 계산 값과 유사합니다[4]. 또한 EQE 및 반사 스펙트럼과 동일한 강력한 Fabry-Perot 진동(별 기호로 표시)을 보여주며 각 레이어/표면 사이의 부드러운 인터페이스를 나타냅니다.
<그림>
아 3개의 질화물 나노로드/Si 샘플의 외부 양자 효율 스펙트럼. ㄴ 베어 Si 웨이퍼와 3개의 질화물 나노로드/Si 샘플의 반사 스펙트럼. ㄷ 두 개의 InGaN 샘플의 실온 광발광 스펙트럼
플라즈마 보조 분자빔 에피택시에 의해 n-Si 상에 성장된 고품질 Mg:GaN/InGaN/Si:GaN 및 Si:GaN 나노로드가 성공적으로 시연되었습니다. 태양광 측정은 PCEeff를 나타냅니다. 1.27% 및 PCEtot Mg:GaN/u-In0.11에 대한 1 태양, AM 1.5G 조명에서 0.98% GA0.89 N/Si:GaN은 더 높은 In 농도와 높은 광전류를 유도하는 더 높은 빛 트래핑 효과를 가지고 있습니다. n-Si 장치의 Si:GaN 나노로드에는 눈에 띄는 p-n 접합 내장 필드가 없을 수 있지만 적절한 이종 접합 구조의 설계는 광 캐리어를 상단 및 하단 접촉으로 구동하고 전지 성능을 향상시키는 데 도움이 됩니다.
저자는 자료와 데이터를 독자가 사용할 수 있음을 선언하며 이 원고의 모든 결론은 이 백서에 제시되고 표시된 데이터를 기반으로 합니다.
발광 다이오드
전력 변환 효율
단락 전류 밀도
플라즈마 보조 분자빔 에피택시
고해상도 X선 회절
고해상도 투과전자현미경
외부 양자 효율
빔 등가 압력
금속 변조 에피택시
인듐 주석 산화물
개방 회로 전압
실내 온도
광발광
니어 밴드 에지
나노물질
초록 삼항 및 합성 MoIn2 S4 고슴도치 볼 구조의 @CNTs 상대 전극(CE)은 손쉬운 1단계 열수 방법을 사용하여 합성되었습니다. 합성 MoIn2 S4 @CNTs 필름은 N2를 통해 큰 비표면적을 보유합니다. 더 많은 전해질을 흡착하고 전극에 더 큰 활성 접촉 영역을 제공하는 데 유리한 흡착-탈착 등온선 테스트. 또한 합성 MoIn2 S4 @CNTs CE는 순환 전압전류법, 전기화학 임피던스 및 Tafel 곡선을 포함한 일련의 전기화학 테스트에서 만들어진 낮은 전하 이동 저항과 미세한 전기촉매 능력을 나타냅니다. 최적의 조
초록 페로브스카이트 태양 전지는 밴드 갭 조정이 가능하고 흡수 계수가 높으며 준비 비용이 낮기 때문에 실리콘 기반 탠덤 태양 전지에 사용됩니다. 그러나 상부 페로브스카이트 흡수층의 광학 굴절률과 비교하여 하부 실리콘의 상대적으로 큰 광학 굴절률은 2단자 장치에서 상당한 반사 손실을 초래합니다. 따라서 Si 바닥 셀에서 광전류 흡수를 향상시키기 위해서는 광 관리가 중요합니다. 이 논문에서 TiO2로 채워진 나노홀 어레이 하단 셀 설계에 도입되었습니다. 유한 차분 시간 영역 방법을 통해 300~1100nm 범위의 흡수 효율과 광전류