산업기술








칩 패키징 기술의 발달로 BGA(Ball Grid Array)가 표준 패키징 형태로 여겨져 왔다. 수백 개의 핀이 있는 칩에 관한 한 BGA 패키지를 적용하면 엄청난 이점이 있습니다.
BGA 칩은 BGA 패키지 모양에서 QFP(쿼드 플랫 패키지) 칩보다 우위에 있습니다. BGA 패키지는 QFP 칩에서 주변 리드를 대체하는 솔더 볼 어레이로 칩의 물리적 크기를 극적으로 줄입니다. 이는 여러 I/O 핀을 사용할 수 있을 때 특히 분명합니다. BGA의 표면적은 I/O 핀 수가 증가함에 따라 선형적으로 증가하는 반면 QFP의 표면적은 I/O 핀 수가 제곱의 개선에 따라 증가합니다. 결과적으로 BGA 패키지는 QFP보다 핀이 여러 개인 구성 요소에 더 많은 제조 가능성을 제공합니다. 일반적으로 I/O 핀 수는 250에서 1089 사이이며 특히 패키징 유형 및 크기에 따라 결정됩니다. 제조 가능성에 관한 한 BGA 칩도 QFP 칩보다 성능이 좋습니다. BGA 패키지 칩의 핀은 볼 모양이며 2D 어레이로 분포되어 있습니다. 또한 I/O 핀은 QFP보다 피치가 더 크고 접촉으로 인해 변형되지 않는 단단한 볼 역할을 합니다. 칩 제조사의 경우 BGA 칩의 또 다른 장점은 높은 수율에 있습니다. BGA 칩의 조립 불량률은 일반적으로 핀당 0.3ppm~5ppm으로 동등하게 불량품이라고 볼 수 있습니다.
위에서 논의한 이유들 덕분에 BGA 패키지 칩은 전자어셈블러들에 의해 널리 적용되고 있다. 그러나 BGA 패키지의 독특한 모양은 설계 단계에서 몇 가지 중요한 레이아웃 팁을 활용하지 않는 한 납땜 시 단락 위험이 더 높아집니다. 따라서 이 기사는 나머지 부분에서 SMT(표면 실장 기술) 어셈블리에서 최적의 납땜 효과를 얻을 수 있도록 BGA 칩에 대한 몇 가지 중요한 레이아웃 규칙을 설명합니다.
BGA 패키지의 솔더 볼 피치는 일반적으로 50mil로 유지됩니다. PCB(인쇄 회로 기판) 제조 공정에서 사용되는 기술 요구 사항을 충족하려면 관통 구멍과 패드 가장자리 사이의 간격이 최소 8mil이어야 하고 트레이스와 패드 가장자리 사이의 간격은 5mil에서 6mil로 줄일 수 있습니다. 따라서 BGA 칩의 패드 크기를 18mil ~ 25mil로 정의하고 BGA 솔더 볼 사이의 트레이싱 너비는 6mil ~ 8mil 범위에 있어야 합니다.
BGA 패키지는 육안으로 검사하기 어렵고 솔더 조인트는 육안으로도 확인되지 않기 때문에 조립 검사, 수동 조립 및 재작업 후 교체 요구 사항에 맞게 정확한 기준 표시를 설정해야 합니다.
다음 그림과 같이 BGA 구성 요소의 반대쪽 모서리에 두 개의 기준 표시를 배치하거나 두 개의 모서리 표시를 배치하는 것이 일반적입니다.
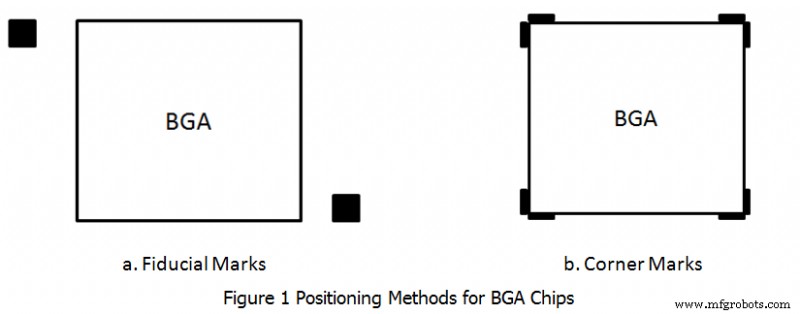
기준 표시와 모서리 표시는 모두 BGA 패키지와 동일한 레이어, 즉 구성 요소 레이어에 배치됩니다. 기준 마크는 일반적으로 20mil에서 80mil 사이의 크기 범위를 갖는 정사각형, 원형 및 삼각형의 세 가지 유형을 특징으로 하며 솔더 마스크가 덮이지 않은 영역은 60mil의 크기로 남아 있습니다. 모서리 표시의 너비는 8mil에서 10mil 사이이며 BGA 패드 그래픽에 가장 정확한 정렬을 제공합니다.
일반적으로 말해서, 블라인드 비아와 매립 비아가 교체된 패드 사이에는 관통 구멍이 배열되어서는 안 됩니다. 그럼에도 불구하고, 그 방법은 PCB 제조에 더 높은 비용을 초래할 것입니다. 패드 사이에 관통 구멍을 적용해야 하는 경우 솔더 마스크 오일을 사용하여 솔더가 흘러내리는 것을 막거나 솔더링에서 단락을 방지하기 위해 구멍을 채우거나 덮어야 합니다.
BGA 칩의 모든 핀 중 전원 또는 접지에서 파생되는 것이 많습니다. 패드가 관통 구멍으로 설계된 경우 추적을 위해 많은 공간이 절약됩니다. 그러나 이러한 유형의 설계는 리플로우 솔더링 기술에만 적용됩니다. 쓰루 홀 조립 방식을 사용하기 때문에 쓰루 홀의 부피는 솔더 페이스트의 양과 호환되어야 합니다. 이 기술이 적용되는 한 솔더 페이스트는 스루홀을 채울 것입니다. 해당 요소를 고려하지 않으면 솔더 볼이 전도성이 떨어지는 솔더 조인트로 가라앉게 됩니다.
BGA 칩 레이아웃은 위의 측면에서 결코 제한되지 않으며 단일 기사에서 BGA 칩의 모든 레이아웃 팁을 다루는 것은 거의 불가능합니다. 위 항목 외에도 BGA 구성 요소 레이아웃은 계약 제조업체 또는 조립 업체의 기능 및 장비 매개 변수와도 관련이 있습니다. 예를 들어, 칩 마운터가 처리할 수 있는 최대 및 최소 보드 크기는 서로 다를 수 있으므로 다른 설계 요구 사항과 호환되도록 해당 설계 수정이 필요합니다. 결과적으로 조립된 PCB 및 추가 최종 제품의 최적 성능을 얻기 위해 BGA 칩 레이아웃에 관한 모든 것을 완전히 확인하는 것이 매우 중요합니다.
실제 제조 또는 조립 전에 PCBCart의 엔지니어가 확인 시간이 필요합니다. 그것은 실제로 완전히 가치가 있습니다. 모든 확인은 귀하의 설계, 제조 능력 및 장비 매개변수 간의 완벽한 일치를 위해 그리고 예상되는 기능이 손상되지 않으면서 시간과 비용을 최대한 절약하기 위해 진행됩니다. 지금 BGA 구성 요소 레이아웃 제안을 원하십니까? 참고:그들은 무료입니다. 아래 버튼을 클릭하여 온라인 견적을 시도하십시오. 맞춤형 PCB 조립 비용을 계산해 드립니다.
유용한 리소스
• BGA 패키징 기술 소개
• BGA 어셈블리 품질에 영향을 미치는 요소
• BGA(Ball Grid Array) 패키지에 표면 실장 기술(SMT) 적용
• BGA(Ball Grid Array) 솔더 조인트에 대한 효과적인 품질 관리 조치
• 효율적인 BGA 어셈블리를 보장하기 위한 설계 파일 요구사항
• BGA 어셈블리 요구 사항에 대한 정확한 견적을 얻는 방법
산업기술
더 안전한 산업용 유체 시스템 구축을 위한 7가지 팁 Ken Backus, 현장 엔지니어, 북미 산업 플랜트나 정유 공장에서는 모든 구석에 잠재적인 안전 위험이 도사리고 있습니다. 공장 관리자로서 귀하의 주요 책임 중 하나는 이러한 위험을 줄여서 안전을 보장할 뿐만 아니라 가동 시간을 유지하고 시설에서 안정적인 수익 흐름을 유지하는 것입니다. 한 가지 중요한 초점 영역은 공장의 산업용 유체 시스템입니다. 이러한 시스템은 종종 문제가 발생할 경우 건강, 안전 및 환경 문제를 증가시킬 수 있는 고압 및 고온 유체 및 가스를 운
3D 프린터 사용자는 부품을 만들 때 특정 문제가 발생할 수 있으므로 조언을 따르는 것이 좋습니다 3D 프린팅을 시작하기 전에 발생 가능한 오류 및 오류를 방지하기 위해 아래에 나와 있습니다. . 1. .STL 파일 검토 3D 프린터 사용자가 인쇄하려는 인터넷 모델을 디자인하거나 다운로드할 때 모델을 확인하고 얼굴이나 표면 사이에 열린 영역이 없는지 확인해야 합니다 , 그들은 존재하기 때문에 조각에서 보이드 또는 필라멘트 형태의 오류를 유발합니다. 이를 방지하기 위해 GCode (Pronterface, Cura, Simplif