나노물질








우리는 전하 중성 스크린 효과를 조절하기 위해 비아 홀 길이의 변조를 통해 다중 메사 채널(MMC) 폭의 일반적인 한계를 극복하는 새로운 GaN HEMT(고전자 이동성 트랜지스터)를 제시합니다. 향상된 표면 피닝 효과를 기반으로 최대 300nm 너비의 향상 모드(E-모드) GaN HEMT를 준비했습니다. MMC 구조와 폭, 비아홀 길이가 각각 100nm/2μm 및 300nm/6μm인 E-모드 GaN HEMT는 양의 임계 전압(V 번째 ) 각각 0.79 및 0.46V입니다. MMC 및 비아홀 길이 구조의 온 저항은 일반적인 3중 게이트 나노리본 GaN HEMT보다 낮았습니다. 또한, 소자는 E-모드를 달성했을 뿐만 아니라 GaN HEMT의 전력 성능을 개선하고 소자 열 효과를 효과적으로 완화했습니다. E-모드 GaN HEMT를 얻기 위해 비아 홀 길이 측벽 표면 고정 효과를 제어했습니다. 우리의 연구 결과는 GaN HEMT에서 일반적으로 벗어난 비아 홀 길이가 차세대 전력 전자 장치에 사용할 수 있는 큰 잠재력을 가지고 있음을 시사합니다.
<섹션 데이터-제목="배경">광대역 갭 III-V 질화물은 큰 밴드 갭, 높은 임계 전기장, 높은 포화 전자 속도 및 높은 전도도를 포함하는 우수한 재료 특성으로 인해 주파수 및 전압 작동을 위한 유망한 반도체 재료입니다[1, 2]. 따라서 LED(Light Emitting Diode), 트랜지스터 등 다양한 응용 분야에서 널리 사용되고 있다[3]. 또한, 알루미늄 갈륨 질화물/갈륨 질화물(AlGaN/GaN) 이종 구조는 III-질화물 화합물의 자발적 및 압전 분극을 이용하여 고성능 장치 개발에 적합한 2차원 전자 가스(2DEG)를 형성합니다[4,5 ,6]. 2DEG의 양은 소자 특성에 직접적인 영향을 미치는 분극 유도 도핑의 비율에 의해 영향을 받습니다[7,8,9]. AlGaN/GaN 고 전자 이동성 트랜지스터(HEMT)는 많은 매력적인 특성을 가지고 있지만 전자 특성이 디지털, 전력, RF 및 마이크로웨이브 회로 애플리케이션을 위한 복잡한 회로 구성을 요구할 수 있기 때문에 보편적인 유틸리티를 찾지 못했습니다. 따라서 향후 III-V 반도체 장치[10, 11]에 대해 평상시에는 오프 작동이 필수적입니다. 일부 특수 제조 기술이 테스트되었지만(예:오목한 게이트의 사용[12,13,14], 게이트 아래에 p형 캡핑 층 삽입[15, 16], 터널 접합 구조[17], 불소 이온 주입 게이트 아래의 장벽[18]과 특수 금속 게이트와 급속 열 어닐링(RTA) 처리[19]와 함께 얇은 AlGaN 장벽 층을 포함하면 장치 성능을 악화시키고 공정으로 인한 재료 손상을 통해 안정성 문제를 일으킬 수 있습니다. 증가된 열 및 전기장 효과.
또는 홋카이도 대학의 팀은 핀 나노채널로 제작된 AlGaN/GaN HEMT가 임계 전압(V 번째 ) 양의 방향으로 [20, 21]. Soochow University의 한 그룹은 V의 값이 번째 나노채널 너비가 90nm보다 작을 때 체계적인 양의 이동을 겪었습니다[22]. 경북대학교 연구원들은 거동을 설명하기 위해 채널 측면의 부분 변형 이완을 고려했습니다[23]. 매사추세츠 공과 대학(Massachusetts Institute of Technology)의 팀은 GaN 기반 HEMT의 표면 패시베이션 후 임계 전압을 시뮬레이션하고 채널 너비가 100nm 미만일 때 양의 값이 발생한다고 결정했습니다[24]. 측벽 효과와 인장 응력 증가의 결과입니다. 이는 채널의 전자 농도를 감소시켰습니다. 핀형 구조는 3차원 구조로 인해 문턱 전압을 이동시킬 뿐만 아니라 게이트 제어성을 향상시켜 온 상태 성능을 유도하고 오프 상태 특성을 향상시킵니다. 정규화된 최대 드레인 전류(I D /mm) 핀형 구조의 AlGaN/GaN HEMT는 해당 평면 구조의 HEMT보다 높다[25]. 이러한 방법이 E-모드 HEMT를 제조하는 데 사용되었지만 고성능 GaN 전력 트랜지스터를 개발하는 것은 여전히 매우 어렵습니다. 먼저 낮은 온저항(R 켜기 ) 및 낮은 장치 총 전력은 채널의 너비가 100nm 미만으로 제한될 때 달성하는 것입니다. R의 값은 켜기 채널의 길이는 정상 오프 게이트의 길이를 줄임으로써 감소될 수 있으며, 오프 상태 드레인 누설 전류를 제어하는 것은 게이트 폭이 극성화 쿨롱 필드 산란 및 게이트 누설 경로를 통해 트랜스컨덕턴스와 게이트 누설에 영향을 미치기 때문에 또 다른 문제를 제기합니다[26, 27 ]. 증착된 필름을 게이트 유전체로 사용하여 이러한 문제를 개선할 수 있습니다[28].
이 편지에서 우리는 3중 게이트 채널의 폭 제한에 대한 돌파구를 설명하고 채널의 비아홀 길이를 변조하는 방법을 제안합니다. 우리 장치는 300nm의 MMC 구조와 6μm의 비아홀 길이로 E-모드를 달성했으며 0.46V의 임계 전압을 나타냈습니다. 이 접근 방식은 장치 온 저항(R 켜기 ) 뿐만 아니라 줄 가열 효과를 완화할 수도 있습니다. 다양한 채널 너비와 비아홀 길이를 가진 3D 트라이 게이트를 결합하여 V의 양수 값을 갖는 normal off GaN HEMT를 달성했습니다. 번째 채널 너비/비아홀 길이가 각각 100nm/2μm 및 300nm/6μm일 때 0.79 및 0.46V입니다.
AlGaN/GaN 에피 웨이퍼는 Nippon Sanso SR-2000 금속-유기 화학 기상 증착 시스템(MOCVD)을 사용하여 (0001) 사파이어 기판에서 성장되었습니다. 에피택시 구조의 성장은 600°C에서 증착된 GaN 핵형성 층으로 시작되었습니다. 2μm 두께의 의도하지 않게 도핑된 GaN 버퍼층, 21.8nm 두께의 의도하지 않은 도핑된 AlGaN 장벽층(공칭 알루미늄 조성 23%), 2nm 두께의 GaN 캡층이 1180°C에서 증착되었습니다. BCl3이 있는 유도 결합 플라즈마(ICP) 반응성 이온 에칭(RIE) 시스템을 사용하여 장치 처리를 시작했습니다. /Cl2 130nm 깊이의 메사를 분리하고 주기적인 트렌치 구조를 에칭하기 위한 가스 혼합물. 그 후, 리세스 영역과 메사 측벽의 결정면을 복원하고 표면 결함 및 이온 충격 손상 수준을 줄이기 위해 두 가지 프로세스가 적용되었습니다. 첫 번째는 결정학적 습식 화학적 에칭을 위해 용융 KOH를 사용하여 건식 에칭으로 인한 표면 손상을 제거하고 동시에 매끄러운 수직 측벽을 생성하는 것입니다. 두 번째는 피라냐 용액(H2 SO4 및 H2 O2 ) 표면 청소 및 유기 잔류물 제거용. DC 측정을 위한 드레인, 소스, 게이트 및 접촉 패드를 정의하기 위해 수은 램프를 사용한 기존의 포토리소그래피가 적용되었습니다. 티타늄/알루미늄/니켈/금(Ti/Al/Ni/Au, 30/120/20/80 nm)으로 구성된 AlGaN/GaN 이종접합에 대한 옴 접촉은 전자빔 증발을 통해 드레인/소스 영역에 증착되고 진공 상태에서 30초 동안 850°C에서 어닐링 트랜지스터 채널을 완성하기 위해 Ni/Au(20/80nm)의 전자빔 증발을 통해 게이트 전극을 제작했습니다. 그림 1은 HEMT 구조의 단면, 기기의 평면도, 기기의 3D 구조 다이어그램을 개략적으로 보여줍니다. 게이트 길이(L g ), MMC 구조 너비(W MMC ), MMC 구조 비아홀 길이(L MMC ) 및 MMC 구조 높이(H MMC )는 각각 2μm, 100~500nm, 1~6μm, 130nm였습니다. 지느러미는 병렬로 연결되었습니다. 표면 피닝 효과를 향상시키기 위해 GaN HEMT 비아홀 길이 구조는 패시베이션되지 않았습니다. 그림 2a는 소스 및 드레인 영역의 금속 표면에 대한 평면도 SEM(주사 전자 현미경) 이미지를 보여줍니다. 그림 2b의 광학 현미경(OM) 이미지는 완전한 게이트와 채널을 보여줍니다. 장치에 존재하는 채널 수를 관찰하는 것은 실제 전류를 계산할 때 도움이 되었습니다. 어닐링 후 결정 격자에서 원자가 이동하고 전위 수가 감소하여 저항이 효과적으로 감소하기 때문에 이미지에서 표면이 거칠게 나타납니다. 그림 2c의 SEM 이미지는 채널의 치수를 확인했습니다.
<그림><그림><소스 유형="이미지/webp" srcset="//media.springerature.com/lw685/springer-static/image/art%3A10.1186%2Fs11671-017-2189-3/MediaObjects/ 11671_2017_2189_Fig1_HTML.gif?as=webp">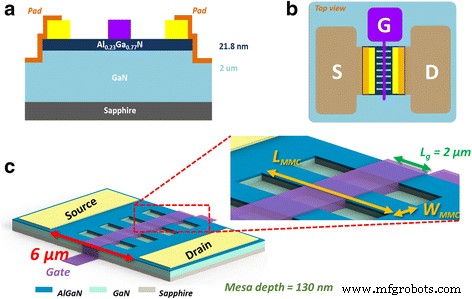
a의 개략도 트랜지스터 채널에 평행한 방향에서 본 HEMT 구조의 단면; ㄴ HEMT 구조의 평면도; 및 c HEMT의 3차원 구조
<그림><그림><소스 유형="이미지/webp" srcset="//media.springerature.com/lw685/springer-static/image/art%3A10.1186%2Fs11671-017-2189-3/MediaObjects/ 11671_2017_2189_Fig2_HTML.gif?as=webp">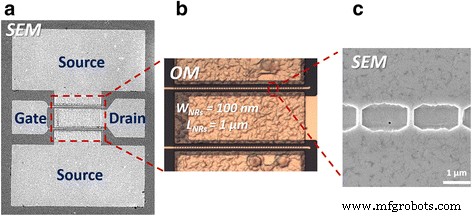
아 장치의 평면도 SEM 이미지; ㄴ 각각 100nm 및 1μm의 채널 너비와 길이를 나타내는 기기의 평면도 OM 이미지 및 c 채널의 상위 뷰 SEM 이미지
지금까지 GaN 고전압 트랜지스터의 대부분의 기술 개발은 AlGaN/GaN HEMT를 기반으로 했으며, 이는 AlGaN-GaN 인터페이스에서 분극 유도된 2D 전자 가스로 인해 본질적으로 공핍 모드(D 모드) 장치입니다. [29]. 그럼에도 불구하고 전력 전자 산업이 GaN 기술을 널리 채택하려면 일반적으로 꺼진 GaN 트랜지스터가 필요합니다.
(Al)GaN 표면의 댕글링 본드 수는 약 10 15 입니다. cm −2 ; 이러한 댕글링 본드는 표면 고정 효과의 결과로 표면이 고갈된 밴드 굽힘을 유발합니다. 그림 3a는 3중 게이트 구조의 측벽 게이트에서 측면 채널 표면 공핍 영역을 표시합니다. 경북대학교 연구원들도 비슷한 현상을 보고했다[21]. 그림 3b는 I를 나타냅니다. DS –V G 고정 값이 L인 장치의 전달 특성 MMC 2μm 및 W 값 MMC 100, 300, 500nm입니다. 드레인-소스 전압이 8V일 때 V의 값은 번째 이들 장치의 전압은 각각 +0.79, -1.32, -2.18V였습니다. 따라서 채널이 좁아짐에 따라 문턱 전압의 양의 이동이 발생했습니다. 이 현상은 측면 채널 공핍 및 비아 홀 길이 표면 굽힘의 영향을 통해 MMC 비아 홀 길이 구조의 측벽에서 2μm 비아 홀 길이의 표면 고정으로 인한 것일 수 있습니다. .
<그림><그림><소스 유형="이미지/webp" srcset="//media.springerature.com/lw685/springer-static/image/art%3A10.1186%2Fs11671-017-2189-3/MediaObjects/ 11671_2017_2189_Fig3_HTML.gif?as=webp">
아 넓고 좁은 채널을 갖는 AlGaN/GaN HEMT의 개략도. ㄴ 나 DS –V G L 값을 갖는 장치에 대해 측정된 전달 특성 MMC 2μm의 다양한 값과 W MMC
그림 4는 IDS를 표시합니다. -VG 고정 값이 W인 장치의 전달 특성 MMC 300nm 및 L 값 MMC 1, 2, 6μm 드레인-소스 전압이 8V일 때 V의 값은 번째 각각 -2.12, -1.07, +0.46V였습니다. 기기는 MMC 길이와 너비가 각각 6μm 및 300nm일 때 정상 오프 작동을 달성했습니다. 비아홀 길이와 채널 폭을 조절하면 정상적으로 꺼진 작동을 표시하는 장치를 제공할 수 있습니다. 표 1에는 다양한 비아홀 길이 및 다중 메사 채널 너비에 대해 측정된 임계값 전압이 나와 있습니다. 채널 폭을 500nm로 고정하고 비아홀 길이를 0.8에서 6μm로 늘리면 V의 값이 번째 -2.62에서 -1.62V로 증가하고, 포화 드레인 전류는 747에서 98mA/mm로, 트랜스컨덕턴스는 270에서 40mS/mm로 감소했습니다. 채널 너비를 300nm로 고정하고 비아홀 길이를 0.8에서 6μm로 늘리면 V의 값이 번째 -2.15에서 +0.46V로 증가하고 포화 드레인 전류는 685에서 6.8mA/mm로, 트랜스컨덕턴스는 290에서 7.4mS/mm로 감소했습니다. 채널 폭을 100nm로 고정하고 비아홀 길이를 0.8에서 2μm로 늘리면 V의 값이 번째 -0.41에서 +0.79V로 증가하고 포화 드레인 전류는 547에서 53mA/mm로, 트랜스컨덕턴스는 400에서 67mS/mm로 감소했습니다. HEMT 전류 처리 용량은 캐리어 농도에 의해 크게 영향을 받습니다[20, 21]. 따라서 장치의 포화 드레인 전류 및 트랜스컨덕턴스는 GaN HEMT의 너비와 비아홀 길이를 변경할 때 측벽 전체 표면 상태와 3중 게이트 채널의 표면 공핍 효과에 의해 크게 영향을 받았습니다. 이전에 보고된 장치[23]와 비교하여 우리 장치는 일반적으로 GaN HEMT에서 사용하지 않는 낮은 온 저항에 대한 새로운 이정표에 도달했습니다.
<그림><그림><소스 유형="이미지/webp" srcset="//media.springerature.com/lw685/springer-static/image/art%3A10.1186%2Fs11671-017-2189-3/MediaObjects/ 11671_2017_2189_Fig4_HTML.gif?as=webp">
나 DS –V G 고정 값이 W인 장치의 전달 특성 MMC 300nm 및 다양한 L 값 MMC
<그림>우리는 다중 메사 채널(MMC) 구조를 갖는 E-모드 GaN HEMT를 준비했습니다. 채널 너비와 비아홀 길이가 각각 300nm와 6μm일 때 0.46V의 양의 임계값 전압을 나타냈습니다. 우리는 측면 채널 고갈과 비아 홀 길이 표면 굽힘 모두의 영향을 추론합니다. MMC 비아홀 길이 구조를 갖는 트라이 게이트를 포함할 때, 새로운 normal off GaN HEMT는 MMC 구조 폭을 300nm(이전에는 100nm 미만으로 제한)로 증가시켰을 때에도 매우 낮은 온 저항을 나타냈습니다. 또한, 비아 홀 길이 MMC 구조의 변조는 MMC 구조 장치 폭을 증가시킨 결과로 우수한 전력 성능을 향상시키는 GaN HEMT에서 일반적으로 제공됩니다.
나노물질
CNC(컴퓨터 수치 제어) 기계는 원자재를 완성 부품으로 변환하기 위해 수치 코드를 데카르트 좌표로 변환하도록 프로그래밍된 장치입니다. CNC 밀링은 컴퓨터 제어와 밀링 머신을 활용하여 부품을 생산하기 위해 솔리드 블록에서 재료를 점진적으로 제거하는 특정 유형의 CNC 가공입니다. 밀링 머신은 재료를 절단하고 드릴링한다는 점에서 다른 드릴링 머신과 유사합니다. 그러나 밀링 머신은 다른 각도로 절단하고 다른 축을 따라 이동할 수 있다는 점에서 표준 드릴링 머신과 다릅니다. 기술적으로 밀링 머신이 가질 수 있는 축의 수에는 제한이 없
공장 및 기타 산업은 150년 이상 존재해 왔으며 사람들은 그보다 오래 전에 작은 상점이나 집에서 자신의 상품을 만들고 있었습니다. 손으로 물건을 만드는 것이 전통이라면 기계로 물건을 만드는 것이 현대의 추세입니다. 3개 이상의 모션 축이 있는 로봇을 생산 라인에 도입한 산업 자동화는 제조업체의 사고 방식을 완전히 바꿔 놓았습니다. 자동화된 산업용 로봇은 여러 가지 이유로 제조업체에게 매력적입니다. 첫 번째는 가장 분명한 속도 중 하나입니다. 인간 작업자가 이러한 지루한 작업을 수행할 때 작업자마다 다른 자신의 속도로 작업을 수행