나노물질








다층 MoS2에서의 에너지 밴드 정렬 /ZrO2 인터페이스 및 CHF3의 효과 밴드 오프셋에 대한 플라즈마 처리는 X선 광전자 분광법을 사용하여 조사되었습니다. MoS2의 가전자대 오프셋(VBO) 및 전도대 오프셋(CBO) /ZrO2 샘플은 각각 약 1.87eV 및 2.49eV입니다. VBO가 CHF3가 있는 샘플의 경우 약 0.75eV만큼 확대되었지만 Zr 3d 코어 레벨의 상향 이동에 기인한 플라즈마 처리. 계산 결과 F 원자는 Zr 원자와 강한 상호작용을 하며 Zr 원자의 d-오비탈에 대한 가전자대 에너지 이동은 약 0.76eV로 실험 결과와 일치합니다. 이 흥미로운 발견은 ZrO2의 적용을 권장합니다. MoS2의 게이트 재료로 기반 전자 장치 및 밴드 정렬을 조정하는 유망한 방법을 제공합니다.
지난 수십 년 동안 SiO2 /Si계 재료는 집적 논리 회로, 비휘발성 메모리 등과 같은 전자 장치의 제조에서 지배적인 역할을 했습니다. 그러나 디바이스의 크기가 마이크로미터에서 10nm 미만으로 끊임없이 축소됨에 따라 기존 반도체는 향상된 비정전용량, 낮은 게이트 누설 전류 및 높은 캐리어 이동도에 대한 요구 사항을 충족하기 어려웠습니다. 따라서 소자 채널로서의 새로운 반도체와 절연체로서의 high-k 산화물에 대한 탐색이 어려워지고 있습니다. 그래핀의 발견 이후 2차원(2D) 물질, 특히 적절한 밴드 갭을 갖는 반도체의 성공적인 제조는 이러한 단점을 극복할 수 있는 유망한 방법을 제공했습니다.
2D 재료 중 이황화몰리브덴(MoS2 ) 레이어 수와 기판 재료의 선택에 따라 조정 가능한 특성을 갖는 것은 우수한 화학적 안정성과 기계적 유연성뿐만 아니라 우수한 광학 및 전기적 특성으로 인해 점점 더 주목을 받고 있습니다[1, 2]. 단층 MoS2의 에너지 밴드 갭 대량의 경우 약 1.80eV인 반면 1.20eV입니다. MoS2로 만든 전자 및 광전자 장치의 유망한 성능 전계 효과 트랜지스터[3,4,5], 센서[6], 광검출기[7]와 같은 층은 기존 전자 장치에서 Si를 대체하고 웨어러블 및 유연한 시스템에서 유기 반도체를 잠재적으로 대체할 수 있음을 증명합니다[8, 9,10,11]. 단일 레이어 MoS2에도 불구하고 기반 전계 효과 트랜지스터(FET)는 약 10 8 의 높은 전류 켜짐/꺼짐 비율로 우수한 성능을 나타냈습니다. 및 낮은 하위 임계값 스윙 ~ 77mV/decade[3], 넓은 면적의 고품질 단일 레이어 MoS2 합성으로 인해 광범위한 적용이 방해를 받았습니다. 및 장치의 안정성 [12,13,14]. 다중 레이어 MoS2 탄도 한계에서 높은 구동 전류에 기여하는 고밀도 상태로 인해 더 매력적일 수 있습니다[15]. 또한 다층 MoS2의 캐리어 이동성 유전체 스크리닝 효과로 인해 높은 κ 산화물에 의해 더욱 크게 개선될 수 있습니다[16, 17]. 따라서 다층 MoS2를 조사하는 것이 필수적이며 중요합니다. /high-κ 산화물 이종접합.
이종 접합 전자 장치에서 전자 수송 특성은 VBO(가전자대 오프셋) 및 CBO(전도 밴드 오프셋) 측면에서 반도체와 절연체 산화물 사이의 계면에서 에너지 밴드 프로파일에 의해 정밀하게 제어됩니다. VBO와 CBO는 정공과 전자의 주입에 의해 형성되는 누설 전류를 줄이기 위해 장벽으로 작동하도록 가능한 한 커야 하며, 특히 CBO는 게이트에 적합한 고유전율 산화물을 선택하는 데 중추적인 역할을 합니다. 전류 누출을 피하기 위해 최소 1eV보다 커야 합니다[18,19,20]. 한편, 반도체/산화물에 위치한 계면 전하는 대역 엔지니어링에 중요한 영향을 미치며 SiH4와 같은 패시베이션 기술을 통해 최적화해야 합니다. 패시베이션 및 CHF3 치료. 이 논문에서는 다층 MoS2의 밴드 정렬을 조사했습니다. / ZrO2 인터페이스의 특성이 장치의 특성과 CHF3의 영향에 직접적인 영향을 미치기 때문에 시스템 MoS2에서 밴드 오프셋에 대한 플라즈마 처리 /ZrO2 인터페이스를 탐색했습니다.
실험에서 다층 MoS2 필름은 SiO2에서 성장되었습니다. MoO3를 사용하는 화학 기상 증착(CVD) 시스템에 의한 /Si 기판 및 Mo 소스 및 S 전구체로서 각각 황 분말. 성장 과정에서 Ar 가스는 캐리어 가스로 사용되었으며 성장 온도는 5분 동안 800°C였습니다. 그런 다음 MoS2 /ZrO2 샘플은 대면적 다층 MoS2를 전송하여 준비했습니다. ZrO2에 필름 /Si 기판은 PMMA(폴리 메틸 메타크릴레이트) 방법을 사용합니다. ZrO2 지르코늄 소스로 Tetrakis Dimethyl Amido Zirconium(TDMAZr) 전구체와 물(H2)을 사용하여 원자층 증착(BENEQ TFS-200) 시스템을 사용하여 200°C에서 Si에 산화물(15nm)을 증착했습니다. O) 산소 공급원으로. CHF3의 효과를 조사하기 위해 MoS2에서 밴드 정렬에 대한 처리 /ZrO2 인터페이스, 한 샘플의 경우 ZrO2 /Si 기판은 CHF3로 처리되었습니다. RF 전력이 약 20W이고 유속이 약 26sccm인 플라즈마. 한편, 플라즈마 처리 시간은 약 60초이며, 공정 중 압력은 1Pa로 유지하였다. 결과적으로 결과 F 선량은 약 2.0 × 10 14 입니다. 원자/cm 2 2차 이온 질량 분석법(SIMS) 측정에 의해 추정됩니다. 플라즈마 처리 시간의 최적화 과정에서 CHF3 플라즈마는 ZrO2에 확산된 불소를 도입하여 재료 품질을 심각하게 저하시켰습니다. 주로 시간이 70초로 설정되었을 때 플라즈마 처리 시간이 50초, 60초 미만인 경우 SIMS 결과는 산화물 표면에서 명백한 F 피크를 나타내지 않았습니다. 다른 샘플의 경우 CHF3 없음 플라즈마 처리를 시행했습니다. 샘플의 라만 특성은 실온에서 RENISHAW 시스템에서 취했습니다. X선 광전자 분광법(XPS)은 VG ESCALAB 220i-XL 시스템을 사용하여 측정되었습니다. 단색 Al Kα x선 소스의 광자 에너지는 약 1486.6eV입니다. 측정하는 동안 통과 에너지는 XPS 스펙트럼을 얻기 위해 20eV로 설정되었습니다. 또한 C 1 s 피크(284.8 eV)를 사용하여 샘플 표면 차동 대전 효과를 제거하기 위해 코어 수준의 결합 에너지를 수정했습니다.
as-grown 및 after-transferred 다층 MoS2의 라만 스펙트럼 그림 1과 같이 실온에서 특성화되었습니다. A로 표시된 두 가지 두드러진 라만 모드 1g 및 \( {\mathrm{E}}_{2g}^1 \)가 스펙트럼에서 관찰되었다. 구체적으로, \( {E}_{2g}^1 \) 모드는 낮은 주파수 영역에서 중심 Mo 원자에 대한 면내 S 원자의 반대 운동으로 인한 반면 A 1g 는 더 높은 주파수 영역에서 S 원자의 평면 외 진동에 상대적입니다[21]. \( {\mathrm{E}}_{2g}^1 \) 및 A 1g MoS2 모드 다른 층간 Van der Waals 복원력과 적층 구조 변화의 영향으로 인해 단층에서 벌크 샘플로 각각 적색 편이와 청색 이동을 겪습니다[21]. 따라서 A 1g 및 \( {\mathrm{E}}_{2g}^1 \) 모드는 종종 MoS2의 레이어 번호 또는 두께를 평가하는 데 사용됩니다. 영화. 여기서, 성장된 MoS2의 Δk는 필름은 약 25.32cm −1 입니다. , 필름이 6개 이상의 레이어임을 나타냅니다. 또한, Fig. 1의 삽입된 단면 투과전자현미경(TEM) 결과는 성장된 MoS2의 층 수를 보여주었다. 약 4.5nm의 두께에 해당하는 약 8이었습니다. 또한 MoS2의 라만 피크 위치 및 반치폭(FWHM) 전사 전과 후가 거의 동일하여 전사 과정이 재료의 품질에 약간의 영향을 미친다는 것을 나타냅니다.
<그림>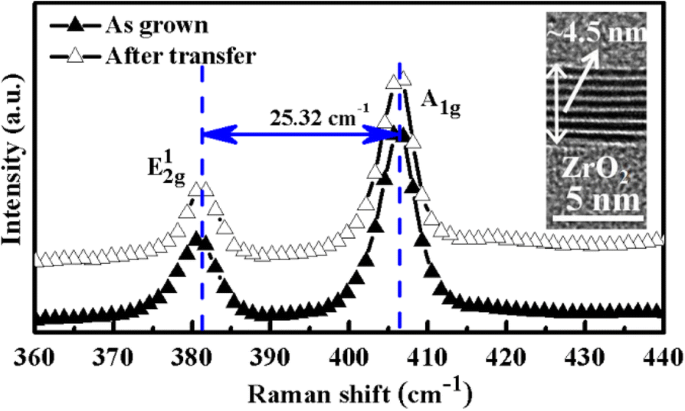
초박형 MoS2의 라만 분광법 필름 전송 전후. 삽입된 것은 MoS2의 단면 투과 전자 현미경(TEM) 이미지입니다. ZrO2에서 /Si 기판, MoS2 레이어를 보여줍니다.
XPS는 이종접합 인터페이스에서 대역 오프셋을 결정하는 효율적인 방법임이 충분히 입증되었습니다[22, 23]. MoS2에서 /ZrO2 이종 접합, VBO 값은 ZrO2의 가전자대 스펙트럼의 변화에서 얻었습니다. 노출된 산화물과 MoS2 사이 자료[24]. 그림 2a, b는 베어 ZrO2의 코어 레벨 및 가전자대 스펙트럼을 보여줍니다. 및 다층 MoS2 /ZrO2 , 각각. 기준선과 앞전의 기울기 사이의 절편은 페르미 준위를 기준 준위로 취하는 샘플의 VBM(가전자대 최대값)을 제공합니다. 결과는 ZrO2의 VBM이 및 다층 MoS2 /ZrO2 시스템은 각각 약 1.88eV 및 0.06eV입니다. 또한 베어 ZrO2의 Zr 3d 코어 레벨 스펙트럼 Zr 3d5/2라고 하는 잘 분리된 이중선 피크를 나타냅니다. 및 3d3/2 에너지 값은 각각 182.05eV 및 184.45eV이며 MoS2에 대한 해당 값 /ZrO2 샘플은 각각 182.10eV 및 184.50eV입니다. Zr 3d5/2의 코어 레벨 변경 또는 3d3/2 ~ 0.05eV는 측정 및 데이터 처리 오류 범위에 있습니다. 베어 ZrO2와 비교 샘플, 다층 MoS2 그림 2b와 같이 Zr 3d 스펙트럼에 거의 영향을 미치지 않았습니다. 그런 다음 Zr 3d5/2 간의 에너지 차이 VBM은 베어 ZrO2의 경우 180.17 eV 및 182.04 eV입니다. 샘플 및 MoS2 /ZrO2 각각 샘플. 결과적으로 multilayer-MoS2에 대한 VBO 값은 /ZrO2 인터페이스는 약 1.87 ± 0.05 eV이며, 주로 베어 ZrO2 간의 VBM 차이로 인해 발생합니다. 및 MoS2 /ZrO2 . 마찬가지로 다층 MoS2의 경우 /ZrO2 CHF3 샘플 MoS2 전 플라즈마 처리 전송에서 VBM은 그림 2c와 같이 약 0.02eV이며 CHF3가 없는 샘플과 거의 동일합니다. 치료. 그러나 Zr 3d 스펙트럼은 약 0.75eV, Zr 3d5/2 만큼 더 높은 에너지 쪽으로 이동합니다. ~ 182.85eV 및 3d3/2 ~185.25eV, VBO 값이 플라즈마 에칭 후 약 0.75 ± 0.04eV만큼 확대되었음을 나타냅니다. 그러면 CBO 값 ∆E C 공식에 따라 얻을 수 있습니다.
$$ \Delta {\mathrm{E}}_{\mathrm{C}}={E}_{G, ZrO2}-{E}_{G, MoS2}-\Delta {E}_V. $$ (1)여기서 E G , ZrO 2 및 E G , MoS 2 ZrO2의 밴드 갭 및 MoS2 , 각각 및 ∆E V VBO 값에 해당합니다. 일반적으로 산화물 절연체의 밴드갭 에너지는 O1의 손실 에너지 스펙트럼에서 구할 수 있다[25]. 그림 3a는 ZrO2의 O 1 손실 에너지 스펙트럼을 보여줍니다. 및 E G , ZrO 2 Zr-O 결합의 코어 레벨 에너지(530.39eV)에 맞는 선형 에지 기준선(535.95eV)을 외삽하여 에너지 차이에서 계산된 약 5.56eV입니다. MoS2의 밴드 갭 이 작업에서 약 1.2eV입니다. 따라서 CHF가 없는 샘플의 CBO 값3 처리는 CHF3가 있는 샘플의 경우 약 2.49eV 및 1.74eV입니다. 치료. 그런 다음 CHF3가 있거나 없는 샘플에 대한 밴드 엔지니어링의 도식적 구조 플라즈마 처리는 그림 3b에 나와 있습니다. 분명히, 다층 MoS2 /ZrO2 시스템은 MoS2에 제한된 전자와 정공을 용이하게 하는 유형 I 정렬을 가지고 있습니다. . 한편, 큰 ∆E C 및 ∆E V MoS2용 /ZrO2 인터페이스는 ZrO2를 의미합니다. n-채널 또는 p-채널 다층 MoS2에 좋은 게이트 유전체가 될 수 있습니다. 게이트 누설 전류 억제 측면에서 기반 FET 적용. 또한, 플라즈마 처리된 샘플은 VBO ∆E가 더 높습니다. V (낮은 CBO ∆E C ) 플라즈마 처리하지 않은 샘플과 비교하여 p-채널 FET의 적용에서 더 우수합니다.
<그림>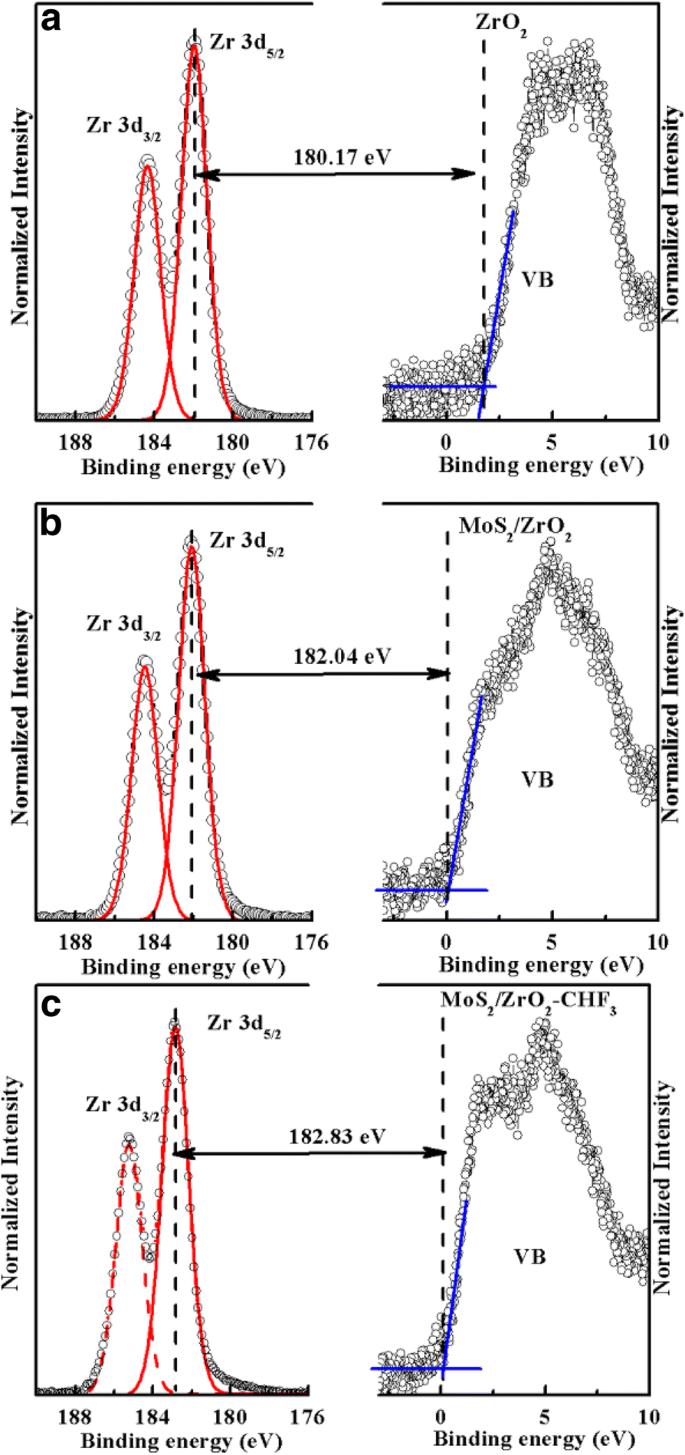
a에 대한 코어 레벨 Zr 3d 및 가전자대 스펙트럼 베어 ZrO2 산화물, b 다층-MoS2 /ZrO2 샘플 및 c CHF3 플라즈마 처리된 다층 MoS2 /ZrO2 샘플
<그림>
아 ZrO2에 대한 O 1 s 광전자 에너지 손실 스펙트럼 산화물. ㄴ MoS2에서 에너지 밴드 정렬의 개략적인 구조 /ZrO2 인터페이스 미포함(상단) 및 포함(하단) CHF3 플라즈마 처리. ㄷ CHF3가 있는 샘플의 SIMS 깊이 프로파일(Si, Zr 및 F) 플라즈마 처리
다층 MoS2에서 밴드 정렬의 변화 /ZrO2 계면은 CHF3에 의해 유도된 F가 풍부한 계면층과 밀접한 관련이 있는 것으로 믿어집니다. 플라즈마 처리. 그림 3c는 Zr, F 및 Si 원소에 대한 플라즈마 처리된 샘플의 SIMS 결과를 표시하며 계면에서 명백한 F 이온 피크를 나타냅니다. 한편, 일부 F 이온은 기본 ZrO2로 확산되었습니다. 크기가 작기 때문에 레이어. MoS2에서 /ZrO2 CHF3와의 인터페이스 플라즈마 처리에서 VBO의 확대(CBO의 감소)는 주로 그림 2c에 표시된 Zr 3d 코어 수준의 상향 이동에 기인하며, 이는 F 이온이 Zr 원자와 강한 상호 작용을 한다는 것을 나타냅니다. 그런 다음 CHF3의 효과 ZrO2의 전자적 특성에 대한 처리 산화물은 밀도 기능 이론(DFT)을 기반으로 하는 케임브리지 순차 총 에너지 패키지(CASTEP)와 결합된 Material Studio를 사용하여 조사되었습니다[26]. Perdew-Burk-Ernzerhof(PBE)[27]가 제안한 교환 및 상관 전위에 대한 일반화된 기울기 근사는 프로젝터 PAW(증강파 전위)[28]와 함께 이온-전자 상호 작용을 처리하는 데 사용되었습니다. 평면파 차단 에너지는 750eV로 선택되고 1 × 1 × 1의 Monkhorst-Pack k-mesh는 구조 최적화 및 총 에너지 계산에서 Brillouin 영역을 샘플링하는 데 사용됩니다[29]. 최적화 동안 총 에너지 변화가 최종적으로 10 −6 미만으로 수렴될 때까지 모든 원자는 평형 위치로 이완되었습니다. eV/ 원자에서 각 원자의 힘과 응력은 각각 0.003 eV/nm 및 0.05 GPa로 수렴되었고 변위는 1 × 10 −4 으로 수렴되었습니다. nm. 그림 4a, b는 두 MoS2에 대한 전체 및 부분 상태 밀도(DOS)를 보여줍니다. /ZrO2 여기서 0 eV는 페르미 레벨에 해당합니다. 분명히, F 이온은 Zr 원자와 강한 상호작용을 하여 원자가띠로 투영되는 Zr 원자의 d-오비탈의 일부를 페르미 준위 아래 - 0.06에서 - 0.82eV 아래로 약 0.76eV 아래로 이동합니다. 이는 다음과 일치합니다. 가전자대 오프셋의 확대 ∆E V ~ 0.75eV. F 원자는 큰 전기 음성도(4.0)로 인해 전자를 끌어당기는 경향이 있으며 부분적으로 음전하를 띤 다음 Zr 원자와 쌍극자를 더 형성하여 결국 밴드 오프셋의 변화에 기여합니다. 따라서 MoS2에서 밴드 변경 /ZrO2 CHF3에 의해 도입된 인터페이스 플라즈마 처리는 이종 접합에서 밴드 정렬을 조정하는 유망한 방법을 제공하여 관련 장치의 설계를 용이하게 합니다.
<그림>
CHF가 없는 샘플에 대해 계산된 총 상태 밀도(TDOS) 및 부분 상태 밀도(PDOS)3 치료(a ) 및 CHF3 치료(b )
이 논문에서 우리는 다층 MoS2에서 에너지 밴드 엔지니어링을 탐구했습니다. /ZrO2 인터페이스 및 CHF3의 효과 조사 X선 광전자 분광법을 이용한 치료. 결과는 유형 I 정렬이 MoS2에서 형성되었음을 보여주었습니다. /ZrO2 CBO 및 VBO와의 이종 접합 인터페이스는 각각 약 2.49eV 및 1.87eV입니다. CHF3 동안 플라즈마 처리는 주로 계산 결과와 일치하는 Zr 3d 코어 레벨 에너지의 상향 이동으로 인해 VBO를 약 0.75 ± 0.04 eV 증가시킵니다. 이 작업은 높은 κ ZrO2의 큰 잠재적 응용을 증명합니다. 다층 MoS2의 산화물 기반 장치이며 인터페이스 에너지 밴드 정렬을 수정하는 가능한 방법을 제공합니다.
2차원
캠브리지 순차 총 에너지 패키지
전도대 오프셋
화학 기상 증착
밀도 함수 이론
상태 밀도
전계 효과 트랜지스터
최대 절반에서 전체 너비
이황화 몰리브덴
프로젝터 증강파
Perdew-Burk-Ernzerhof
폴리 메틸 메타크릴레이트
2차 이온 질량 분석기
Tetrakis 디메틸 아미도 지르코늄
투과전자현미경
전이금속 디칼코게나이드
가전자대 오프셋
X선 광전자 분광법
이산화지르코늄
나노물질
초록 웨어러블 전자 장치의 인기가 높아짐에 따라 유연한 에너지 변환 시스템이 빠르게 개발되었습니다. 이론적인 에너지 밀도가 높은 플렉서블 징크-에어 배터리(ZAB)는 웨어러블 전자 제품에 적용할 수 있는 차세대 플렉서블 에너지 장치로서 상당한 잠재력을 보여줍니다. 산소 환원 반응(ORR)과 산소 발생 반응(OER) 모두를 전기화학적으로 촉매할 수 있는 고효율 및 공기 안정 음극의 설계는 매우 바람직하지만 도전적입니다. ORR/OER 촉매 작용을 위한 유연한 탄소 기반 촉매는 크게 두 가지 유형으로 분류될 수 있습니다. (ii) 가
열전 발전기의 측면 섹션 출처:Wikimedia Commons 요즘 전 세계적으로 많은 사람들이 그린 에너지 하베스팅을 받아들이고 있습니다. 왜요? 단순한! 환경에서 낭비되거나 다른 에너지원에서 전기를 제공합니다. 흥미롭게도 시스템은 배터리나 그리드 연결 없이 이 모든 작업을 수행합니다. 일부 에너지 및 열원에는 열, 태양 및 무선 주파수가 포함됩니다. 즉, 열전 에너지 수확 기술은 녹색 범주에 속하는 에너지 원입니다. 그리고 Seebeck 효과를 사용하여 온도 구배를 전력으로 변경합니다. 그렇다면 강력하고 안정적인 에너지