나노물질








반도체에서 합금 원자의 분포는 종종 재료의 특성에 상당한 영향을 미칠 수 있는 무작위 분포에서 벗어납니다. 이 연구에서 주사 투과 전자 현미경 기술은 여러 MBE 성장 GaAs에서 Bi의 분포를 분석하기 위해 사용됩니다.1−x Bix 합금. 원자 분해능 HAADF 이미지의 통계적 정량화와 수치 시뮬레이션은 원자적으로 갑작스러운 (001) GaAs-GaAsBi 인터페이스 및 CuPt 유형 순서의 시작에서 Bi 함유 열의 대비를 해석하는 데 사용됩니다. 단색 EELS 매핑을 사용하여 상 분리 도메인을 나타내는 샘플에서 벌크 플라즈몬 에너지 적색 편이를 검사합니다. 이것은 로컬 GaAsBi 단위 셀 부피 팽창을 조사하고 표준 X선 기반 격자 변형 측정을 보완하는 간단한 방법을 제안합니다. 또한 오프컷 기판에서 성장한 단일 변형 CuPt 정렬 GaAsBi 샘플은 원자 규모 구성 EDX 매핑으로 특성화되고 차수 매개변수가 추정됩니다. 마지막으로, 수직 Bi 조성 변조를 갖는 GaAsBi 합금은 낮은 기판 회전율을 사용하여 합성됩니다. 원자적으로 분해된 EDX 및 HAADF 이미징은 일반적인 CuPt 유형 정렬이 3개의 격자 상수 주기로 [001] 성장 축을 따라 추가로 변조됨을 보여줍니다. 이 독특한 GaAsBi 샘플은 이 합금에서 달성할 수 있는 다양한 Bi 분포를 예시하여 Bi 원자의 통합 메커니즘과 Bi 함유 III-V 반도체를 추가로 개발하는 방법에 대한 정보를 제공합니다.
비스마이드 GaAs1−x Bix 합금은 광범위한 연구를 경험했으며 비스무트를 함유한 III-V족 반도체의 신흥 클래스를 나타냅니다[1]. 비스무트(Bismuth)는 가장 큰 안정하고 독성이 없는 원소로, 결합 시 큰 GaAs 밴드 갭 감소를 생성합니다. 그룹 V 부격자에서 Bi를 대체하면 적당한 격자 변형으로 GaAsBi에서 90 meV/Bi%만큼 밴드 갭 휘어짐을 달성할 수 있습니다[1,2,3]. 큰 스핀-궤도 밴드 분할은 격자에서 Bi 통합의 또 다른 주목할만한 효과입니다. 이를 통해 GaAs1−x에서 원자가 밴드 간 흡수 및 Auger-Meitner 재결합을 억제할 수 있습니다. Bix 농도 x> 10% [4]. 감소된 밴드 갭 감도와 결합된 이러한 특성은 장파 적외선 레이저, 광검출기 및 다중접합 태양 전지 등의 응용 분야에서 비스미드를 매력적인 후보로 만듭니다[1, 5,6,7].
Bi 원자가 전형적인 GaAs 성장 온도에서 탈착되는 경향이 있기 때문에 GaAs 매트릭스에 Bi를 통합하려면 비전통적인 성장 조건이 필요합니다[8,9,10]. 일반적으로 400 °C 미만의 기판 온도와 거의 화학양론적 그룹 III/V 비율이 필요합니다. 이러한 조건 근처에서 쉽게 발생할 수 있고 성장하는 층 두께 및 그 조성의 불균일성과 관련된 표면 Ga 또는 Bi 액적의 형성을 피하기 위해 주의해야 합니다[11,12,13,14]. 금속-유기 기상-에피택시를 사용하여 발전이 이루어지긴 했지만 더 높은 농도의 Bi를 통합하는 데 필요한 저온은 분자빔 에피택시(MBE)를 선호하는 합성 방법으로 만듭니다[15,16,17]. GaAsBi 합금은 여전히 이러한 낮은 성장 온도에서 놀라울 정도로 높은 광발광(PL) 강도를 나타내며, 이는 Bi 계면활성제 효과와 저온 GaAs에서 일반적으로 형성되는 As 관련 점 결함의 밀도 감소에 기인합니다[18, 19]. 원자가 밴드(VB) 교차 방지 그림에서 통합된 개별 Bi 원자는 확장된 GaAs VB 아래에서 공진 상태를 생성하여 광학 밴드 갭 감소를 유발합니다[2, 20, 21]. 제1 원리 계산은 또한 인접한 Bi 원자로 구성된 클러스터가 고립된 Bi 원자보다 훨씬 더 크게 좁아지는 밴드 갭을 생성할 수 있음을 보여줍니다[22]. 이러한 다양한 Bi 구성은 강력한 VB 섭동을 생성하고 국부적인 전자 결함 상태를 유발할 수 있습니다. 연구에 따르면 큰 Bi 원자에 의해 생성된 격자 변형으로 인해 클러스터가 빈자리 VGa에 결합할 가능성이 더 높아집니다. 및 VAs [23]. As-rich 성장 조건은 BiGa 형성에 유리해야 합니다. GaAsBi에서 깊은 구멍 트랩을 유발할 것으로 예상되는 이종 안티사이트 결함[23, 24]. 발음된 여기자 국지화 효과는 일반적으로 GaAsBi 합금의 온도 의존성 PL에서 관찰되며 이러한 Bi 관련 클러스터 및 결함 복합체에 기인합니다[25, 26].
다른 많은 삼원 III-V 반도체 합금과 마찬가지로 GaAsBi는 자발적인 정렬 경향을 보입니다[27]. 소위 CuPtB - B형 평면에서 두 번째 B형 평면에서 Bi 원자의 농도가 변조되는 유형 정렬은 고해상도(주사) 투과 전자 현미경(STEM/TEM)을 사용하여 관찰되었습니다[13, 17, 28]. CuPtB III-V 합금의 유형 변조는 표면 재구성 역학에 의해 구동되며 표면 이량체 행으로 구성된 (2 × 1) 재구성이 수반됩니다[27, 29,30,31,32,33]. 평평한 (001) GaAs 기판에 증착되면 4개의 고유한 평면 세트 중 2개에서 정렬이 발생합니다. 인접 기질을 활용하여 단일 B형 순서 하위 변이를 추가로 선택할 수 있습니다. 실제로 최근 연구에서는 이것이 GaAsBi에도 적용되는 것으로 나타났으며, 이에 따라 큰 CuPtB -유형 도메인은 낮은 각도의 오프컷 웨이퍼를 사용하여 단일 세트의 B 평면에서 달성되었습니다[34]. GaInP2의 CuPt 유형 순서 지정 이 합금에서 큰 차수 매개변수를 가진 고품질 결정을 얻을 수 있기 때문에 아마도 가장 많이 연구되었을 것입니다. 장거리 주문은 사면체 Td에서 아연 혼합 점 그룹 대칭을 변경합니다. 삼각 C3v로 [35, 36]. 대칭 감소로 인한 주목할만한 효과에는 밴드 갭 협소화, 광발광의 편광, 복굴절 및 이방성 변형이 포함됩니다[37,38,39]. 이러한 효과의 크기는 장거리 차수 매개변수 η에 따라 다릅니다. , 이는 정렬된 격자 평면 사이의 원소 분포의 정도를 나타냅니다. CuPtB에서 -순서 AB1−x Cx 합금(x용 <=0.5), 격자는 B 요소가 풍부한 AB1−(x−η /2) Cx−η /2 및 C가 풍부한 AB1-(x + η /2) Cx + η /2 <111>B 방향을 따라 단층. 주문 매개변수 η =농도가 x인 완전히 정렬된 합금인 동안 무작위 합금에서 0 따라서 η입니다. =2x .
분명히, 이러한 정렬된 합금 내 Bi의 분포는 무작위 합금과 다르며, 이는 합금 특성을 추가로 추론할 때 고려되어야 합니다[17, 40]. 묽은 GaAsBi 합금에서 CuPt 정렬 효과에 대한 이해는 아직 초기 단계이므로 보다 체계적인 연구가 필요합니다. 이 기사에서는 고급 수차 보정 STEM 방법을 사용하여 뚜렷하게 성장한 여러 GaAsBi 합금의 Bi 분포 모드를 분석합니다. 분석은 통계적 STEM Z-콘트라스트 이미지 처리 및 이미지 시뮬레이션뿐만 아니라 원자 분해 X선 에너지 분산 분광법(EDX)을 사용하여 수행됩니다. 단색 전자 에너지 손실 분광법(EELS)은 벌크 플라즈몬 에너지 이동을 사용하여 GaAsBi의 국소 단위 세포 부피 변화를 조사하는 데 사용됩니다.
최초의 GaAs1−x Bix 여기에 제시된 샘플 S1은 도핑된 GaAs 층과 고유한 420 nm 비스미드가 있는 p-i-n 헤테로 다이오드입니다. 샘플의 비스무트 농도는 X선 회절(여기에는 표시되지 않음) 및 실온 PL을 사용하여 4.5% Bi로 결정되었으며, 이는 1.10 eV 밴드 갭을 나타냅니다(SI 그림 S1). PL 대역 에지 측정은 참조 [1, 2, 4]를 사용하여 Bi%로 변환됩니다. GaAs-GaAsBi 인터페이스 근처의 [110] 영역 축을 따른 단면 원자 해상도 HAADF STEM 이미지가 그림 1a에 나와 있습니다. 성장 축 및 기타 관련 결정학적 방향은 도 1b에 표시되어 있고 도 1a에도 적용된다. 무거운 Bi 원자는 Ga 또는 As 원자보다 훨씬 강한 높은 각도로 프로브 전자를 산란시키기 때문에 내부 수집 각도(여기서는 90mrad)가 큰 HAADF 검출기는 얇은 샘플에서 Bi 분포를 유리하게 강조합니다. <110> 방향을 따라 본 결정은 성장 [001] 축에 평행하게 배향된 원자 "덤벨"의 집합체로 나타납니다. Ga(31)와 As(33)는 원자 번호(Z)가 비슷하기 때문에 HAADF 이미지만 보면 쉽게 구별할 수 없습니다. 그러나 Bi 함유 그룹 V 열은 눈에 띄게 더 높은 대비를 보여줍니다. 그림 1a와 인터페이스 근처의 확대 영역에서 볼 수 있듯이 그룹 V 열은 Ga 열 위의 덤벨 상단 절반에 위치합니다. 이는 [110] 영역 축을 따라 GaAsBi를 이미징할 때 예상됩니다. 샘플을 직교 [\( \overline{1} \)10] 방향을 따라 볼 때 그룹 V/III 덤벨의 극성이 반대입니다. 이러한 평면 내 직교 방향은 CuPt 유형 정렬이 B 유형 평면에서 발생하므로 [110] 영역 축을 따라 이미징해야 볼 수 있기 때문에 구별할 수도 있습니다. 그림 1b는 CuPtB가 뚜렷한 필름 내부의 더 낮은 배율의 HAADF 이미지를 보여줍니다. - 유형 주문. 정렬된 도메인은 B 평면의 두 세트, 즉 (\( \overline{1} \)11) 및 (1\( \overline{1} \)1) 사이에서 무작위로 교대로 나타납니다. 이를 B+라고 합니다. 그리고 B- 관례에 따른 하위 변형. 이미지의 푸리에 변환은 왼쪽 상단 삽입에 표시됩니다. 4개의 주요 브래그 반점은 [111]* 유형이고 4개의 1/2[111]* 유형 초격자 반점은 CuPtB를 나타냅니다. B 평면의 두 세트에서 비슷한 크기로 정렬됩니다. 상 분리된 GaAsBi 영역은 그림 1b에서 아래쪽 이미지 부분에서 더 어두운 줄무늬로 볼 수 있습니다. 이 도메인은 Bi-deficient GaAs와 유사하기 때문에 비스마이드보다 어둡게 나타납니다. GaAsBi 합금의 준안정성으로 인해 스피노달 분해 및 상 분리가 많은 논문에서 보고되었습니다[11,12,13,14, 41, 42]. B+를 보다 명확하게 표현하려면 그리고 B- 하위 변형 순서, Fig. 도 1c, d는 1/2[111]* 초격자 반사 쌍을 사용하여 이미지를 형성하여 표시됩니다. 상호 공간의 각 초격자 쌍에 마스크가 적용되고 역 푸리에가 다시 실제 공간으로 변환됩니다. 이 이미지에서 (111) 평면의 더 밝은 영역은 순서가 더 뚜렷함을 나타냅니다. 즉, 순서 매개변수가 국부적으로 변하고 있음을 나타냅니다. 또한 집속된 이온 빔에 의한 샘플 준비로 인해 TEM 샘플 표면 두께 변화가 있습니다. 샘플 준비는 표면에 비정질 표면층과 용융된 Ga 원자 덩어리를 남길 수 있어 약한 이미지 강도 변조를 유발할 수 있습니다. 그러나 Ga는 Bi 원자보다 높은 각도에서 훨씬 약하게 산란되며 Bi 분포 분석에 큰 영향을 미치지 않습니다. 그림 1d의 화살표는 역위상 경계가 정렬된 영역을 보여줍니다. 이러한 경계를 넘어 B+ (B- ) 도메인은 모든 Bi-rich 평면을 As-rich 평면으로 전환하여 위상을 변경합니다. 정렬 역위상 경계는 전위의 활주 또는 B+ 간의 무작위 교대로 인해 형성될 수 있습니다. 그리고 B- 성장하는 동안 도메인 [43]. 후자가 여기에 해당하는 것으로 보입니다.
<그림>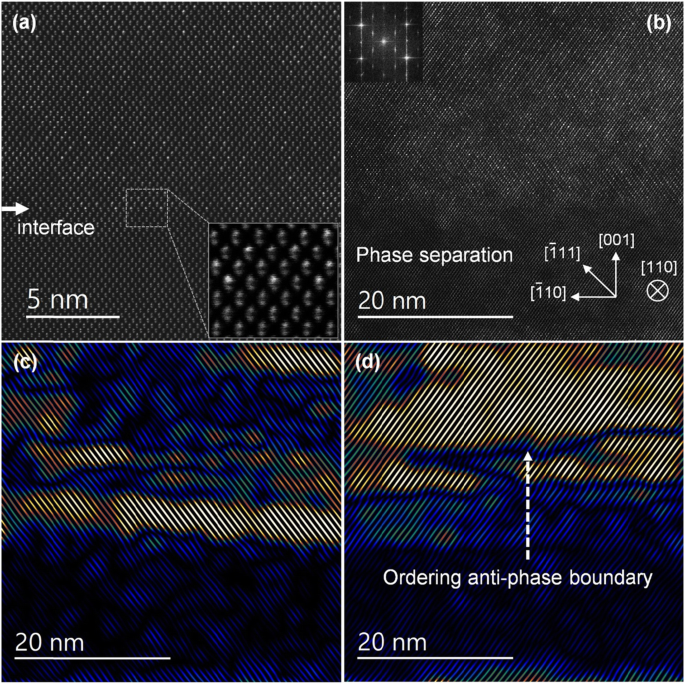
아 샘플 S1 GaAs-GaAsBi 인터페이스 영역의 단면 HAADF 이미지. 인터페이스의 확대된 삽입이 오른쪽 하단에 표시됩니다. 결정학적 방향은 그림 1b와 같다. ㄴ 인터페이스에서 떨어진 샘플의 HAADF 이미지. 길쭉한 자발적으로 상 분리 된 GaAs와 같은 도메인이 중간에 보입니다. 삽입은 이미지의 푸리에 변환을 보여줍니다. ㄷ (b에서 형성된 이미지 ) 1/2[\( \overline{1} \)11]* 쌍의 초격자 반사를 사용합니다. 더 밝은 색상은 더 뚜렷한 순서를 나타냅니다. d (b에서 형성된 이미지 ) ½[1\( \overline{1} \)1]*반사
쌍 사용그림 1a에 표시된 HAADF 이미지의 정량화는 원자 기둥 산란 단면(SCS)의 공간 분포를 고려하여 다음으로 수행됩니다(방법 참조). StatSTEM 알고리즘은 2차원 가우시안으로 열을 맞추는 데 사용되며 주어진 열의 SCS는 해당 가우시안 아래의 부피로 정의됩니다[44, 45]. 이것은 실험 이미지에서 열 강도의 직접 통합과 반대되는 매개변수 모델 기반 정량화입니다. <110> GaAsBi와 같이 열 강도가 겹치는 경향이 있는 경우 매개변수 모델 접근 방식이 더 안정적일 수 있습니다. 정량화된 그림 1a의 SCS 분포는 5개의 가우시안으로 잠정적으로 맞는 그림 2b의 히스토그램으로 표시됩니다. 그런 다음 SCS의 공간 분포는 각 열에 배치된 동일한 색 구성표 사각형을 사용하여 가우시안 중첩으로 구성된 모델 구조에 대해 그림 2a에 표시됩니다. Ga 및 As 열의 SCS는 강하게 중첩되어 히스토그램에서 주요 피크를 생성합니다. 이것은 이러한 원자의 유사한 Z-숫자와 실험적으로 도입된 추가 확장 때문입니다(방법 참조). 이 주요 피크 내에서 아래쪽 가우시안 성분(진한 파란색) 또는 위쪽(밝은 파란색)을 플로팅하면 덤벨 극성에서 검사할 수 있는 것처럼 GaAs 버퍼 레이어의 As 열의 ~ 60%가 올바르게 식별됩니다. . 비교를 위해 하단 GaAs 버퍼 층의 SCS 정량화는 보충 그림 S2에 나와 있습니다. 이는 시야에서 Ga 및 As 열을 더 잘 구별하기 위해 현재 2개 이상의 가우시안이 필요하며 평균 SCS가 10%만큼 차이가 난다는 것을 나타냅니다. 이 차이는 아래에 표시된 시뮬레이션과 Beyer et al.에서 발견된 결과와 일치합니다. [17], 여기서 GaAsBi의 Ga 및 As 통합 열 강도 분포가 해결되었습니다. 강하게 산란하는 Bi 원자의 존재는 SCS를 ~ 5.5 × 10 5 이상의 값으로 확장합니다. e - Å 2 (SI 그림 S2 참조), 이는 그림 2b의 오른쪽 어깨를 발생시킵니다. Bi 함량이 더 높은 열을 잠정적으로 구별하기 위해 3개의 가우시안이 장착되어 있습니다. 원자적으로 급격한 GaAs-GaAsBi 인터페이스는 그림 2a에서 볼 수 있습니다. 자세히 살펴보면 상당한 수의 Bi 원자를 포함하는 기둥의 첫 번째 그룹 V(001) 층이 인터페이스를 따라 매 두 번째 덤벨에 배열되어 있음을 보여줍니다. 이것은 에피택셜 성장 초기에 CuPt 유형 정렬의 시작을 시사합니다. 인터페이스 원자 구성의 묘사는 그림 2b의 삽입에 나와 있습니다. 첫 번째 group-V(001) 평면을 따라 두 번째 열마다 Bi 원자(주황색)와 계면을 따라 원자 배열을 재현합니다. 그림 2a의 첫 번째 ~ 4–5(001) 원자 평면은 CuPt B+에 대한 경향이 없음을 보여줍니다. 또는 B- 하위 변이. 보다 확연한 단일 변형 순서는 ~ 6번째(001) V족 원자층에서 나온 다음 다른 하위 변형으로 전환됩니다. 안티사이트 결함이 없음 BiGa 인터페이스에서 SCS 분포로 표시되며, Bi와 관련된 색상이 있는 III족 열에 사각형으로 표시됩니다. 여러 BiGa의 가능성 그러나 안티사이트는 그림의 오른쪽 상단 모서리에 있습니다. 그룹 III 및 그룹 V 열 모두 해당 영역의 단일 덤벨에 Bi-like SCS를 표시하며, 이는 결함 쌍 BiGa의 존재를 나타낼 수도 있습니다. -Bi로 . SCS를 결정하는 데 관련된 Bi 원자의 수에 대한 더 나은 아이디어를 얻으려면 명목상 20–25nm 두께의 샘플에서 <110> 컬럼에 50–60개의 원자가 있다는 점에 유의하십시오. 따라서 현재 4.5% Bi가 포함된 무작위 합금의 경우 2-3개의 Bi 원자가 V족 열에서 가장 많이 발견될 가능성이 높습니다. 이 숫자는 정렬된 Bi-rich 평면에서 더 높을 것이며, 아마도 가장 큰 SCS가 있는 열에서 최대 6-7에 도달할 것입니다[40]. StatSTEM 분석을 보완하기 위해 다중 슬라이스 HAADF 이미지 시뮬레이션이 모델 GaAsBi <110> 슈퍼셀 구조에 대해 다음에 제시됩니다(자세한 내용은 방법 참조).
<그림>
아 그림 1a의 SCS 분포. 각 원자 열의 색이 지정된 사각형은 그림 2b의 SCS 색 구성표를 따릅니다. ㄴ 그림 1a의 SCS 히스토그램은 5개의 가우시안을 사용합니다. 삽입은 인터페이스 영역의 묘사를 보여줍니다. Ga 원자 열은 진한 파란색, As - 밝은 파란색, Bi를 포함하는 열은 주황색입니다. ㄷ 그림 2d에 표시된 GaAsBi 구조의 시뮬레이션된 HAADF 이미지. 컬럼에 있는 Bi 원자의 수는 각 V족 컬럼의 오른쪽에 주황색으로 괄호 안에 표시됩니다. 피팅된 SCS 값은 각 열의 왼쪽에 표시되며 슈퍼셀에서 가장 큰 SCS 값으로 정규화됩니다. d 모델 GaAsBi <110> 구조는 Bi 위치(주황색), 밝은 파란색-As, 진한 파란색-Ga 원자를 강조 표시하기 위해 옆으로 회전했습니다. 화살표는 입사빔 방향을 나타냅니다.
다양한 샘플 깊이에서 Bi 원자의 HAADF 이미지 강도에 대한 기여는 채널링으로 느슨하게 지칭되는 것으로 인해 비선형일 수 있습니다[46,47,48,49]. 따라서 원자 규모에서 도펀트의 정량화는 조성의 실제 변동을 도펀트 구성의 변동과 구별할 때 고려가 필요합니다[50, 51]. 채널링 동작을 설명하기 위해 <110> GaAs의 As 열 위에 배치될 때 샘플 깊이에 따른 평균 프로브 강도 변화가 수치적으로 시뮬레이션되고 보충 그림 S3에 표시됩니다(방법 참조). HAADF 시뮬레이션에 사용된 17 nm 두께의 모델 GaAsBi 구조는 옆으로 회전되어 As 열(As-밝은 파란색, Ga-진한 파란색) 내 Bi 원자(주황색)의 위치를 강조 표시하기 위해 그림 2d에 나와 있습니다. 화살표는 입사빔 방향을 표시합니다. 그림 2c에 표시된 시뮬레이션 이미지는 실험과의 비교를 위해 StatSTEM 알고리즘을 사용하여 적합합니다. 얻어진 SCS 값은 가장 큰 SCS(6개의 Bi 원자)를 갖는 컬럼의 SCS 값으로 정규화되었고 2개의 유효 숫자로 반올림되었습니다. 이러한 정규화된 값은 각 열의 왼쪽에 표시됩니다. 각 V족 열에 있는 Bi 원자의 수는 열 오른쪽에 괄호 안에 표시됩니다. 이전 연구 결과와 합리적으로 일치하여 As 및 Ga SCS 값의 차이는 ~ 8%로 나타났습니다. 순수한 As 컬럼과 하나의 Bi 원자를 포함하는 As 컬럼 사이의 SCS 차이는 위치가 다른 Bi 원자의 경우 2-4% 범위입니다. 거의 동일한 SCS 값을 제공하는 4개 및 5개 원자 또는 5개 및 6개 원자와 같이 다양한 구성에 대해 서로 다른 Bi 구성이 잘못 해석될 수 있음을 분명히 알 수 있습니다. 바닥 표면을 향한 기둥의 Bi 원자는 SCS에 점점 더 적게 기여합니다. 여기에서 차례로 조사된 2개의 Bi 원자를 갖는 여러 구성이 SCS 값에 큰 기여를 하는 것으로 보입니다. [110] 열을 따라 2개의 Bi 원자 구성은 실제로 CuPtB GaAsBi 합금의 주문은 실제로 C3v 구조 단위를 생성합니다. 점군 대칭, 즉 가장 가까운 이웃인 1 As 및 3 Bi 원자를 갖는 Ga 원자. 동일한 Ga 열은 최대 ~ 0.02까지 SCS의 변화를 나타냅니다. 이것은 인접 환경, 예를 들어 근처의 강하게 산란하는 기둥이 다중 산란으로 인해 또는 확장된 프로브 꼬리를 통해 결합함으로써 추가 강도에 기여함을 시사합니다[52]. 최근에 도입된 더 나은 스케일링 알고리즘은 양자 역학 다중 슬라이스 계산의 속도를 높이고 앞서 언급한 효과를 더 자세히 탐색할 수 있는 가능성을 열어줍니다[53, 54].
샘플 S1의 STEM 분석을 결론짓기 위해 전자 에너지 손실 분광법(EELS)을 사용하여 벌크 플라즈몬 에너지를 매핑합니다. 플라즈몬 에너지 이동은 다음에 논의되는 바와 같이 단위 셀 부피 변화 및 이에 따른 합금 변형과 관련될 것입니다. GaAs는 ~ 16 eV에서 하나의 주요 플라즈몬 피크를 나타내며, 예를 들어 CdTe와 달리 대역 간 전이에서 복잡한 간섭 특성을 나타내지 않습니다[55]. 측정된 플라즈몬 에너지 변화를 해석하기 위한 첫 번째 근사값으로 우리는 자유 전자 가스에 대한 Drude-Lorenz 모델을 사용합니다. 여기서 자유 전자는 이제 반도체의 원자가 전자입니다[56]. 이 모델의 벌크 플라즈몬 에너지는 \( {E}_p=\hslash {\left(N{e}^2/ Vm{\epsilon}_0\right)}^{1/2} \)로 표시됩니다. 아니 단위 셀의 원자가 전자 수, e 전자 전하, V 단위 셀 부피, m 는 전자 질량, 그리고 ε 0 자유 공간의 유전율입니다. 간단한 Drude-Lorenz 모델은 일반적으로 반도체에서 몇 퍼센트 이내의 플라즈몬 에너지를 예측하며 더 나은 일치를 찾으면 밴드 구조 효과에 대해 수정해야 합니다[56]. InGaAs 및 III족 질화물 반도체 합금에서 볼 수 있듯이 단위 셀 부피의 변화는 플라즈몬 에너지 이동을 결정하는 주요 양입니다[57, 58]. 유사하게, GaAs 매트릭스에서 등전자 Bi 원자의 치환은 주로 단위 셀 부피, V를 확장하는 역할을 합니다. , 따라서 플라즈몬 에너지를 적색 편이합니다. 다음에서는 측정된 GaAs 및 GaAsBi 피크 에너지를 사용하여 단위 셀 부피의 비율을 통해 GaAsBi 층의 국부 변형 상태 변화를 추론합니다.
HAADF 이미지 그림 3에 표시된 위상 분리된 GaAsBi 도메인을 포함하는 영역이 선택됩니다. EELS 스펙트럼은 동시에 획득된 HAADF 이미지를 수반하는 각 픽셀에서 수집되었습니다(원시 스펙트럼은 방법 및 SI 그림 S4 참조). HAADF 이미지의 점선은 고유 GaAsBi와 p형(하단) 및 n형(상단) GaAs 층 사이의 인터페이스를 나타냅니다. 인터페이스 경계선은 더 낮은 배율 STEM 이미지(여기에는 표시되지 않음)에서 결정되었습니다. 보호 Pt 층은 상부 n-GaAs 위의 고대비 물질로 볼 수 있습니다. GaAs 레이어와 GaAsBi 내의 위상 분리 도메인은 HAADF 이미지에서 더 어둡게 나타납니다. 오른쪽 EELS 그림의 수직선 프로파일은 모든 EELS 데이터 포인트를 수평으로 비닝하여 획득했습니다. 상대적인 벌크 플라즈몬 피크 에너지 이동, EGaAsBi를 보여줍니다. -EGaAs , 바닥 p-GaAs 버퍼 층 내의 GaAs 플라즈몬 에너지(16.23 eV로 측정됨)를 기준으로 합니다. 플라스몬 피크는 GaAsBi 층에서 더 낮은 에너지로 평균 0.08 eV 이동하는 것으로 보입니다. ~ 0.01 eV 내의 작은 변화는 정량화 노이즈 레벨에 있습니다. 상단 GaAs(얇은 층) 및 하단(2개의 교차 도메인) 근처의 상 분리 도메인은 GaAs 플라즈몬 에너지 값으로 돌아가며, 이는 무시할 수 있는 Bi 농도를 포함하고 있음을 나타냅니다. GaAs 층의 도펀트 농도(차수 10 17 cm −3 ) N에 비해 중요하지 않음 /V 플라즈몬 에너지에 영향을 주어서는 안됩니다. 이제 우리는 GaAs1−x에 대한 두 가지 제한적인 경우를 고려합니다. Bix 단위 셀 부피 V; 하나는 격자가 완전히 이완되고 다른 하나는 GaAs 기판에 완전히 변형됩니다. 완전히 이완된 경우 단위 셀은 격자 상수가 a인 입방체입니다. x에서 ≈ 5.684 Å =4.5% Bi[1]. 플라즈몬 에너지와 V 사이의 위의 제곱근 관계를 사용하여 , GaAs에 대한 에너지 이동은 \( \Delta {E}_p^{GaAs Bi}=16.23\left({\left({V}_{GaAs}/{V}_{GaAs Bi}\right) }^{1/2}-1\right)=-0.132\mathrm{eV} \), 이것은 측정된 것보다 분명히 더 큽니다. GaAsBi 합금의 이완 경향을 기반으로, 우리는 이 420 nm 두께 필름에서 격자의 ~30%가 이완된 것으로 추정합니다. 이는 상부 n-GaAs 층을 성장시키는 동안 짧은 열 어닐링도 경험했다는 점을 고려할 때입니다. 따라서 평균 GaAsBi 단위 셀은 완전히 완화된 시나리오에서 과대평가되고 위에서 얻은 더 큰 \( \Delta {E}_p^{GaAsBi} \)를 설명합니다. 다른 한계에서 비스마이드 격자는 GaAs(a =5.653 Å). − 0.080 eV 에너지 이동을 검색하는 데 필요한 평면 외 격자 상수는 a z =5.709 Å. 이것은 현명한 a z GaAs 기판에 압축 변형된 GaAsBi의 XRD-RSM 측정값과 비교할 수 있습니다[1, 34, 59]. 이완으로 인해 실제 격자 상수는 이 두 가지 제한적인 경우 사이에 있을 것으로 예상됩니다. 이것은 준안정 합금에서 X선 기반 기술을 보완하는 격자 변형에 대한 정보를 제공할 수 있는 유망한 특성화 방법을 보여줍니다.
<그림>
표시된 GaAs 및 GaAsBi 레이어가 있는 p-i-n 샘플 S1의 단면 HAADF 이미지(왼쪽). GaAsBi 내의 더 어두운 영역은 위상 분리된 도메인입니다. 라인 프로파일(오른쪽)은 EELS 벌크 플라즈몬 피크 에너지 이동, E를 보여줍니다. GaAsBi -이 GaAs , GaAs 버퍼 레이어에 상대적입니다. 프로필은 왼쪽에서 동시에 획득한 HAADF 이미지와 밀접하게 정렬됩니다. EELS 데이터 픽셀은 수평 방향으로 완전히 비닝되어 공간 평균 값을 나타냅니다. 스케일 바는 100nm이며 EELS 프로파일의 수직축에도 적용됩니다.
두 번째 GaAsBi 샘플인 S2는 절단된 Ge 기판에 증착된 GaAs 버퍼층 위에 성장되었습니다(방법 참조). Ge-GaAsBi 헤테로 에피택시는 우리의 이전 작업에서 분석되었으며, 이는 또한 대규모 도메인 단일 변형 CuPtB GaAsBi에서 주문[34]. 추가 데이터는 이 작업에서 제공되며 Bi 원자 순서에 대한 논의의 완전성을 위해 사용됩니다. 이 샘플의 총 비스무트 농도는 PL로 측정했을 때 ~ 5.8%입니다(SI 그림 S1)[34]. 이 에피택시에 사용된 GaAs 버퍼 층과 결합된 오프컷은 GaAsBi에서 역위상 도메인의 형성을 방지하는 데 도움이 되며, 이는 비극성 Ge에서 직접 성장시킬 때 제거하기 여전히 번거로운 문제입니다[60,61,62]. 그림 4a는 HAADF 이미지에서 가시적으로 더 밝은 GaAsBi 층이 있는 GaAs-GaAsBi 인터페이스 영역을 보여줍니다. 평평한 GaAs 기판에 증착된 이전의 GaAsBi 필름과 달리 여기에서는 단일 CuPtB 오더로 인해 하위 변형 주문이 선택되었습니다. 이것은 HAADF 이미지와 오른쪽 상단에 삽입된 푸리에 변환에서 볼 수 있으며 한 쌍의 1/2[\( \overline{1} \)11]* 초격자 반점을 보여줍니다. 그림 4b는 그림 1c, d와 유사한 한 쌍의 초격자 반사에 마스크를 적용하여 형성되었습니다. 그것은 영화에서 훨씬 더 균일하고 큰 도메인 정렬을 보여줍니다. 이 샘플에서 원자적으로 해결된 EDX 이미지를 획득하여 주문 매개변수 η를 추정했습니다. 구성 분석을 기반으로 합니다. EDX 화학 매핑은 고에너지 및 지연된 이온화 에지를 정량화할 때 신호 대 잡음비가 더 나쁜 경향이 있는 대체 코어 손실 EELS 정량화보다 우수한 경우가 많습니다[56, 63,64,65]. STEM 스캐닝 방향은 정렬된 (\( \overline{1} \)11) 평면을 수평으로 정렬하도록 변경되었습니다. 그림 4c–e는 Wiener 필터링된 X선 원소 맵을 보여줍니다. 매초(\( \overline{1} \)11) 평면에서 Bi 원자의 순서는 명확하고 원자 위치로 따릅니다. EDX 구성 정량화를 위해 동일한 실험 조건을 사용하여 샘플의 서로 다른 영역에서 각각 512 × 512 픽셀의 두 데이터 세트를 획득했습니다. 하위 영역이 정렬되고 원시 신호가 합산되어 총 10개의 프레임이 생성되었습니다. As-K 및 Bi-M의 수평으로 합산된 원시 데이터 수직선 프로파일이 그림 4f에 나와 있습니다. Bi-rich 및 Bi-deficient (111) 평면에서 비스무트 조성을 정량화하기 위해 원자 평면을 중심으로 3 Å 너비의 통합 창을 사용했습니다. 배경 빼기 및 모든 (111) 평면에 대한 평균화 후 Bi X-ray 카운트가 Bi-rich 평면에서 ~ 3배 더 높음을 보여줍니다. PL 및 XRD-RSM 측정으로 얻은 샘플의 총 농도 5.8% Bi를 사용하여 Bi X선 수를 조성에 대해 선형으로 확장하여 Bi가 풍부한 평면에서 최대 9%에 도달함을 보여줍니다. 따라서 order 매개변수는 η로 추정될 수 있습니다(서론 참조). =0.07. 이 총 Bi 농도를 가진 완전히 정렬된 비스마이드의 정렬 매개변수는 η =0.116입니다. HAADF 분석과 유사하게, 개별 컬럼의 EDX 정량화는 코어 전자의 이온화 전위가 고도로 국한되어 있기 때문에 채널링 효과로 어려움을 겪습니다. Alx의 다른 저자가 표시한 것처럼 가1-x 합금으로서 이것은 서로 다른 도펀트 구성으로 인해 최대 5%의 X선 카운트 표준 편차를 초래할 수 있습니다[50]. 편차를 고려할 때 X선 카운트는 너무 두껍지 않은 샘플에서 도펀트의 수에 따라 선형으로 확장되는 것으로 나타났습니다. 본 연구의 구성 오류는 각 (111) 평면에서 ~ 11개 원자 열을 총 ~ 130개 열에 대해 효과적으로 평균화하여 최소화됩니다. 또한, 전자 프로브 꼬리와 다중 산란은 EDX 이미지에서 신호 비편재화를 생성할 수 있습니다[52]. Ga SCS 값의 변화를 보여주는 이전 섹션의 HAADF 이미지 시뮬레이션은 EDX 정량화에서 이러한 효과의 예상 크기를 암시합니다. 샷 노이즈는 현재 이러한 묽은 합금에서 본질적으로 낮은 Bi X선 수로 인해 주요 정확도 제한 요소인 것으로 보입니다.
<그림>
아 오프컷(001) Ge에서 성장한 GaAs 버퍼층과의 경계면 근처에 있는 GaAsBi 샘플 S2의 HAADF 이미지. 오른쪽 상단의 푸리에 변환은 (\( \overline{1} \)11) 평면의 단일 집합에서 순서를 나타내는 피크 쌍을 보여줍니다. ㄴ (a ) 한 쌍의 초격자[\( \overline{1} \)11]* 브래그 반점을 사용합니다. ㄷ –이 Wiener는 표시된 대로 Bi-M, As-K 및 Ga-K X선 방출과 함께 GaAsBi 샘플의 EDX 이미지를 필터링했습니다. EDX 데이터에서 결정학적 방향은 정렬된 (\( \overline{1} \)11) 평면을 수평으로 정렬하기 위해 회전됩니다. 에 수평으로 합산된 수직 X선은 원시 As-K 및 Bi-M 신호의 프로필을 계산합니다. 두 개의 정렬된 데이터 세트를 결합하여 프로필을 얻습니다.
The final GaAsBi sample, S3, that we wish to explore here was synthesized under conditions to create so-called vertical composition modulations (VCM) (see Methods) [66]. In contrast to samples S1 and S2, the VCM is achieved in S3 by utilizing a slower substrate rotation rate (RPM), which is coupled to intrinsically inhomogeneous elemental flux profiles reaching the substrate in a typical MBE chamber. The III/V elemental ratio within a sample region can be oscillated by controlling the RPM and the film growth rate to obtain the desired VCM period. A vertical spiral in regards to Bi concentration can be obtained in GaAsBi this way, as has been well explained in M.A. Stevens et al. [66]. A cross-sectional HAADF image of the GaAsBi sample S3 is shown in Fig. 5a, grown on a (001) GaAs substrate rotated 5 RPM and 300 nm/h growth rate. Total bismuth composition in the sample area under investigation was determined to be 2.8% Bi using room-temperature PL (SI Fig. S1). The VCM is visible with a well-defined superlattice-like appearance. The tendency to CuPtB order is also visible in this image, and here it incurs the additional vertical modulation. The inset on the top right shows Fourier transform of the image with arrows marking the pair of stripes, which result from Bi content modulation along the [\( \overline{1} \)10] direction on every second plane and accordingly reduced extent of (111)-type ordered planes along [001].

아 HAADF image of the VCM GaAsBi sample S3. Bi concentration modulations along the growth [001] direction are visible, as well as CuPtB ordering within the Bi-enriched planes. Inset shows Fourier transform with reminiscent CuPtB ordering modulated by the VCM. ㄴ A combined Wiener filtered elemental EDX image of the sample with normalized X-ray counts for each element, Bi-green, As-Blue, and Ga-red. ㄷ Vertical X-ray count profile extracted from 3 × 3 binned raw As-K and Bi-M signals, horizontally summed within a 5 nm window
The sample was also investigated using atomic scale elemental EDX mapping. Figure 5b shows overlaid normalized and color-coded X-ray signals of Bi-M (green), As-K (blue), and Ga-K (red). The corresponding elemental Wiener filtered maps are shown in SI Fig. S5. The peak-to-peak distance between Bi-rich regions is 1.7 nm, which indicates the VCM period is ~ 3 lattice constants. The peak positions do not align on a single Bi-rich (001) plane. This offset reflects that Bi atoms with higher concentrations are dispersed over 2–3 group-V (001) atomic planes, which is clearer in the HAADF image (Fig. 5a). Figure 5c shows 4 VCM periods by plotting vertical Bi-M and As-K line profiles of horizontally summed counts in a 5 nm wide window from the 3 × 3 binned raw EDX data. Despite the signal noise, As-K X-ray count profile seems to inversely follow the Bi-M profile showing small dips at Bi-enriched regions. Such a correlation between substitutional element and the host element X-ray signals may be exploited in future atomic scale EDX analysis of dilute alloys.
Three different bulk GaAsBi samples regarding Bi distribution modes were investigated in this study using STEM techniques. The quantification of scattering cross sections was applied to a GaAs-GaAsBi hetero-diode grown on conventional (001) GaAs, showing atomically abrupt interface and early CuPtB -type ordering onset. Numerical multislice image simulations within the frozen-phonon thermal scattering approximation were used to investigate GaAsBi HAADF images. It showed that due to channeling, the configurational Bi variations can translate into apparent compositional variations. To carry out column-by-column Bi atom counting would thus require numerical image analysis. EDX mapping was presented of a single-variant ordered dilute GaAsBi sample grown on an offcut substrate. To avoid the configurational errors in elemental EDX quantification, the X-ray signals were averaged over many columns in (111) atomic planes, and the order parameter was estimated to be η =0.07 in this sample. The atomic-resolution HAADF and EDX were also used to analyze a VCM GaAsBi film synthesized using a slow substrate rotation rate. This sample showed Bi content modulation in the [001] axis with a period of three lattice constants in addition to the CuPtB ordering. Finally, bulk plasmon energy mapping using monochromated EELS was performed on a GaAs-GaAsBi hetero-diode. As the plasmon energy shift in dilute GaAsBi is related to the unit-cell volume changes, this provides a simple method to complement XRD-based techniques to examine local strain-state in GaAsBi alloys.
Three different samples were examined in this study, samples S1, S2, and S3, all grown by solid-source MBE. The first sample, S1, is a GaAsBi p-i-n heterojunction, with an intrinsic 420-nm GaAsBi layer containing ~ 4.5 Bi%, as evaluated by XRD (not shown here) and room-temperature PL (SI Fig. S1). The n-type and p-type GaAs layers are 100 nm and 80 nm thick, respectively, and were doped to 5 × 10 17 cm −3 concentrations using Si and Be, respectively. The sample was grown on an n-type (001) GaAs substrate using SVT-A MBE reactor equipped with metallic Ga and Bi sources and a two-zone valved arsenic cracker. The GaAs layers were deposited using a 330-nm/h growth rate at 600 ° C substrate temperature, supplying arsenic overpressure. GaAsBi layer was grown using a 100 nm/h rate, 10 revolutions per minute (RPM) substrate rotation, 360 ° C (thermocouple readings), As/Ga BEP around 1.08, Bi flux ~ 10 −7 토르. The (2 × 1) surface reconstructions were seen using RHEED during GaAsBi deposition. The second sample, S2, consisted of 280 nm thick GaAsBi with 1.0 eV band gap and~ 5.8 Bi%, as measured by PL (SI Fig. S1) and XRD [34]. This sample was grown over a ~ 300 nm GaAs buffer layer which was deposited on a p -type (001) Ge substrate with 6° offcut towards <110>. The first 50 nm of the buffer was deposited by migration-enhanced epitaxy. The remaining 300 nm of GaAs buffer was synthesized at 600 °C. GaAsBi film was grown at 350 °C, with BEP ratio of As to Ga in the range 1.063 to 1.1, and Bi/Ga ratio 0.35–0.37. The substrate was rotated 15 at RPM. The third and final sample, S3, was grown using the Veeco GENxplor MBE chamber, with the same type of sources and the arsenic cracker as in the SVT-A reactor. The sample consists of 500 nm GaAsBi with ~ 2.8% Bi, as measured by PL (SI Fig. 1) and XRD (not shown here). The layer was grown at 310 °C (band edge absorption measurement, kSA Bandit), on top of 80 nm GaAs buffer layer grown at 580 °C. The growth rate of the bismide was 0.5 monolayers/s, As/Ga BEP ratio ~ 1.35, and Bi flux ~ 8 × 10-8 Torr. The substrate was rotated at 5 RPM.
Transmission electron microscopy samples were prepared in a cross-sectional geometry by the focused ion beam (FIB) lift-out technique using FEI Helios Nanolab 650 dual-beam microscope. The samples were polished to 20–25 nm thickness, as measured by the EELS Log-ratio method, and argon-oxygen plasma-cleaned or degassed before loading into a microscope. HAADF imaging was carried out using cold-field emission double aberration-corrected JEOL JEM-ARM200CF operated at 200 kV [67]. The inner collection semi-angle of the HAADF detector was set to 90 mrad, with 22 mrad probe convergence semi-angle. The HAADF image analysis was carried out using StatSTEM add-on for Matlab [44]. Single width 2D Gaussian functions were fitted to the atomic columns after background subtraction. HAADF image simulation was performed using the muSTEM software using 15 frozen-phonon configurations, transmission functions with 0.02 Å square pixel size, and supercell size ~ 20 × 15 Å [68, 69]. The above experimental STEM probe parameters were used with defocus C1 =0, C3 =0.002 mm, and C5 =1 mm spherical aberration coefficients, and a fully coherent electron probe. Kirkland multislice code was used to calculate the average of electron probe intensity versus sample depth, averaged over 10 frozen-phonon configurations [68]. The intensity average is taken across the atomic column in a 1 Å wide window. X-ray energy dispersive spectroscopy was performed using 0.98 steradian solid-angle windowless silicon drift-detector JEOL JED-2300. The probe current was set to 200 pA for EDX characterization and pixel dwell time 0.2 msec. The EDX images were 512 × 512 pixels in size, and a total of 5 frames were accumulated for each data set. Wiener filtering was applied to both EDX images for visualization, and sample drift-correction was used on Fig. 5 EDX data. On-axis electron energy-loss spectrum imaging was carried out using a modified monochromated Nion Hermes-200 (ChromaTEM) operated at 100 kV. The probe convergence semi-angle was set to 10 mrad, EELS collection semi-angle 35 mrad, 0.02 eV EELS energy dispersion, and 0.005 s EELS exposure time. The FWHM of the ZLP with beam positioned on the sample was measured to be 0.11 eV. Gatan DM 3.01 image analysis software was employed post-acquisition to center and removes the ZLP. The spectrum image was binned vertically by a factor of 4 and fully binned in the horizontal direction. Cross-correlation-based “Align SI by peak” algorithm was employed within the Gatan DM 3.01 software to determine plasmon peak shifts. Room-temperature PL measurements were carried out using a 420-mm focal length monochromator along with thermoelectrically cooled InGaAs photodetector. Diode-pumped solid-state laser emitting at the wavelength of 532 nm with an estimated power density of 5 kW/cm 2 was used as an excitation source.
현재 연구 중에 사용 및/또는 분석된 데이터 세트는 합당한 요청이 있는 경우 교신 저자에게 제공됩니다.
Beam equivalent pressure ratio
Electron energy-loss spectroscopy
고속 푸리에 변환
고각 환상 암시야
분자빔 에피택시
광발광
주사 투과 전자 현미경
Scattering cross-section
Vertical composition modulations
X-ray energy dispersive spectroscopy
나노물질
초록 우리는 폴리에틸렌 글리콜(PEG)로 코팅된 코발트 페라이트 나노 입자와 나노구의 독성에 대한 비교 연구를 제시합니다. 나노입자는 열수법에 의해 제조되었고 나노구체는 용매열법에 의해 제조되었다. 나노 물질의 표면은 폴리에틸렌 글리콜로 성공적으로 개질되었습니다. 제조된 시료의 형태를 조사하기 위해 X선 회절(XRD), 푸리에 변환 적외선(FTIR) 분광법, 라만 분광법, 열중량 분석(TGA) 및 전자 현미경 기술을 사용했습니다. 구조 분석을 통해 각각 직경이 20–25 nm 범위인 다결정 코발트 페라이트 나노입자와 80–100
초록 침과 그 경락은 중국 전통 의학의 중요한 구성 요소이며 이러한 경락에 대해 이전에 수많은 의견이 표현되었습니다. 본 연구는 전기펄스와 침에 의해 영향을 받는 응답전류에 대한 이러한 자오선을 연구함으로써 전자물리학의 관점에서 자오선의 현상을 탐구하는 것을 목적으로 한다. 본 연구에서는 경락의 물리적 특성을 연구하기 위해 전기 펄스를 가하는 침을 사용하였다. 비정상적인 전기 신호를 구현하기 위해 다양한 종류의 펄스가 인체에 가해졌습니다. 이러한 전기 측정 결과를 ITIC(등온 과도 이온 전류) 이론과 비교하여 자오선 메시지의 전