나노물질








플라즈마 보조 분자빔 에피택시(MBE)에 의해 Si(111)에서 GaN 나노벽 네트워크, 나노컬럼 및 컴팩트 필름의 구조 이동이 성공적으로 얻어졌습니다. 예상한 바와 같이, GaN 나노컬럼의 성장은 베어 Si 상에서 N이 풍부한 조건에서 관찰되었으며, Ga 플럭스가 개선되면 성장이 콤팩트 필름으로 이동하였다. 흥미롭게도 GaN 성장 전에 40초 동안 알루미늄(Al) 사전 증착을 수행하면 GaN이 나노벽 네트워크 형태로 성장합니다. 결과는 사전 증착된 Al이 각각 ~ 80 및 ~ 6.7 nm의 일반적인 직경과 높이를 갖는 액적 형태로 존재함을 보여줍니다. 나노벽 네트워크에 대한 성장 모델이 제안되고 성장 메커니즘이 논의됩니다. GaN은 Al 액적이 없는 영역에서 성장하고 Al 액적 위의 성장은 방해를 받아 나노 디바이스 제조의 장애물을 제거하는 연속적인 GaN 나노벽 네트워크를 형성합니다.
<섹션 데이터-제목="배경">직접적인 광대역 갭 반도체로서 GaN 및 관련 화합물은 발광 다이오드[1,2,3], 레이저 다이오드[4] 및 높은 전자 이동도 트랜지스터[5, 6]에서 큰 성공을 거두었습니다. 그러나 사파이어, 탄화규소 또는 단결정 실리콘 상의 GaN 필름의 헤테로에피택시는 높은 밀도의 전위를 유도합니다. 이들의 나노구조는 무전위, 변형이 없고 큰 표면적 대 부피 비율로 인해 우수한 성능을 갖는 것으로 여겨진다[7, 8]. GaN 나노컬럼과 나노와이어에 대한 연구가 집중적으로 수행되어 왔다[9,10,11,12]. GaN 나노기둥 핵형성은 Volmer-Weber 성장 메커니즘[13]에 의해 자발적으로 발생하는 반면, 질소가 풍부한(N-풍부) 조건은 핵형성 사이트가 합쳐지는 것을 방지합니다. GaN 나노와이어 또는 나노컬럼에서 전기 장치를 제작하는 데 많은 관심을 기울였습니다. GaN 나노와이어는 SiO2에 기계적으로 분산되었습니다. /Si 기판 및 개별 나노와이어의 양면에 무작위로 형성된 옴 접촉 [14]. 또 다른 경우[15]에서는 나노와이어의 한 면을 음극에 연결된 스테이지에 고정하고 다른 면을 양극에 정렬하여 주사전자현미경(SEM)을 사용하여 과학 연구를 위한 전기 장치를 구성했습니다.
대안적으로, 나노 장치 제조에 복잡한 공정이 필요하지 않기 때문에 면내 전기 전도성인 GaN 나노벽 네트워크라는 특수한 나노구조가 유망하다. 2007년에 Kishino의 그룹은 전자빔 리소그래피에 의해 패터닝된 Ti 층을 마스크로 사용하여 GaN 나노벽 네트워크의 성장을 얻었다[16]. 몇 년 전, 리소그래피 없이 GaN 나노벽 네트워크의 성장이 사파이어 및 실리콘 기판에서 성공적으로 얻어졌습니다[17,18,19]. GaN 나노벽 네트워크의 밴드 에지 방출 강도는 GaN 나노컬럼과 유사하고 노란색 발광이 명확하지 않아 GaN 나노벽 네트워크의 고품질을 나타냅니다. 나노컬럼과 같이 분리된 나노구조와 달리 나노벽 네트워크는 면내 전기전도성이 있어 [18, 20, 21] 필름처럼 쉽게 나노소자를 제작할 수 있다[22]. 따라서, 나노벽 네트워크의 면내 전기 전도에 의해 분리된 나노칼럼에서 소자 제작의 장애물을 제거할 수 있다. 나노벽 네트워크의 성장 메커니즘을 연구하는 것이 중요합니다. 나노벽 네트워크의 전위 유도 자발적 형성은 베어 c에서 GaN 나노벽 네트워크의 성장 메커니즘으로 간주됩니다. -플레인 사파이어[23]. 전위에 의해 유도된 나노벽 네트워크의 형성은 제어가 낮기 때문에 Al 버퍼층이 있는 Si(111) 기판에 나노벽 네트워크 성장이 수행되었다[18]. Si(111)의 나노벽 성장 메커니즘은 베어 사파이어 기판의 성장 메커니즘과 상당히 다릅니다. 그러나 Si(111)의 성장 메커니즘이 나노벽 네트워크 성장의 핵심이지만 연구는 수행되지 않았습니다.
이 연구에서는 나노벽 네트워크, 나노컬럼, 콤팩트 필름을 포함한 다양한 구조에서 GaN의 성장을 체계적으로 연구합니다. 위에서 언급한 다양한 GaN 구조는 플라즈마 보조 분자빔 에피택시(MBE)를 사용하여 Si(111)에서 성장되었습니다. 결과는 Ga/N 비율을 조정하고 사전 증착된 Al 액적을 추가함으로써 GaN 성장의 구조 이동이 달성될 수 있음을 보여줍니다. GaN 나노벽 네트워크의 형태 및 광발광은 여기 소스로 He-Cd 레이저(325nm, 200mW)를 사용하는 전계 방출 주사 전자 현미경(FESEM) 및 광발광 스펙트럼 분석기로 측정되었습니다. AFM(Atomic Force Microscope)은 사전 증착된 Al 층의 특성화에 사용되었습니다. 금속 Al 방울을 갖는 Si(111) 상의 GaN 나노벽 네트워크의 성장 메커니즘이 제안됩니다.
GaN 구조는 N2가 장착된 Riber 32 MBE 시스템에 의해 Si(111) 기판에 성장되었습니다. RF 플라즈마 소스(Veeco, RFS-N/TH). 성장 챔버의 압력은 3.0 × 10 - 10 으로 펌핑되었습니다. 성장 전 토르. N2 본 실험에서는 순도 99.9999%의 가스, Ga, Al을 사용하였다. 저항이> 5000Ωcm인 Si(111) 기판(도핑 없이, 성장을 위해 한 면이 성장을 위해 연마됨, 380 ±20μm, Sigma-Aldrich에서 제공)을 표준 RCA 공정으로 세척한 다음 HF:H2에 침지했습니다. O =1:50 몇 초 동안 Si 기판 표면의 실리콘 산화물 층을 제거하고 수소 말단 표면을 형성합니다.
GaN 나노컬럼의 성장을 위해 N2의 셔터 플라즈마와 Ga 소스가 동시에 열리고 베어 Si(111)가 973K에서 가열되었습니다. N2의 전력과 압력 이 작업의 모든 샘플에 사용된 플라즈마 소스는 400W 및 4.2 × 10 − 5 로 고정되었습니다. 각각 토르. GaN 나노벽 네트워크의 성장 전에 직경이 약 80nm인 Al 액적이 973K로 가열된 베어 Si(111)에 증착되었습니다. Al 소스는 1323K로 유지되었습니다. Al 액적의 사전 증착 GaN의 다른 핵 생성과 성장을 초래하여 나노벽 네트워크의 성장을 이끈다. 나노벽 네트워크의 성장을 위한 Ga 플럭스는 나노컬럼(φ 가 =1.2 × 10 − 7 1169K의 Torr). GaN 박막의 성장을 위해 Ga 플럭스는 5.3 × 10 − 7 으로 증가하였다. N 자속이 일정하게 유지되는 동안 Torr.
N2의 셔터가 있을 때 플라즈마와 Ga가 동시에 열림, GaN(S1 )은 그림 1a와 같이 베어 Si(111)에 나노기둥 형태로 성장했다. Ga 플럭스는 1.2 × 10 − 7 이었습니다. Torr 및 Si(111) 기판은 표 1과 같이 973K로 유지되었습니다. GaN 나노컬럼의 직경은 52~125nm이고 길이는 ~ 460nm인 것으로 관찰되었습니다. SEM 이미지에서 계산된 나노 컬럼의 밀도는 ~ 10 7 입니다. mm − 2 . 분명히, 그림 1b에서 관찰된 대부분의 나노 컬럼은 기판에 수직이 아니라 ~ 30°의 각도로 기울어져 있습니다. Bertness의 보고서 [9]와 일치하여 나노 컬럼의 상단 표면은 매끄럽습니다. (0 0 01) c의 점착 계수 때문에 나노기둥이 자발적으로 핵을 생성한 다음 전파되는 것으로 믿어집니다. -평면이 {110 0} m보다 높습니다. -비행기. 확산 길이 L 흡수된 Ga 원자의 (Gaab ) 나노 컬럼의 성장에 필수적입니다. 식에 설명된 대로 (1), 확산 길이 L 평균 점프 거리 a에 따라 다릅니다. , Gaab 탈착 에너지 Q 데스 , 그리고 표면 확산 점프를 위한 활성화 에너지 Q d [13].
$$ L=\sqrt{2}a\ \exp \left(\frac{Q_{\mathrm{d}\mathrm{es}}-{Q}_{\mathrm{d}}}{2 kT}\ 오른쪽) $$ (1) <그림>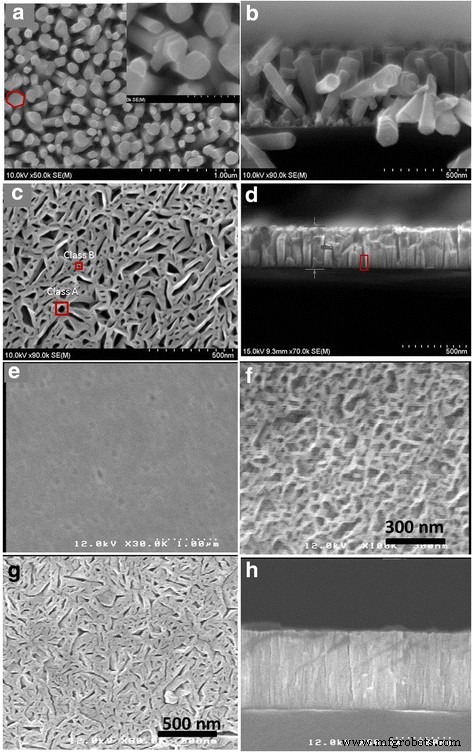
다양한 조건에서 성장한 샘플의 FESEM 이미지. 아 , b GaN 나노 컬럼에 해당(샘플 S1 ). ㄷ , d GaN 나노벽 네트워크에 해당(샘플 S2 ), e 컴팩트 필름에 해당(샘플 S3 ), f GaN 나노벽 네트워크에 해당(샘플 S4 ) 초기 성장 단계에서. 지 , h 낮은 온도 900K에서 성장한 GaN 나노벽 네트워크에 해당(샘플 S5 )
원자적으로 평평한 나노기둥 측벽은 흡착 부위를 거의 제공하지 않기 때문에 Gaab 확산 길이 L m에 - 측벽의 평면이 c의 평면보다 훨씬 높습니다. - 평면, 결과적으로 GaN을 나노 컬럼으로 수직 성장. 이 가정이 사실이라면 Ga/N 비율이 개선될 때 강한 성장률 이방성이 변경될 것입니다. 실제로 GaN(S3 ) Ga 플럭스가 5.3 × 10 − 7 으로 증가했을 때 나노기둥에서 조밀한 필름으로 구조가 변경됨(그림 1e) 토르. 따라서 Ш/V 비율을 조정하여 나노기둥 또는 조밀한 필름 형태의 GaN 성장을 제어할 수 있습니다.
GaN 나노컬럼은 필름보다 우수한 성능을 나타내지만, 분리된 나노컬럼은 전기적 접촉을 제조하기 전에 정렬이 필요하기 때문에 전기소자의 제조가 매우 어렵다. 따라서 면내 전기 전도성 나노구조가 선호됩니다. 샘플 S2의 성장을 위해 , 금속 Al 사전 증착은 MBE 성장 챔버에서 40초 동안 수행되었습니다. 그런 다음 N2 플라즈마와 Ga 소스가 동시에 열렸습니다. S2의 Ga 플럭스 성장은 S1의 성장과 동일하게 표 1에 요약되어 있습니다. . 그림 1c는 샘플 S2.의 평면도 FESEM 이미지를 보여줍니다. GaN이 Al/Si(111)에서 나노벽 네트워크의 형태로 성장한다는 것은 매우 흥미롭습니다. 직경이 50~100nm인 나노벽이 서로 중첩 및 인터레이스되어 면내 연속 네트워크, 즉 나노벽 네트워크를 형성합니다. 클래스 A와 클래스 B라는 두 가지 클래스의 구멍이 관찰 가능합니다. 클래스 A와 클래스 B 구멍의 직경은 일반적으로 각각 50~100 및 10~ 49 nm입니다. 평면 내 연속 특성은 나노벽 네트워크를 패널 내 전기 전도성으로 만들어[18], 나노 장치 제조의 장애물을 어느 정도 제거합니다. 나노벽의 상단 표면은 Ref. [13]. 평면도 이미지에 표시된 구멍이 그림 1d의 직사각형으로 표시된 것처럼 기판 근처까지 확장되는 것을 볼 수 있습니다.
위에서 언급한 구멍이 어떻게 생성되는지 궁금할 수 있습니다. 샘플 S5를 키웠습니다. 900K의 낮은 성장 온도에서. 다른 성장 매개변수는 샘플 S2와 동일합니다. , 표 1에 표시된 대로. 그림 1g에서 샘플 S5 또한 더 작은 구멍을 가진 나노벽 네트워크의 형태로 성장했습니다. 그림 1h는 S5의 단면 이미지입니다. , S2.보다 더 컴팩트한 레이어를 보여줍니다. GaN 나노벽 네트워크의 초기 성장을 보기 위해 다른 샘플 S4를 성장시켰습니다. Al 사전 증착으로 짧은 시간에. S4의 모든 성장 매개변수 샘플 S2와 동일합니다. 성장 시간을 제외하고(20분 대 120분) 두께 S4 약 50nm이고 평면도 이미지가 그림 1f에 나와 있습니다. 이 단계에서 정공이 형성되었으며 as-gown GaN은 GaN 나노와이어 또는 섬이 아니라 면내 연속 네트워크인 것으로 관찰됩니다. 샘플 S1 연구에서 , S2 , S4 및 S5 , Al 층의 사전 증착이 나노 컬럼에서 면내 연속 나노벽 네트워크에 이르기까지 초기에 GaN의 성장 거동을 변화시키는 것이 분명합니다.
S2의 모든 성장 조건에 유의하십시오. Al 사전 증착이 S1의 것과 동일하다는 점을 제외하고 . 그러면 우리는 사전 증착된 Al의 구조가 무엇이며 이것이 GaN의 후속 성장에 어떤 영향을 미치는지 궁금할 수 있습니다. 이러한 답을 찾기 위해 FESEM 및 AFM에서 베어 Si(111)에 40초 동안 Al 사전 증착을 조사했습니다. 그림 2a는 사전 증착된 Al의 평면도 이미지를 보여줍니다. Si 기판 상의 Al은 막이 아닌 액적(백색 점)의 형태로 존재함을 알 수 있다. 밀도가 ~ 4 × 10 7 인 금속성 Al 방울 mm − 2 상당한 축적 없이 상대적으로 균일하게 분포합니다. 최근에 Al 액적은 Li et al.에 의해 MBE를 사용하여 성공적으로 성장되었습니다. As-grown GaN의 품질을 개선하고 스트레스를 줄이기 위해 [24]. Al 액적의 형태를 추가로 연구하기 위해 AFM을 사용하여 그림 2b, c와 같이 3차원 이미지와 관련 매개변수를 측정했습니다. 액적은 SEM 결과와 일치하는 그림 2b와 같이 구형입니다. 측정된 Al 액적의 높이와 직경은 각각 6.7 및 80nm입니다. Poppitz et al. [25]는 철 빔 지원 MBE에 의해 베어 6H-SiC(0001)에서 GaN 나노벽 네트워크의 성장을 조사했습니다. 그들의 결과는 높은 기판 온도와 결합된 극도로 N이 풍부한 성장 조건과 성장 중 에너지 넘치는 N-이온 조사가 베어 6H-SiC(0001)에 나노벽 네트워크가 형성되는 주요 원인임을 보여줍니다. 개척자로서 Kesaria et al. [17]은 PA-MBE를 사용하여 베어 사파이어 기판에서 GaN 나노벽 네트워크를 조사했습니다. 그들의 연구에서 GaN 나노벽은 가장자리와 나사 전위에서 핵을 형성하고 N이 풍부한 분위기에서 성장하는 것으로 간주됩니다.
<그림>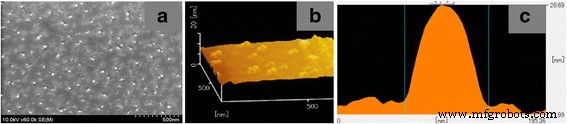
FESEM(a ) 및 원자현미경(b ) Si 기판에 사전 증착된 Al의 이미지. ㄷ AFM에 의한 하나의 Al 방울의 매개변수 측정
우리의 경우, GaN 나노벽 네트워크의 성장 메커니즘은 금속 Al 사전 증착의 요구 사항에 따라 나노벽이 성장하기 때문에 달라야 합니다. 물론 우리가 아는 한 실험을 포함한 모든 GaN 나노벽 네트워크는 N이 풍부한 분위기에서 성장했습니다. N이 풍부한 것은 나노벽의 유착을 줄이기 위해 필요합니다. 이제, 나노벽 네트워크의 형성에서 Al 액적의 역할에 초점을 맞춰보자. 촉매로 작용하는 Au 방울[26]과 유사하게, Al 방울이 촉매로 작용하면 GaN은 나노벽 네트워크가 아닌 나노 기둥으로 성장해야 합니다. 따라서 Al 액적의 역할은 우리 연구에서 촉매가 아닙니다. Al 금속의 용융 온도는 933K이며 기판 온도는 성장 중에 973K로 유지됩니다. 따라서 GaN 성장이 시작될 때 Al 방울은 액체 방울입니다. 이전 보고서에 따르면, Ga 액적[13]이 있는 Si(111) 상의 GaN의 경우, Ga 액적은 가까운 부근에 Ga 원자를 공급하는 저장소 역할을 합니다. 그러나 Ga 액적 자체는 원래 Ga 액적 사이트가 속이 빈 원이기 때문에 GaN 성장을 방해합니다. 우리의 경우 Al 액적의 직경은 ~ 80nm로 그림 1a의 클래스 A 구멍 크기와 유사합니다. 따라서 Al 액적은 그 위의 GaN 성장을 방해하여 GaN 나노벽 네트워크에서 관찰되는 클래스 A 정공을 형성할 수 있습니다. 샘플 S1의 Ш/V 비율이 동일하기 때문에 및 S2 , Ga 확산 길이 L 나노월 네트워크 성장을 위한 Si의 경우 나노컬럼의 성장과 동일할 것으로 예상됩니다. 베어 Si 기판(Al 방울이 없는 영역)의 일반적인 크기는 ~ 80nm이며, 그림 1a의 나노컬럼 직경 값 내입니다. 즉, Ga 확산 길이 L 베어 Si 기판의 크기를 커버하여 Al 액적이 없는 영역, 즉 GaN 나노벽 네트워크에서 GaN의 지속적인 성장을 초래합니다.
위의 분석을 바탕으로 GaN 나노벽 네트워크의 성장 모델이 제안되고 그림 3에 표시됩니다. GaN은 그림 3a에 표시된 대로 베어 Si 기판에서 핵을 형성합니다. Gaab 이후 확산 길이 L 베어 Si 기판을 덮고, GaN은 전체 베어 Si 기판에서 성장하는 반면 Al 액적 위의 GaN 성장은 방해를 받습니다(그림 3b). 또한 N이 풍부한 조건에서 GaN은 그림 3c와 같이 수직으로 성장하는 경향이 있습니다. Bare Si 기판은 평면 내 연속 네트워크이기 때문에 위의 GaN 성장은 그림 3d와 같이 나노벽 네트워크라는 연속 네트워크이기도 합니다. 이 가정은 샘플 S4의 평면도 이미지에 의해 확인됩니다. 그림 1f에서. 샘플 S2에 대한 N이 풍부한 조건으로 인해 성장, 측면 성장은 구멍이 후속 성장에서 예비할 수 있도록 제한됩니다. Al 액적과 N이 풍부한 조건은 모두 GaN 나노벽 네트워크 성장에 필수적입니다.
<그림>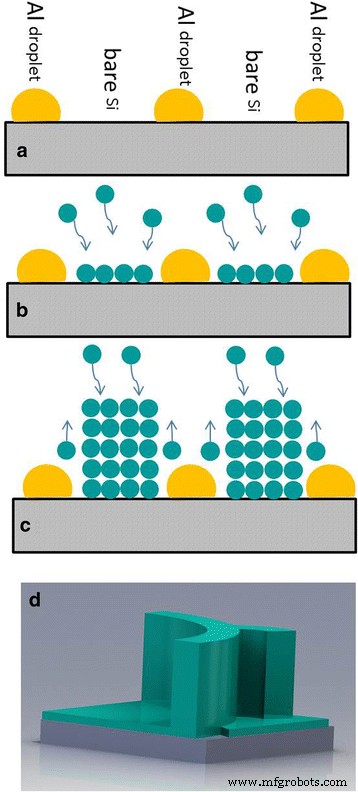
GaN 나노벽 네트워크의 성장 모델. 아 Si 기판에 미리 증착된 Al 방울. ㄴ 베어 Si에서 GaN 나노벽 네트워크의 핵 생성. ㄷ N이 풍부한 조건에서 수직으로 성장한 GaN 나노벽 네트워크의 단면도. d GaN 나노월 네트워크의 기울기 그림
X선 회절은 그림 4와 같이 GaN 나노벽 네트워크의 결정 구조 특성화에 사용되었습니다. GaN(002) 및 GaN(004)의 두 개의 회절 피크가 Si 기판. 결과는 GaN 나노벽 네트워크가 육각형이고 C를 따라 높게 배향되어 있음을 보여줍니다. 중심선. XRD 패턴 외에도 GaN(002)의 ω-scan 로킹 곡선도 그림 4의 삽입과 같이 측정되었습니다. 반치의 전체 너비는 사파이어에서 성장한 이전 보고서와 유사한 52.2arcmin입니다. 기판 [27]. 293K에서 Van der Pauw Hall 측정 시스템(HL5500PC, Nanometrics)을 사용하여 전기적 특성도 측정했습니다. GaN 나노월 네트워크의 전기 전도도, 홀 이동도 및 전자 농도는 10.2S/cm, 31cm 입니다. 2 /V 및 2.1×10 18 cm − 3 , 각각. GaN 필름의 경우 2.2×10 20 의 높은 전자 농도로 인해 전기 전도도가 666.7S/cm로 증가합니다. cm − 3 . 필름의 높은 캐리어 농도는 최적화되지 않은 Ga/N 비율에 의해 생성된 높은 고유 결함 농도 때문일 수 있습니다. 필름의 홀 이동도 값은 18.7cm 2 입니다. /대.
<사진>
GaN 나노벽 네트워크의 X선 회절 패턴(S2 ). 삽입은 샘플 S2의 ω-스캔 요동 곡선입니다.
그림 5는 여기 소스로 He-Cd 레이저를 사용하는 GaN 나노벽 네트워크의 광발광 스펙트럼을 보여줍니다. Kesaria et al.의 보고서[17]에 따르면, 베어 사파이어 기판에서 성장된 GaN 필름, 나노벽 네트워크 및 나노컬럼 간의 음극 발광의 직접적인 비교가 수행되었습니다. 그들의 결과는 나노벽 네트워크의 밴드 에지 방출이 나노컬럼보다 약간 높고 필름보다 훨씬 높다는 것을 보여줍니다. 520에서 620에 중심을 둔 광범위한 결함 방출은 나노벽 네트워크에서 관찰할 수 있지만 나노컬럼에서는 결함 방출이 관찰되지 않습니다. 그림 5에서 363.7nm를 중심으로 하는 강한 밴드 에지 방출이 14.1nm의 반값에서 전체 너비로 관찰됩니다. Kesaria et al.의 보고서[17]와 잘 일치하여 520~620nm 범위에서 점 결함[28]으로 인한 넓은 녹황색 방출이 감지 가능하지만 매우 약하여 GaN 나노벽의 고품질을 나타냅니다. 회로망. 따라서 베어 사파이어 기판과 Al 방울이 있는 Si 기판에서 성장한 GaN 나노벽 네트워크의 발광은 성장 메커니즘은 다르지만 거의 동일합니다.
<그림>
실온에서 측정된 GaN 나노벽 네트워크의 광발광(PL) 스펙트럼
이 연구에서 MBE를 사용하여 Si(111) 기판에서 나노컬럼, 나노벽 네트워크 및 콤팩트 필름 사이에서 GaN 성장의 구조 이동이 성공적으로 달성되었습니다. GaN 나노컬럼은 N이 풍부한 조건에서 베어 Si 기판에서 성장되는 반면, 컴팩트 필름은 개선된 Ga 플럭스로 성장되었습니다. 사전 증착된 Al 층을 추가함으로써 GaN의 성장은 나노컬럼에서 평면 내 연속 나노벽 네트워크로 이동합니다. 사전 증착된 Al 층은 각각 6.7 및 80nm의 일반적인 높이와 직경을 갖는 액적 형태로 존재합니다. 나노벽 네트워크의 성장 메커니즘을 다룬다. GaN은 베어 Si 기판에서 지속적으로 성장하는 반면 Al 액적에서 GaN 성장은 방해를 받아 나노벽 네트워크가 형성됩니다. Al 액적과 N이 풍부한 조건은 모두 나노벽 네트워크 성장에 필수적입니다.
나노물질
초록 플렉서블 투명 전도성 전극은 플렉서블 광전자 소자의 필수 구성 요소로 최근 몇 년 동안 광범위하게 연구되고 있는 반면, 대부분의 연구는 전극 자체에 초점을 맞추고 있으며 소재 녹색 및 재활용 가능성에 대한 주제는 거의 없습니다. 이 논문에서 우리는 이전의 크래킹 기술을 기반으로 하는 고성능 투명 전도성 전극(TCE)을 녹색 및 재활용 가능한 기질인 녹말 필름과 결합하여 시연합니다. 낮은 R을 보여줄 뿐만 아니라 s (1.0 Ω sq−1 82%, 성능 지수 ≈ 10,000)이지만 매우 부드러운 형태와 재활용성을 제공합니다. 또
초록 메타물질의 도입은 전자기를 포함한 여러 분야에 지대한 영향을 미쳤습니다. 그러나 요청에 따라 메타물질의 구조를 설계하는 것은 여전히 시간이 많이 걸리는 프로세스입니다. 딥 러닝은 효율적인 머신 러닝 방법으로 최근 몇 년 동안 데이터 분류 및 회귀에 널리 사용되어 실제로 좋은 일반화 성능을 보여주었습니다. 우리는 주문형 설계를 위한 심층 신경망을 구축했습니다. 필요한 반사율을 입력으로 하여 구조의 매개변수가 자동으로 계산된 다음 주문형 설계 목적을 달성하기 위해 출력됩니다. 우리 네트워크는 훈련 세트와 테스트 세트 모두에서