고속 전압 펄스 측정을 특징으로 하는 ZrO2 시드 레이어가 있는 Hf0.5Zr0.5O2 기반 FeFET의 메모리 창 및 내구성 향상
초록
HfO2 금속/강유전체/절연체/반도체(MFIS) 게이트 스택이 있는 기반 강유전체 전계 효과 트랜지스터(FeFET)는 현재 고밀도 및 빠른 쓰기 속도 비휘발성 메모리의 가능한 후보로 고려되고 있습니다. HfO2의 보유 성능이 MFIS 게이트 스택이 있는 기반 FeFET는 실제 응용 분야의 요구 사항을 충족할 수 있으며 메모리 창(MW) 및 내구성에 대한 신뢰성이 더욱 향상되어야 합니다. 이 작업은 ZrO2 사용의 이점을 조사합니다. MW의 시드 레이어, Hf0.5의 유지 및 내구성 Zr0.5 O2 빠른 전압 펄스 측정을 사용하여 MFIS 게이트 스택이 있는 (HZO) 기반 FeFET. ZrO2를 갖는 HZO 기반 FeFET 시드 층은 ZrO2가 없는 HZO 기반 FeFET에 비해 향상된 내구성 성능뿐만 아니라 더 큰 초기 및 10년 외삽 MW를 보여줍니다. 종자층. 결과는 직접 결정질 high-k/Si 게이트 스택을 사용하면 HfO2의 MW 및 신뢰성을 더욱 향상시킬 수 있음을 나타냅니다. 기반 FeFET.
<섹션 데이터-제목="배경">
배경
HfO2 기반 강유전성 박막은 CMOS(Complementary Metal-Oxide-Semiconductor) 호환성 및 확장성 때문에 강유전계 전계 효과 트랜지스터(FeFET)를 위한 유망한 게이트 스택 재료로 간주됩니다. FeFET에 사용할 수 있는 여러 종류의 게이트 스택 구조 중에서 금속/강유전체/절연체/반도체(MFIS)는 현재의 MOS 장치 아키텍처를 따르고 최신 고유전율 금속 게이트와 잘 어울리기 때문에 보다 실용적인 구성을 나타냅니다. (HKMG) 프로세스. 따라서 임베디드 비휘발성 메모리, 음의 커패시턴스 전계 효과 트랜지스터, 인공 뉴런, 시냅스 및 메모리 내 논리 장치에 적용하기 위해 MFIS 게이트 스택 구조를 가진 FeFET를 설계하고 제작하기 위해 많은 노력을 기울였습니다[1,2,3,4 ,5,6,7,8].
지금까지 MFIS 게이트 스택 구조를 가진 고밀도 및 빠른 쓰기 속도 FeFET는 HKMG 프로세스를 사용하여 성공적으로 제작되었습니다[9, 10]. 높은 집적도와 빠른 쓰기 속도 외에도 비휘발성 메모리 애플리케이션에 FeFET를 사용하려면 큰 메모리 창(MW)과 유지 및 내구성 측면에서 높은 신뢰성이 중요합니다[11,12,13,14]. 실리콘에 대한 큰 밴드 오프셋으로 인해 HfO2의 높은 보자력장 및 적당한 유전 상수 - 기반 강유전성 박막, HfO2 MFIS 게이트 스택 구조를 가진 기반 FeFET는 안정적인 유지 특성을 나타냅니다(10년 외삽)[15,16,17]. 그러나 HfO2 기반 박막은 1 × 10
9
이상의 적당한 내구성을 나타냅니다. 스위칭 사이클 [14, 18], HfO2 MFIS 게이트 스택 구조가 있는 기반 FeFET는 1 × 10
4
범위의 내구성이 다소 제한적입니다. ~ 1 × 10
7
스위칭 주기 [17, 19,20,21,22,23]. 이론적으로 고유전율 절연체 층을 사용하면 MFIS 게이트 스택의 전계를 감소시켜 밴드 굽힘을 완화하여 HfO2의 내구성 특성과 MW를 향상시킬 것으로 예상됩니다. 기반 FeFET[12, 14]. 실험적으로 Ali et al. 초박형 절연체 층의 k 값 증가(즉, SiO2 대신 SiON 사용) ) HfO2의 MW 뿐만 아니라 내구성 특성을 효과적으로 향상시킬 수 있습니다. 기반 FeFET[13]. 이전 연구[24]에서 결정질 ZrO2 MFIS 게이트 스택의 고유전율 층은 결정질 품질을 개선하고 Hf0.5에서 단사정상 형성을 억제할 수 있습니다. Zr0.5 O2 (HZO) 박막, DC 전압 스윕 방식으로 특징지어지는 2.8 V의 큰 MW로 이어집니다.
이 작업에서 우리는 결정질 ZrO2가 있거나 없는 HZO 기반 FeFET의 MW, 유지 및 내구성의 특성화에 대해 보고합니다. 빠른 포지티브 및 네거티브 전압 펄스 측정을 사용하여 시드 레이어. 또한, 결정질 ZrO2를 사용하는 장점 MW 및 내구성 속성에 대한 시드 레이어에 대해 설명합니다.
방법
ZrO2가 있거나 없는 n-채널 FeFET 시드 레이어는 [24]에 설명된 대로 게이트 라스트 프로세스를 사용하여 제작되었습니다. ZrO2 시드 층과 HZO 층은 모두 300
o
의 성장 온도에서 성장했습니다. 원자층 증착(ALD)에 의한 C. 제작된 FeFET의 개략도는 그림 1a에 나와 있으며, 채널 폭(W ) 및 길이(L )는 각각 80 및 7 μm였다. 한편, TaN/HZO/TaN 및 TaN/HZO/ZrO2 HZO 박막의 강유전체 특성을 평가하기 위해 /TaN 커패시터도 제작되었습니다. 분극-전압(P–V ) 커패시터의 히스테리시스 루프는 Radiant Technologies RT66A 강유전체 테스트 시스템을 사용하여 측정되었으며 FeFET의 디바이스 특성은 펄스 발생 장치(B1525A)가 있는 Agilent B1500A 반도체 디바이스 분석기로 측정되었습니다[20]. MW 및 내구성 측정에 사용되는 두 가지 주요 테스트 시퀀스는 그림 1b와 c에 나와 있습니다. MW 및 머무름 측정의 경우 프로그램/소거(P/E) 펄스가 먼저 FeFET의 게이트에 적용되었고 읽기 작업은 I를 사용하여 다른 시간 간격으로 수행되었습니다. D –V G 스윕(V D =0.1 V) V 감지 TH . 일반적으로 V TH 10
−7
의 드레인 전류에 해당하는 게이트 전압으로 결정됩니다. A∙W/L [25], MW는 V의 차이로 정의됩니다. TH 프로그래밍된 상태와 지워진 상태 사이의 값. 내구성 측정의 경우 MW는 일정 수의 교대 P/E 펄스 후에 측정되었습니다.
<그림><그림><소스 유형="이미지/webp" srcset="//media.springerature.com/lw685/springer-static/image/art%3A10.1186%2Fs11671-019-3063-2/MediaObjects/ 11671_2019_3063_Fig1_HTML.png?as=webp"> 
아 제작된 FeFET의 개략도. 추가 결정질 ZrO2 시드 레이어는 검은색 격자선으로 표시됩니다. ㄴ , ㄷ MW 및 내구성 측정에 사용되는 테스트 시퀀스
결과 및 토론
그림 2a는 P–V를 보여줍니다. TaN/HZO/TaN 및 TaN/HZO/ZrO2의 히스테리시스 루프 /TaN 커패시터. 놀랍게도 TaN/HZO/ZrO2 /TaN 캐패시터는 TaN/HZO/TaN 캐패시터보다 훨씬 더 나은 강유전성을 가지며, 이는 보고된 결과[26]와 일치하여 결정질 ZrO2 시드 층은 실제로 결정질 품질을 개선하고 HZO 박막에서 단사정상 형성을 억제할 수 있습니다[24]. 그림 2b는 I D –V G 추가 결정질 ZrO2가 있거나 없는 HZO 기반 FeFET의 곡선 P/E 펄스 후 시드 레이어. 빨간색 기호 라인은 I를 나타냅니다. D –V G 7 V/100ns의 프로그램 펄스를 적용한 후 곡선, 파란색 기호 라인은 I D –V G - 7 V/100 ns의 소거 펄스를 적용한 후 곡선. 나 D –V G 두 FeFET의 곡선은 반시계 방향 스위칭 특성을 나타내며, 이는 현재 FeFET의 MW가 전하 트래핑 및 주입이 아니라 HZO 층의 분극 스위칭에서 유래함을 시사합니다. 그럼에도 불구하고 추가 결정질 ZrO2를 포함하는 HZO 기반 FeFET 시드 층은 추가 결정질 ZrO2가 없는 HZO 기반 FeFET의 것(0.8 V)보다 약 1.8배 더 큰 1.4 V의 개선된 MW를 나타냅니다. 종자층. 또한, 1.4V의 얻은 MW는 현재까지 보고된 최상의 결과와 유사합니다[9, 11, 14, 17, 21, 22, 23, 27].
<그림><그림><소스 유형="이미지/webp" srcset="//media.springerature.com/lw685/springer-static/image/art%3A10.1186%2Fs11671-019-3063-2/MediaObjects/ 11671_2019_3063_Fig2_HTML.png?as=webp"> 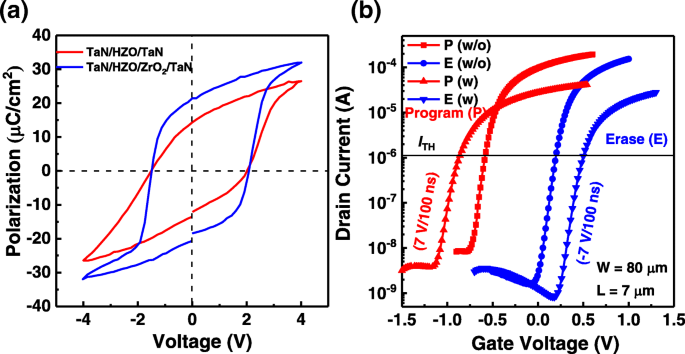
아 P–V TaN/HZO/TaN 및 TaN/HZO/ZrO2의 히스테리시스 루프 /TaN MFM 구조는 4 V 및 5 kHz의 주파수에서 측정되었습니다. ㄴ 나 D –V G ZrO2가 있거나 없는(w/o) HZO 기반 FeFET의 곡선 프로그램 펄스(+ 7 V/100 ns) 및 소거 펄스(- 7 V/100 ns) 이후의 시드 레이어
추가 결정질 ZrO2가 있거나 없는 HZO 기반 FeFET의 유지에 대한 신뢰성 종자층도 평가했다. 그림 3은 V를 보여줍니다. TH 실온에서 7 V/100ns의 프로그램 펄스와 –7V/100 ns의 소거 펄스를 인가한 후의 유지 특성. V TH 값은 로그 시간 척도와 거의 선형입니다. 추가 결정질 ZrO2가 있는 HZO 기반 FeFET의 10 년 후 외삽된 MW 시드 층은 추가 결정질 ZrO2가 없는 HZO 기반 FeFET의 경우(0.6 V)보다 큰 0.9 V입니다. 종자층. ZrO2의 두꺼운 정전 용량 등가 두께(CET) 때문에 (1.5 nm)/SiO22 (2.6 nm) 게이트 절연체 층은 게이트 스택에서 향상된 탈분극 필드로 이어질 것이며[13, 15], SiO2 레이어가 줄어듭니다.
<그림><그림><소스 유형="이미지/webp" srcset="//media.springerature.com/lw685/springer-static/image/art%3A10.1186%2Fs11671-019-3063-2/MediaObjects/ 11671_2019_3063_Fig3_HTML.png?as=webp"> 
ZrO2가 있거나 없는 HZO 기반 FeFET의 유지 특성 시드 레이어
그림 4는 I의 진화를 보여줍니다. D –V G ± 7 V/100 ns 교대 P/E 사이클 후 곡선. 추가 결정질 ZrO2가 없는 FeFET의 경우 종자층, I D –V G 곡선은 P/E 사이클링의 초기 단계에서 관찰되며 I D –V G 지워진 상태의 곡선은 프로그램 상태에 비해 더 많은 기울기 저하를 나타냅니다. 추가 결정질 ZrO2가 있는 FeFET의 경우 비록 I D –V G 지워진 상태의 곡선은 "웨이크업" 효과에 기인하는 P/E 사이클링의 초기 단계에서 명백한 양의 이동을 나타냅니다[13, 28,29,30,31,32]. I의 명백한 이동은 없습니다. D –V G 프로그램 상태의 곡선은 최대 1 × 10
3
까지 관찰됩니다. 주기. 또한 추가 결정질 ZrO2가 있는 FeFET의 경우 시드 레이어, 나 D –V G 지워진 상태와 프로그램 상태 모두에서 곡선은 최대 1 × 10
3
까지 약간의 기울기 저하만 나타냅니다. 주기.
<그림><그림><소스 유형="이미지/webp" srcset="//media.springerature.com/lw685/springer-static/image/art%3A10.1186%2Fs11671-019-3063-2/MediaObjects/ 11671_2019_3063_Fig4_HTML.png?as=webp"> 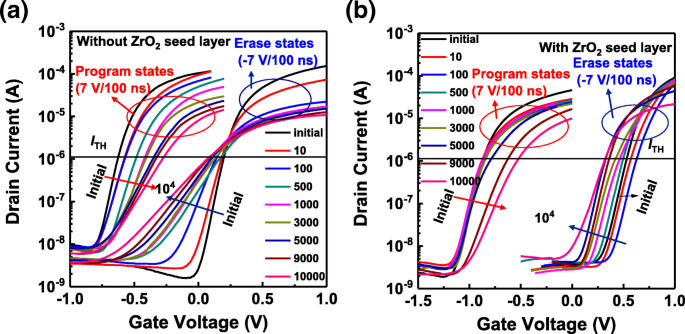
나의 진화 D –V G HZO 기반 FeFET의 곡선 a 및 b 없이 ZrO2 포함 P/E 순환이 있는 시드 레이어
이전 보고서[12, 28, 33]에 따르면 I D –V G 곡선은 게이트 스택에 갇힌 전하의 점진적인 축적에 기인하는 반면 I의 기울기 저하 D –V G 곡선은 인터페이스 트랩 생성의 결과입니다. 갇힌 전하는 전기적 수단으로 제거할 수 있지만 계면 트랩의 생성은 되돌릴 수 없으므로 계면 트랩 생성을 최소화하는 것은 내구성 특성을 향상시키는 데 매우 중요합니다[28]. P/E 순환에 의해 생성된 인터페이스 트랩(ΔN 그것 )는 식을 사용하여 설명할 수 있습니다. (1) [34, 35]:
$$ \Delta \mathrm{SS}=\frac{\Delta {N}_{it} kT\ln 10}{C_{FI}{\varnothing}_F} $$ (1)
여기서 ΔSS는 하위 임계값 스윙의 변화, k 볼츠만 상수, T 절대 온도, C FI 는 게이트 스택의 총 커패시턴스이고 ∅ F 는 페르미 포텐셜이다. ΔN 그것 추가 결정질 ZrO가 있거나 없는 HZO 기반 FeFET에 대한 P/E 주기의 함수2 시드 층은 그림 5에 나와 있습니다. 분명히, 추가 결정질 ZrO2가 없는 FeFET의 경우 시드 레이어, ΔN 그것 P/E 사이클링의 초기 단계에서 분명히 증가하고 ΔN 그것 지워진 상태에서는 프로그램 상태에서보다 훨씬 큽니다. 그러나 ΔN 그것 추가 결정질 ZrO2가 있는 FeFET의 경우 시드 레이어는 1 × 10
3
까지 거의 변하지 않습니다. 주기이며 추가 결정질 ZrO2가 없는 FeFET의 경우보다 항상 작습니다. 종자층. 추가 ZrO2를 삽입하기 때문에 시드층은 게이트 스택의 전계를 감소시켜 밴드 벤딩이 약해지고 인터페이스 트랩 생성이 완화됩니다[12, 14].
<그림><그림><소스 유형="이미지/webp" srcset="//media.springerature.com/lw685/springer-static/image/art%3A10.1186%2Fs11671-019-3063-2/MediaObjects/ 11671_2019_3063_Fig5_HTML.png?as=webp"> 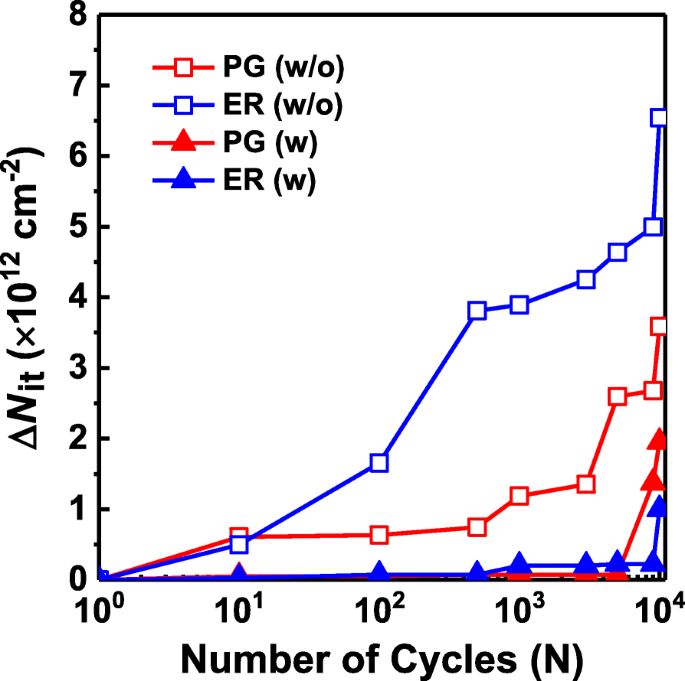
∆N의 진화 그것 P/E 사이클링 사용
그림 6은 게이트 누설 전류 특성의 변화를 보여줍니다(I G –V G ZrO가 있거나 없는 HZO 기반 FeFET의 곡선)2 P/E 사이클링이 있는 시드 레이어. 추가 결정질 ZrO2가 없는 FeFET의 경우 시드 레이어에서 게이트 누설 전류는 P/E 사이클링의 초기 단계부터 급격히 증가합니다. 그러나 추가 결정질 ZrO2가 있는 FeFET의 게이트 누설 전류 시드 레이어는 5 × 10
2
까지 거의 변하지 않습니다. 주기이며 추가 결정질 ZrO2가 없는 FeFET의 경우보다 항상 작습니다. 종자층. 게이트 누설 전류의 증가는 생성된 인터페이스 트랩과 관련이 있을 수 있다고 보고되었습니다[28]. 추가 결정질 ZrO2가 있는 FeFET에 대한 사이클링으로 게이트 누설 전류 감소 시드 레이어는 인터페이스 트랩 생성의 억제에 기인합니다.
<그림><그림><소스 유형="이미지/webp" srcset="//media.springerature.com/lw685/springer-static/image/art%3A10.1186%2Fs11671-019-3063-2/MediaObjects/ 11671_2019_3063_Fig6_HTML.png?as=webp"> 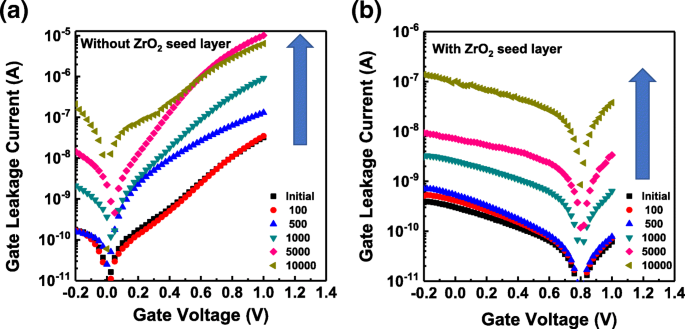
게이트 누설 전류 특성의 진화(I G –V G 곡선) HZO 기반 FeFET a 및 b 없이 ZrO2 포함 P/E 순환이 있는 시드 레이어
V TH I에서 추출된 프로그램 및 지우기 상태에 대한 값 D –V G 추가 결정질 ZrO2가 있거나 없는 HZO 기반 FeFET의 곡선 시드 층은 그림 7에 나와 있습니다. 추가 결정질 ZrO2가 있는 HZO 기반 FeFET 시드 층은 추가 결정질 ZrO2 없이 항상 HZO 기반 FeFET보다 더 큰 MW를 나타냅니다. 종자층. 또한 추가 결정질 ZrO2가 없는 HZO 기반 FeFET의 MW 시드 층은 P/E 사이클링의 초기 단계에서 분명히 감소하는 반면 추가 결정질 ZrO2가 있는 HZO 기반 FeFET의 MW 시드 레이어는 최대 1 × 10
3
까지 약간 감소합니다. 주기. P/E 사이클링 수가 추가로 증가함에 따라 결정질 ZrO2가 추가된 HZO 기반 FeFET 시드 층은 또한 I D –V G 향상된 인터페이스 트랩 생성으로 인해 곡선 및 MW. 그러나 추가 결정질 ZrO2가 있는 HZO 기반 FeFET의 MW 시드 레이어는 여전히 0.9 V보다 1 × 10
4
까지 큽니다. 추가 결정질 ZrO2가 없는 HZO 기반 FeFET의 것(0.4 V)보다 약 2.3배 더 큰 사이클 종자층. 앞서 논의한 바와 같이, 더 포화된 분극 상태를 얻기 위해 필요한 전기장의 감소는 아마도 향상된 내구성 특성에 대한 책임이 있을 것입니다.
<그림><그림><소스 유형="이미지/webp" srcset="//media.springerature.com/lw685/springer-static/image/art%3A10.1186%2Fs11671-019-3063-2/MediaObjects/ 11671_2019_3063_Fig7_HTML.png?as=webp"> 
V의 진화 TH P/E 사이클링 사용
결론
TaN/HZO/SiO2를 사용하는 HZO 기반 FeFET의 유지 및 내구성과 관련된 MW 및 신뢰성 /Si 및 TaN/HZO/ZrO2 /SiO2 /Si MFIS 게이트 스택은 빠른 전압 펄스 측정이 특징입니다. 결과는 추가 결정질 ZrO2가 있는 HZO 기반 FeFET가 시드 층은 1.4 V의 큰 초기 메모리 창과 0.9 V의 외삽 10년 유지를 나타내며, 이는 추가 결정질 ZrO2 종자층. 또한, 결정질 ZrO2를 삽입하여 HZO 기반 FeFET의 내구성에 대한 신뢰성을 향상시킬 수 있습니다. HZO 층과 SiO2 사이의 시드 층 /Si 기판. ZrO2를 사용한 HZO 기반 FeFET의 MW 및 내구성 향상 시드 층은 주로 HZO 층의 개선된 결정 품질 및 보다 포화된 분극 상태를 얻기 위해 필요한 전기장의 감소로 인한 인터페이스 트랩의 억제된 생성과 관련이 있습니다. 이 작업을 기반으로 직접 결정질 high-k/Si 게이트 스택을 사용하면 HfO2의 MW 및 신뢰성이 더욱 향상될 것으로 예상됩니다. 기반 FeFET이므로 추가 연구와 개발이 필요합니다.
데이터 및 자료의 가용성
이 기사의 결론을 뒷받침하는 데이터 세트가 기사에 포함되어 있습니다.
약어
- CMOS:
-
상보성 금속 산화물 반도체
- FeFET:
-
강유전계 효과 트랜지스터
- FeFET:
-
강유전계 효과 트랜지스터
- HKMG:
-
High-k 금속 게이트
- HZO:
-
Hf0.5 Zr0.5 O2
- 나 D :
-
드레인 전류
- L:
-
길이
- MFIS:
-
금속/강유전체/절연체/반도체
- MW:
-
메모리 창
- P/E:
-
프로그램/지우기
- P–V :
-
분극-전압
- SS :
-
하위 임계값 스윙
- V G :
-
게이트 전압
- V TH :
-
임계 전압
- 여:
-
너비
- ΔN 그것 :
-
생성된 인터페이스 트랩