결과 및 토론
Al 도핑된 ZnO/β-Ga2의 가전자대 오프셋(VBO) O3 이종접합은 다음 공식을 통해 얻을 수 있습니다[18]:
$$ \델타 {E}_V=\left({E}_{\mathrm{Ga}\ 2p}^{{\mathrm{Ga}}_2{\mathrm{O}}_3}-{E}_{ \mathrm{VBM}}^{{\mathrm{Ga}}_2{\mathrm{O}}_3}\right)-\left({E}_{\mathrm{Zn}\ 2p}^{\mathrm{ AZO}}-{E}_{\mathrm{VBM}}^{\mathrm{AZO}}\right)-\left({E}_{\mathrm{Ga}\ 2p}^{{\mathrm{Ga }}_2{\mathrm{O}}_3}-{E}_{\mathrm{Zn}\ 2p}^{\mathrm{AZO}}\right) $$ (1)
여기서\( {E}_{\mathrm{Ga}\ 2p}^{{\mathrm{Ga}}_2{\mathrm{O}}_3} \)는 Ga 2p 벌크 β-Ga2의 코어 레벨(CL) O3 , \( {E}_{\mathrm{VBM}}^{{\mathrm{Ga}}_2{\mathrm{O}}_3} \) 는 대량 β-Ga2에서 VBM의 BE를 나타냅니다. O3 , \( {E}_{\mathrm{Zn}\ 2p}^{\mathrm{AZO}} \) 은 Zn 2p의 BE를 나타냅니다. 두꺼운 Al 도핑 ZnO 필름의 CL, \( {E}_{\mathrm{VBM}}^{\mathrm{AZO}} \)는 두꺼운 Al 도핑 ZnO 필름의 VBM의 BE를 나타냅니다. 후자의 \( {E}_{\mathrm{Ga}\ 2p}^{{\mathrm{Ga}}_2{\mathrm{O}}_3} \) 및 \( {E}_{\mathrm{Zn }\ 2p}^{\mathrm{AZO}} \) Ga 2의 BE를 나타냄p 및 Zn 2p 얇은 Al 도핑 ZnO 필름의 CL.
이후 E g 및 ∆E V , Al 도핑된 ZnO/β-Ga2에서 CBO O3 인터페이스는 다음 방정식으로 계산할 수 있습니다.
$$ \Delta {E}_C={E}_g^{{\mathrm{Ga}}_2{\mathrm{O}}_3}-{E}_g^{\mathrm{AZO}}-\Delta {E }_V $$ (2)
여기서\( {E}_g^{{\mathrm{Ga}}_2{\mathrm{O}}_3} \)는 Ga2의 밴드갭입니다. O3 그리고 \( {E}_g^{\mathrm{AZO}} \)는 Al-도핑된 ZnO의 밴드갭이다. 도핑되지 않은 5% Al 도핑 ZnO, 10% Al 도핑 ZnO 및 β-Ga2에 대한 밴드갭 O3 각각 3.20eV, 3.25eV, 3.40eV, 4.65eV입니다[17, 19]. 밴드갭은 Al 도핑 비율이 높을수록 증가하며 다음 부분의 시뮬레이션과 잘 일치합니다.
그림 1은 벌크 β-Ga2의 Ga 및 Zn 원소 CL 및 VBM을 보여줍니다. O3 , 도핑되지 않은 두꺼운 필름, 5% 및 10% Al 도핑된 ZnO 필름. VBM 스펙트럼에서 선형 영역과 플랫 밴드 영역을 맞추면 VBM을 추론할 수 있습니다[20]. 그림 2는 Ga 2p를 보여줍니다. 및 Zn 2p 다양한 얇은 Al 도핑 ZnO/β-Ga2의 CL O3 이종 접합. Ga 2p의 BE 차이점 및 Zn 2p 도핑되지 않은 5% Al 도핑 ZnO/β-Ga2에 대한 CL O3 및 10% Al 도핑된 ZnO/β-Ga2 O3 각각 96.12eV, 96.16eV, 95.94eV가 됩니다. 그런 다음 인터페이스의 VBO는 도핑되지 않은 5% Al 도핑 ZnO/β-Ga2에 대해 1.39 eV, 1.52 eV 및 1.67 eV로 결정됩니다. O3 및 10% Al 도핑된 ZnO/β-Ga2 O3 각각 샘플입니다.
<그림><그림><소스 유형="이미지/webp" srcset="//media.springerature.com/lw685/springer-static/image/art%3A10.1186%2Fs11671-019-3092-x/MediaObjects/ 11671_2019_3092_Fig1_HTML.png?as=webp"> 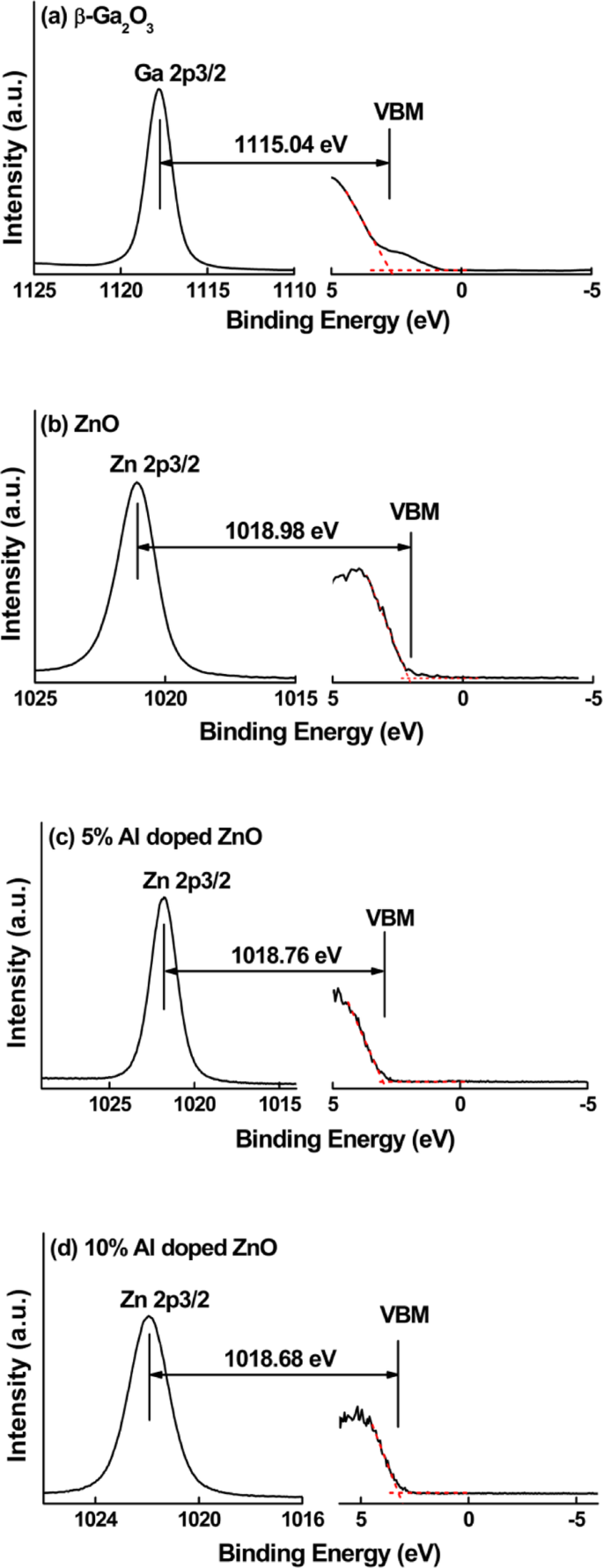
a의 코어 레벨 및 최대 가전자대(VBM)에 대한 고해상도 XPS 스펙트럼 가 2p 베어 β-Ga2의 코어 레벨 스펙트럼 및 VBM O3 , b Zn 2p 두꺼운 순수 ZnO/β-Ga2의 코어 레벨 스펙트럼 및 VBM O3 , ㄷ Zn 2p 두꺼운 5% Al 도핑 ZnO/β-Ga2의 코어 레벨 스펙트럼 및 VBM O3 , 및 d Zn 2p 두꺼운 10% Al 도핑 ZnO/β-Ga2의 코어 레벨 스펙트럼 및 VBM O3
<그림><그림><소스 유형="이미지/webp" srcset="//media.springerature.com/lw685/springer-static/image/art%3A10.1186%2Fs11671-019-3092-x/MediaObjects/ 11671_2019_3092_Fig2_HTML.png?as=webp"> 
Ga 2p의 핵심 레벨 스펙트럼 및 Zn 2p a의 고해상도 XPS 스펙트럼에서 얻음 얇은 ZnO/β-Ga2 O3 , b 얇은 5% Al 도핑된 ZnO/β-Ga2 O3 , 및 c 얇은 10% Al 도핑 ZnO/β-Ga2 O3
0%, 5% 및 10% Al 도핑된 ZnO/β-Ga2에 대한 체계적인 밴드 정렬 O3 이종 접합은 그림 3과 같이 위의 방정식으로 계산됩니다. 도핑되지 않은 ZnO/β-Ga2의 밴드 오프셋 O3 이종 접합은 유형 I에 속합니다. 5% 및 10% Al-도핑된 ZnO/β-Ga2 O3 이종 접합에는 유형 II 대역 오프셋이 있습니다. 그림 4는 Al 도핑된 ZnO/β-Ga2의 밴드 정렬을 보여줍니다. O3 계면은 Al 도핑 농도와 유사한 선형 관계를 갖는다. CBO는 1.39에서 1.67 eV까지 다양하며 Al 도핑 농도는 0에서 10%까지 증가합니다. VBO는 0.06에서 - 0.42eV로 감소하고 Al 도핑 농도는 0에서 10%로 증가합니다. 스퍼터링된 AZO/β-Ga2에 대한 CBO 및 VBO는 O3 각각 0.79eV 및 0.61eV입니다[9]. 전도대와 가전자대가 이 연구에서 아래쪽으로 이동하는데, 이는 증착 방법에 의해 도입된 다른 조성비와 결정 구조 때문일 수 있습니다.
<그림><그림><소스 유형="이미지/webp" srcset="//media.springerature.com/lw685/springer-static/image/art%3A10.1186%2Fs11671-019-3092-x/MediaObjects/ 11671_2019_3092_Fig3_HTML.png?as=webp"> 
a의 개략적인 밴드 정렬 다이어그램 순수한 ZnO/β-Ga2 O3 , b 5% Al 도핑된 ZnO/β-Ga2 O3 , 및 c 10% Al 도핑 ZnO/β-Ga2 O3
<그림><그림><소스 유형="이미지/webp" srcset="//media.springerature.com/lw685/springer-static/image/art%3A10.1186%2Fs11671-019-3092-x/MediaObjects/ 11671_2019_3092_Fig4_HTML.png?as=webp"> 
원자층 증착 AZO/β-Ga2의 전도 및 가전자대 오프셋 O3 다른 Al 도핑 비율로 제작된 이종 접합
그 외에 VASP(Vienna Ab-initio Simulation Package)[21,22,23,24]에서 첫 번째 원칙 시뮬레이션을 수행하여 Al 도핑된 ZnO/Ga2의 전자 밴드 구조 및 밴드 정렬을 조사했습니다. O3 이종 접합. 계산하는 동안 전자-이온 상호 작용은 초연성 유사 전위로 처리되고 파동 함수와 전위는 평면파 기반으로 확장됩니다[25]. 또한 Perdew, Burke, Ernzerhof(PBE)가 제안한 GGA(generalized gradient approximation)가 교환 상관 에너지를 설명하기 위해 구현되었습니다[26]. 시뮬레이션을 시작하기 전에 수렴 테스트를 수행했습니다. Monkhorst Pack 방식을 사용하여 평면파 기반에 대한 450eV의 차단 에너지와 3 × 3 × 3의 k-공간 그리드가 잘 수렴된 결과를 제공함을 보여주었습니다. 구조 최적화에서는 conjugate gradient 방법을 사용하여 0.01eV/Å 미만이 될 때까지 잔류력을 해제했습니다. 또한 semi-local PBE approximation을 기반으로 하는 하이브리드 밀도 함수가 구현되었습니다. 과소평가된 밴드갭을 수정하기 위해 PBE 교환의 35%를 정확한 것으로 교체하였다[27]. Al 도핑 수준의 변화에 따른 밴드 에지 이동을 식별하기 위해 평균 정전기 전위(AEP)를 계산하고 0V로 조정된 진공 수준에 정렬했습니다. 결과적으로 VBM 및 전도대 최소값(CBM)은 다음과 같이 정렬되었습니다. 밴드 다이어그램에 기반한 AEP [28]. 이 작업에서는 슈퍼셀에 16개의 O 원자와 16개의 Zn 원자를 가진 벌크 ZnO가 사용되었습니다. Al 도핑을 도입하기 위해 슈퍼셀에서 1개 또는 2개의 Zn 원자가 Al 원자로 대체되어 각각 3.21% 및 6.25%의 도핑 농도를 갖는 Al 도핑 구조를 생성했습니다.
그림 5a-c는 각각 도핑되지 않은 3.21% Al 도핑 ZnO 및 6.25% Al 도핑 ZnO 구조의 계산된 밴드 다이어그램을 보여줍니다. 이는 ZnO가 3.42eV의 밴드갭을 갖는 직접적인 밴드갭 반도체이며, CBM과 VBM이 브릴루앙 영역의 Γ 지점에 위치함을 명확하게 보여줍니다. 이러한 이론적 시뮬레이션 결과는 실험 값과 매우 잘 일치합니다[29]. Al 도핑으로 페르미 준위가 전도대로 위쪽으로 이동하여 순수한 ZnO를 n형 반도체로 변환한다는 것을 알 수 있었습니다. 한편, 밴드갭은 3.21% Al 도핑 ZnO 및 6.25% Al 도핑 ZnO에 대해 각각 4.83 eV 및 5.42 eV로 증가했습니다. 도핑된 ZnO에 대한 밴드갭이 우리의 실험 결과보다 높지만; 그러나 이는 계면 결함 상태 및 기타 결정 결함을 무시했기 때문일 수 있습니다.
<그림><그림><소스 유형="이미지/webp" srcset="//media.springerature.com/lw685/springer-static/image/art%3A10.1186%2Fs11671-019-3092-x/MediaObjects/ 11671_2019_3092_Fig5_HTML.png?as=webp"> 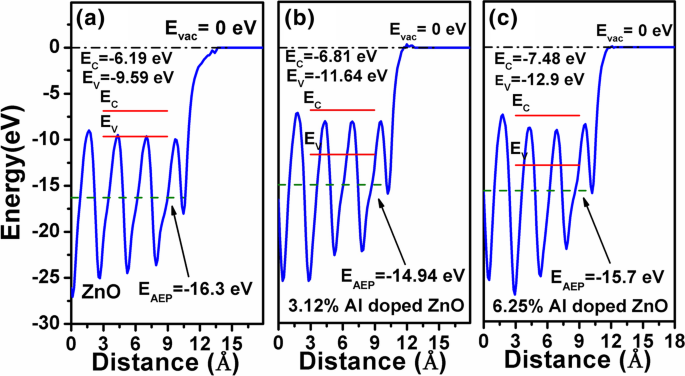
a의 계산된 밴드 다이어그램 도핑되지 않은 ZnO, b 3.21% Al 도핑된 ZnO 및 c 6.25% Al 도핑된 ZnO 구조. 페르미 레벨은 0eV로 설정되었습니다.
그림 6a-c는 진공 수준에 대한 도핑되지 않은 3.21% Al 도핑 ZnO 및 6.25% Al 도핑 ZnO의 밴드 정렬을 나타냅니다. 재료의 전도대의 경우, Al과 O 원소 사이의 강한 전자 혼합으로 인해 에너지 준위가 ZnO의 - 6.19 eV에서 3.21% Al이 도핑된 ZnO( ΔE =0.62 eV) 및 6.25% Al 도핑 ZnO(ΔE)의 경우 - 7.48 eV로 추가 감소 =1.29 eV). 한편, 밴드갭의 개방으로 인해 가전자대 가장자리가 ZnO의 경우 - 9.59eV에서 3.21% Al-도핑된 ZnO의 경우 - 11.64eV로 아래쪽으로 이동한다는 것을 알 수 있었습니다(ΔE =2.05 eV) 및 − 12.9 eV(6.25% Al 도핑 ZnO의 경우 ΔE =3.31 eV). 전체적으로 강한 Al과 O 전자 혼합으로 인해 ZnO에 Al을 통합하면 밴드 갭이 열리는 것으로 이해할 수 있습니다. 더욱이, 그것은 진공 준위에 정렬될 때 전도대와 가전자대 가장자리를 더 낮은 에너지 준위로 이동시킬 것입니다.
<그림><그림><소스 유형="이미지/webp" srcset="//media.springerature.com/lw685/springer-static/image/art%3A10.1186%2Fs11671-019-3092-x/MediaObjects/ 11671_2019_3092_Fig6_HTML.png?as=webp"> 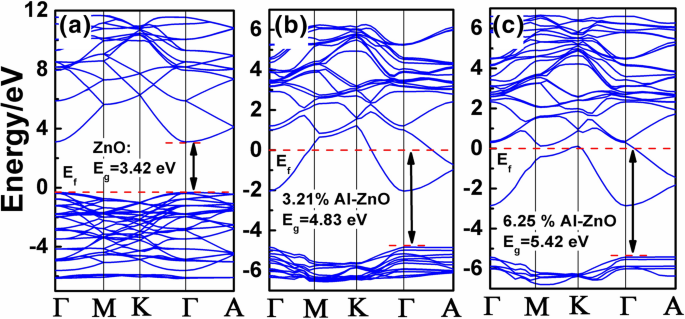
AZO/β-Ga2의 밴드 정렬 O3 a 이종접합 도핑되지 않은 b 3.21% 및 c 6.25% Al 도핑된 ZnO. 진공 수준은 0eV로 조정되었습니다.
결론
결론적으로, 서로 다른 Al 도핑된 ZnO/β-Ga2의 밴드 정렬 O3 (\( \overline{2} \)01) 인터페이스는 XPS에서 조사되었습니다. ZnO/β-Ga2의 계면에서 I형 밴드 정렬이 형성됩니다. O3 이종 접합. AZO/β-Ga2 O3 인터페이스에는 유형 II 밴드 정렬이 있습니다. CBO는 1.39에서 1.67 eV까지 다양하고 VBO는 0.06에서 - 0.42 eV로 감소하며 Al 도핑 농도는 0에서 10%까지 증가합니다. 더욱이, 밀도 함수 계산은 Al이 ZnO에 포함될 때 강한 Al과 O 전자 혼합으로 인해 밴드 오프셋이 변경됨을 보여줍니다. 이러한 결과는 순수한 ZnO가 장벽 높이를 줄이고 전자 수송을 촉진하는 유효한 ISL임을 시사합니다.
데이터 및 자료의 가용성
이 원고의 결론을 뒷받침하는 데이터 세트가 원고에 포함되어 있습니다.
약어
- AEP:
-
평균 정전기 전위
- ALD:
-
원자층 증착
- BE:
-
결속력
- CBM:
-
전도대 최소
- CBO:
-
전도대 오프셋
- CL:
-
핵심 레벨
- CL:
-
핵심 레벨
- CVD:
-
화학 기상 증착
- DEZ:
-
Zn(C2 H5 )2
- Ga2 O3 :
-
산화갈륨
- GaN:
-
질화갈륨
- GGA:
-
일반화된 기울기 근사
- ISL:
-
중간 반도체층
- PBE:
-
퍼듀, 버크, 에른처호프
- SiC:
-
탄화규소
- TMA:
-
트리메틸알루미늄
- VASP:
-
Vienna Ab 초기 시뮬레이션 패키지
- VBM:
-
원자가 밴드 최대값
- VBO:
-
가전자대 오프셋
- XPS:
-
X선 분광법
- ZnO:
-
산화아연